
在聊到800G DSP时,点击可链接Y8T100 Marvell 800G DSP
其中一个点是说400G DSP要从带有封装的形式,升级到800G时,要去掉封装,采用Die的形式来实现高密度的引脚。
这个去掉外封装的工艺,是要支持更高频的应用,原因Y8T99 高频DSP的焊点的间距为何要缩短
焊点的布局和电信号的高阶模的激发有关,对的,不只是光信号有高阶模,电信号也有,以前地频时不太引起注意而已。
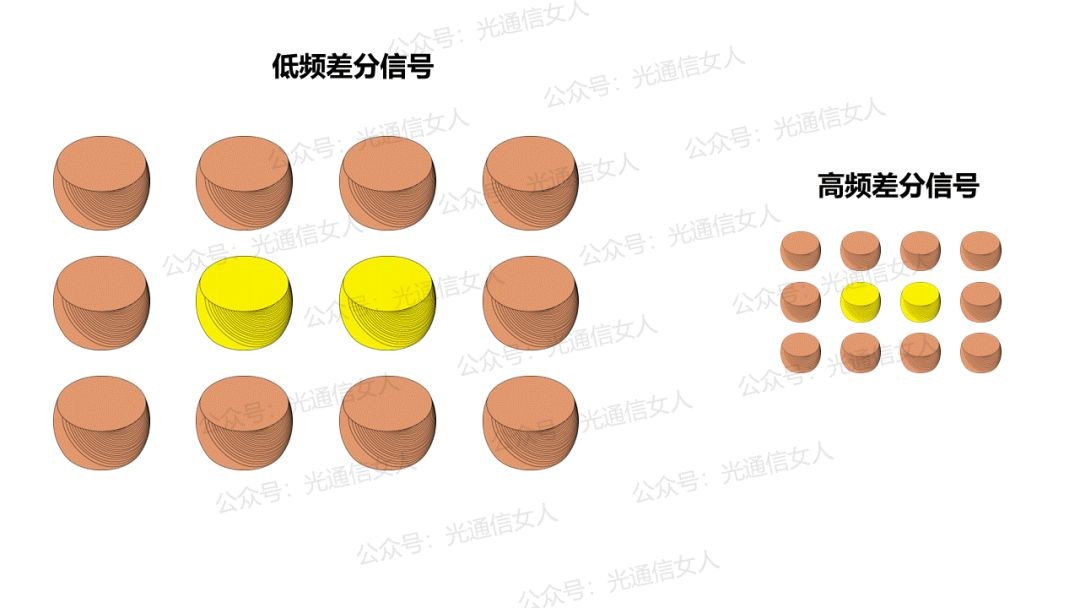
这就和Y8T91 II VI:光模块未来封装热插拔还是CPO,中对DSP焊点间距的解释,起到互相印证的作用。
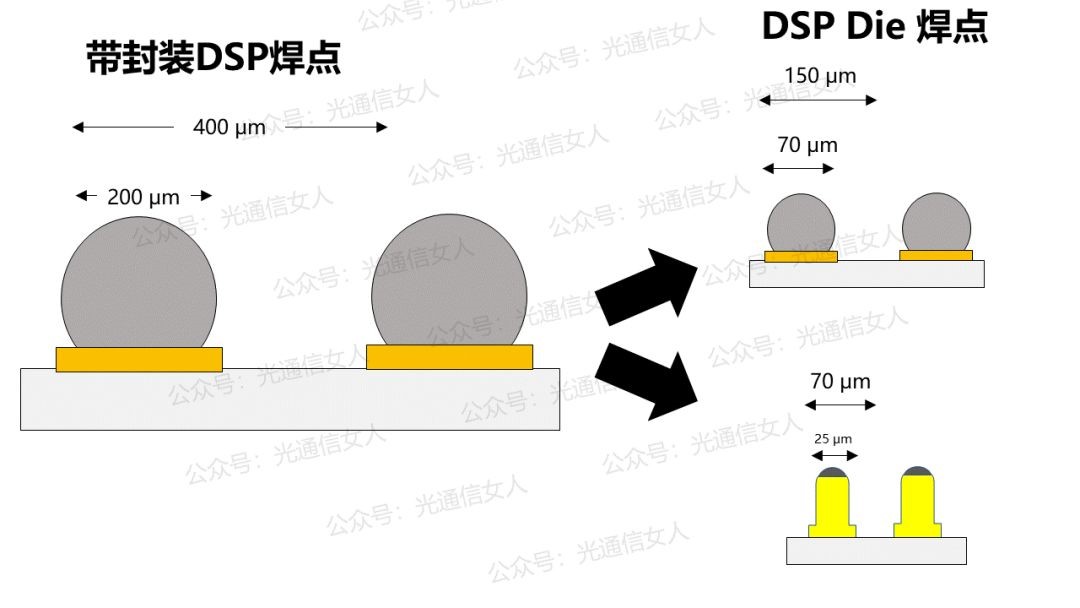
今天继续补充一下DSP Die的两个焊点画法的区别。
一个焊球的直径70μm,球间距150μm,这个叫C4凸点,controlled collapse chip connection,可控塌陷芯片连接,工艺是写在2020合集的第390页
那个小焊点,直径可以缩小到25μm,这个叫C2,chip connection,芯片连接,从这俩名字上看不出太大区别。

C4球,在芯片焊盘,一般用Al焊盘,之后用多层金属,来和铜层连接,多层金属起到黏附、接触以及中间防止迁移的隔离层,铜层上是焊料。
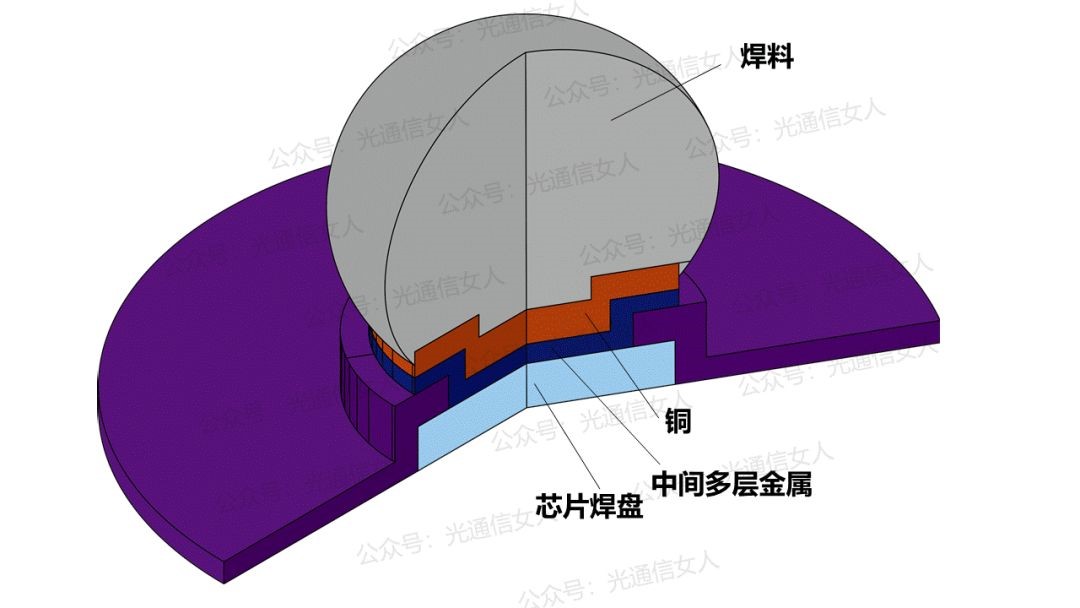
焊料,是低温熔融的金属,换句话说,在特定的温度下,焊料呈现液态,用于连接固态金属。
一旦呈现液态,就有了流动性,一方面通过紫色的阻焊框,来控制液体大范围流动,另一方面液体本身有表面张力,可以起到汇聚成球的作用。
我们的焊球高度在100μm左右的话,意味着在液态下会扩张到基本同等量级的直径,受控优化到也就是60-70μm的直径。
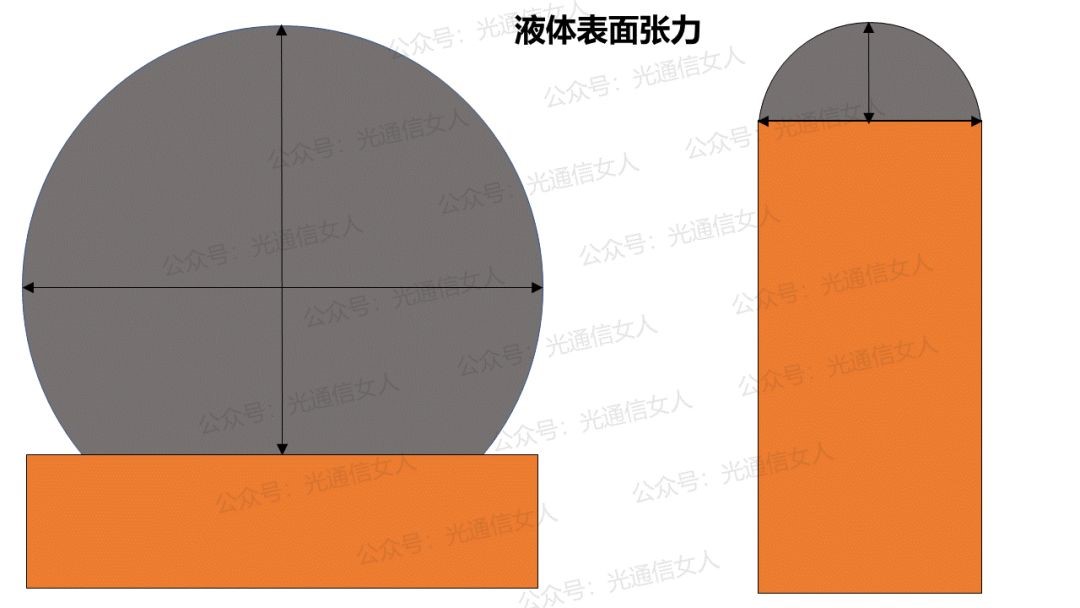
要想继续缩小焊点直径,从而降低焊点间距,实现更高频互联时,不出现电信号高阶模,就需要降低焊料的高度,不足的部分用铜柱来补充。
焊料是焊接温度点会熔化成液体,但铜柱不会,在焊接时能依然保持固体的铜柱形态。
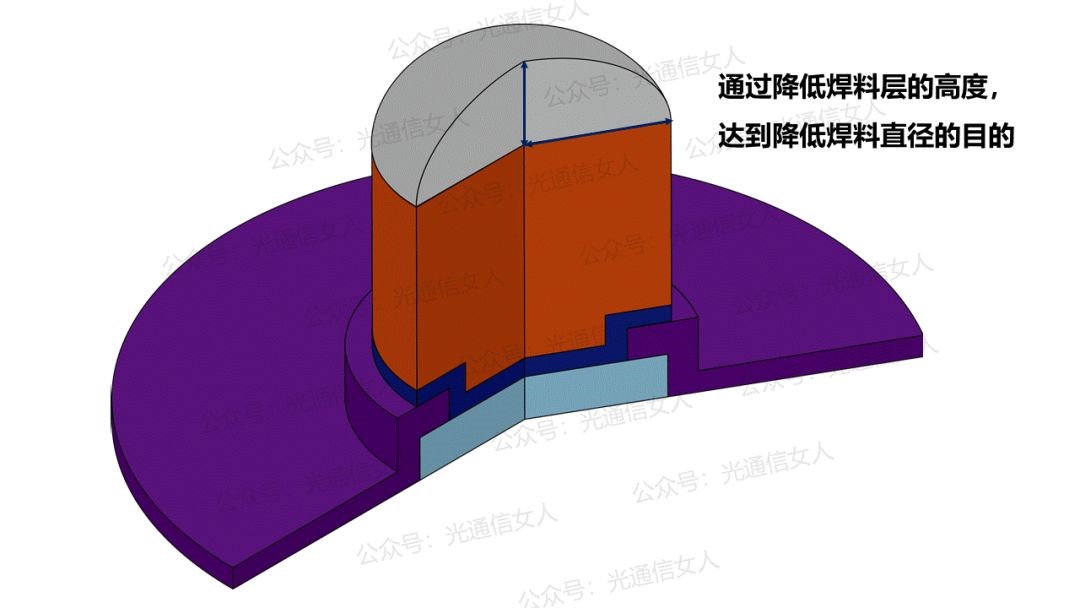
这是C4和C2的主要区别,单从名字上看不出来的。
最后理一理逻辑关系。
高频电信号,信号与信号回流的GND之间的距离要更短,才能避免电信号的高阶模。
这需要高密度的焊点布局,400G DSP有外封装,到达800G时,就要考虑取消外封装,采用芯片的Die的凸点来达到高密度焊点
焊点的直径,受限于焊料熔融坍塌时表面张力所形成的液体球的半径(可推算高度与宽度)
降低焊点直径,就需要降低焊料高度,不足的高度通过不会产生熔融塌陷的铜柱弥补。
5月28号,预计用5个小时来聊聊2022年OFC和咱们光模块相关的一些技术进展,6月份有整期的光模块/光器件/光芯片的技术解析,可详询客服18140517646
