
2024OFC,三菱发表他家用于50G PON OLT 1342nm的大功率EML集成SOA的芯片数据,目标是满足Class C+的应用。
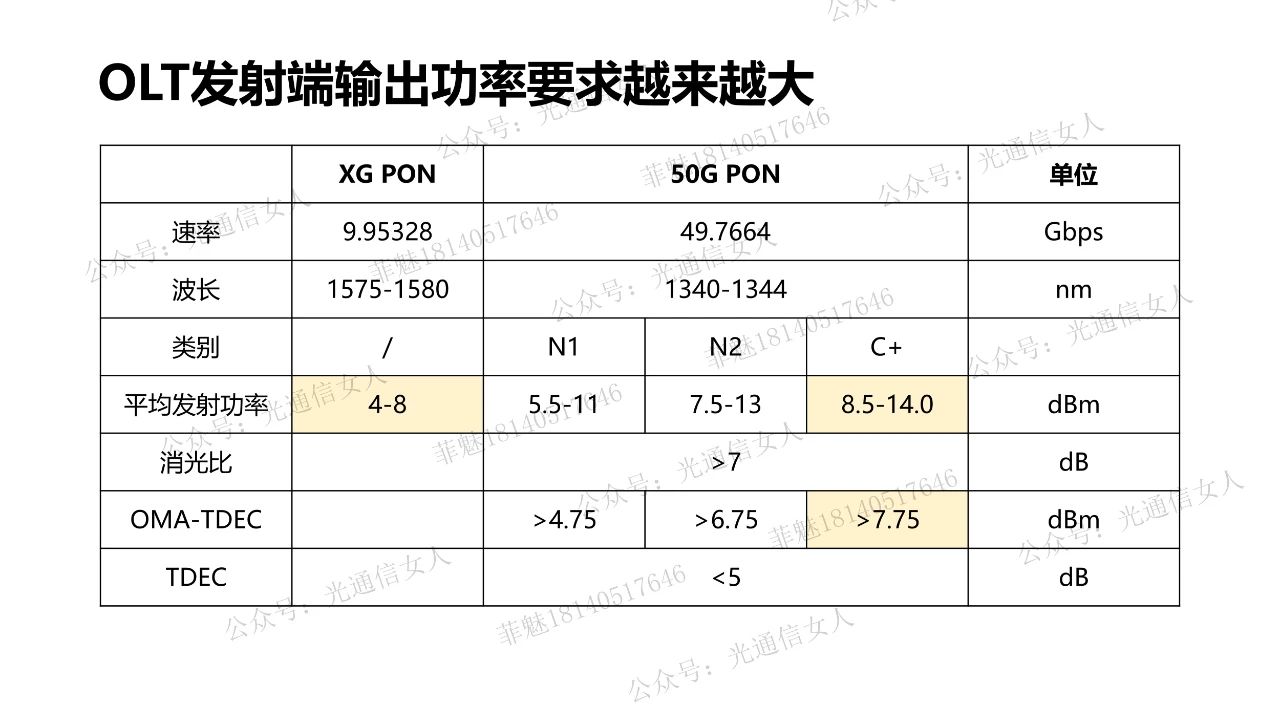
给出的结构是四段式分布,台面的EML电吸收调制结构,与昨天写三菱的台面设计,与去年写博通和Lumentum的台面设计是一样的。通过降低RC常数提高带宽,通过增大限制因子Γ来保持TDEC,而DFB与SOA为了提高电光效率,需要降低限制因子Γ,所以这几段的设计目标不一样。
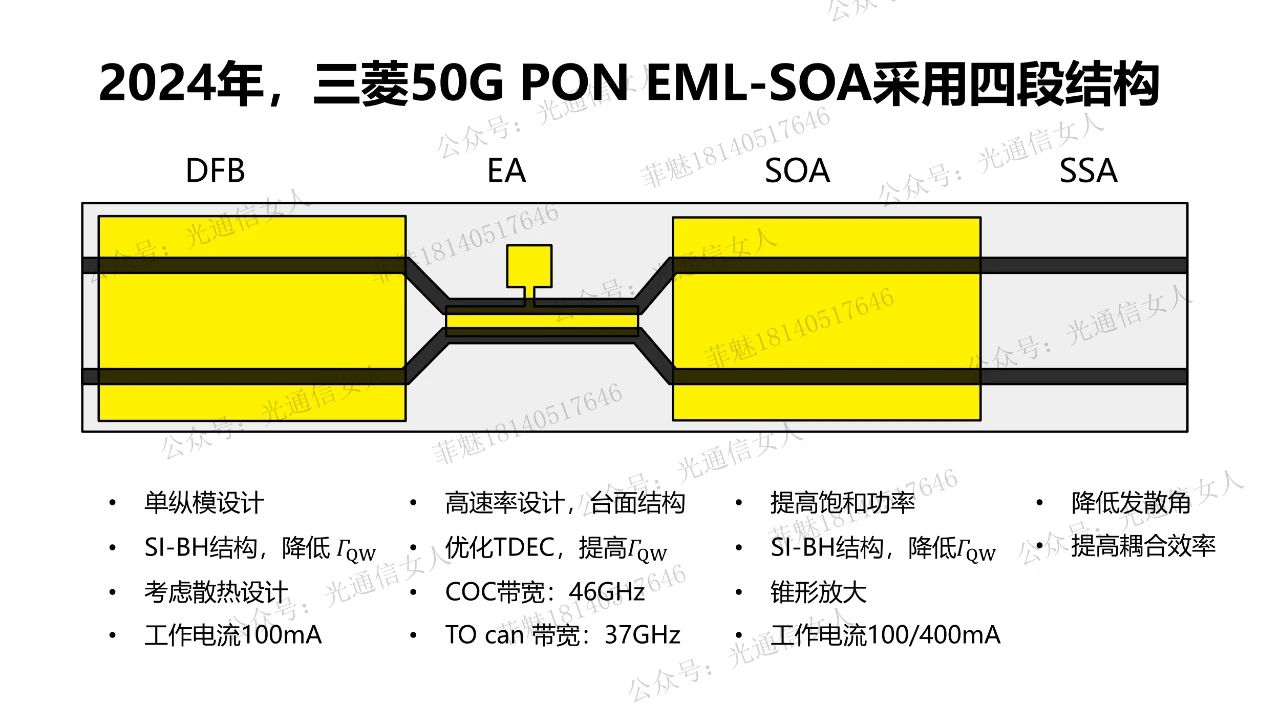
为了提高SOA的饱和功率,实现大功率设计,三菱、华为海思等厂家都采用了“锥形”放大结构,华为的设计思路之前写的比较多,三菱给出来的更多是简要描述,不过技术原理是通的。
●《2023合集下》 SOA锥形放大结构
●Y10T34 华为黑科技Class D模块,10G PON OLT的EML也采用了锥形放大SOA结构
●《ECOC 2023 PPT汇编》 华为50G PON 1342nm 15dBm EML-SOA,采用锥形放大的SOA结构
看华为去年ECOC的图,也是“四段”式的结构,比三菱的那个示意图看着更明白些。
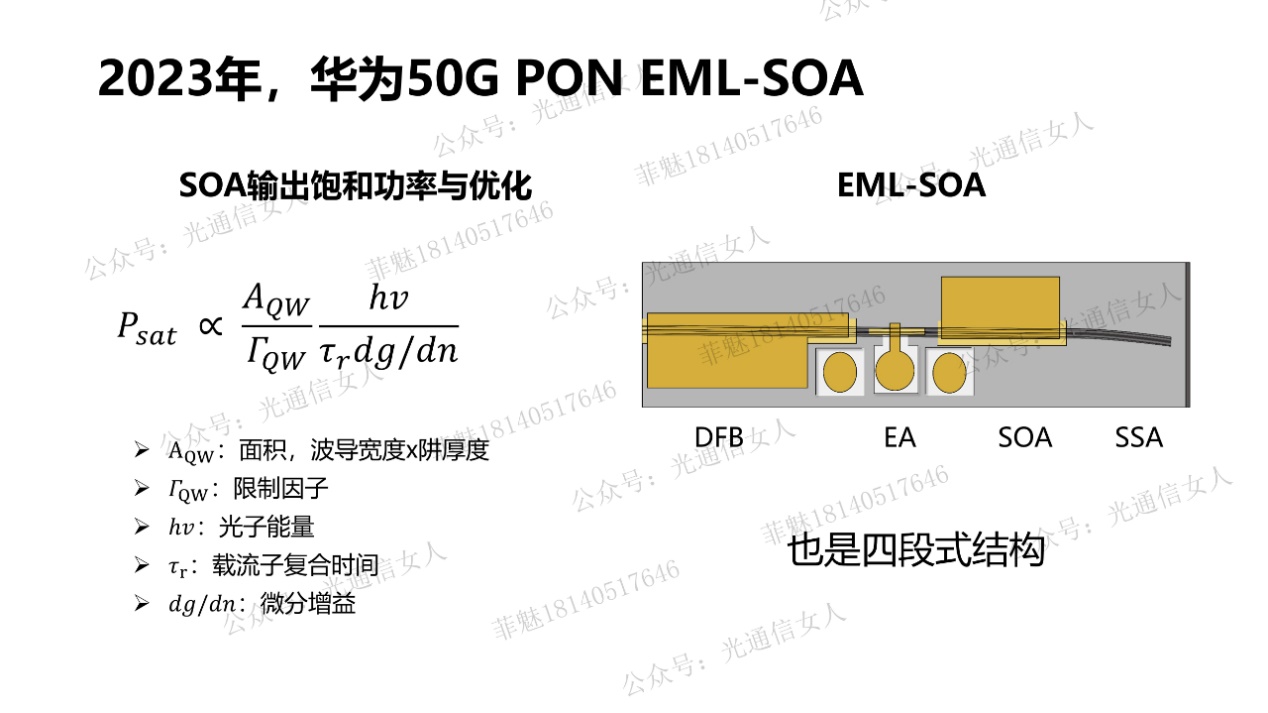
PON领域的最大特点是低成本,华为和三菱不约而同的选择了TOcan封装,华为的结构之前写过一些,《2023合集下》 华为采用陶瓷基板与硅基板的EML TO布局
三菱基于TO56的EML 封装,在2021年演讲中给的还略详细一些,今年的示意图更更简化了。
EML的常用TO can封装案例,在2024年5月25号有一期案例分析汇总,可以关注一下。

三菱的TO56,同样考虑的射频性能,引脚的寄生电感,键合金丝的寄生电感,柔性板焊接导致的寄生电容,GSG过渡基板引线长度,高频信号TO玻璃体的介电损耗和介电常数,以及所有寄生参数中可一起谐振频率的LC谐振频点的控制,EML芯片RC谐振频点的控制.....这些都是高速EML设计及封装需要考虑的。
另外也会考虑光学耦合效率,EML COC以及透镜的距离,形貌,角度等等。
还需要考虑TOSA焊接点等弹性、塑性形变与耦合效率的控制。
TO还需要考虑气密型设计。
三菱做了一组对比,激光器Bias电流100mA,SOA分别作100mA,400mA两类设计,SOA 100mA用于较小功率的场景,SOA 400mA用于类似C+的超大功率预算的场景。
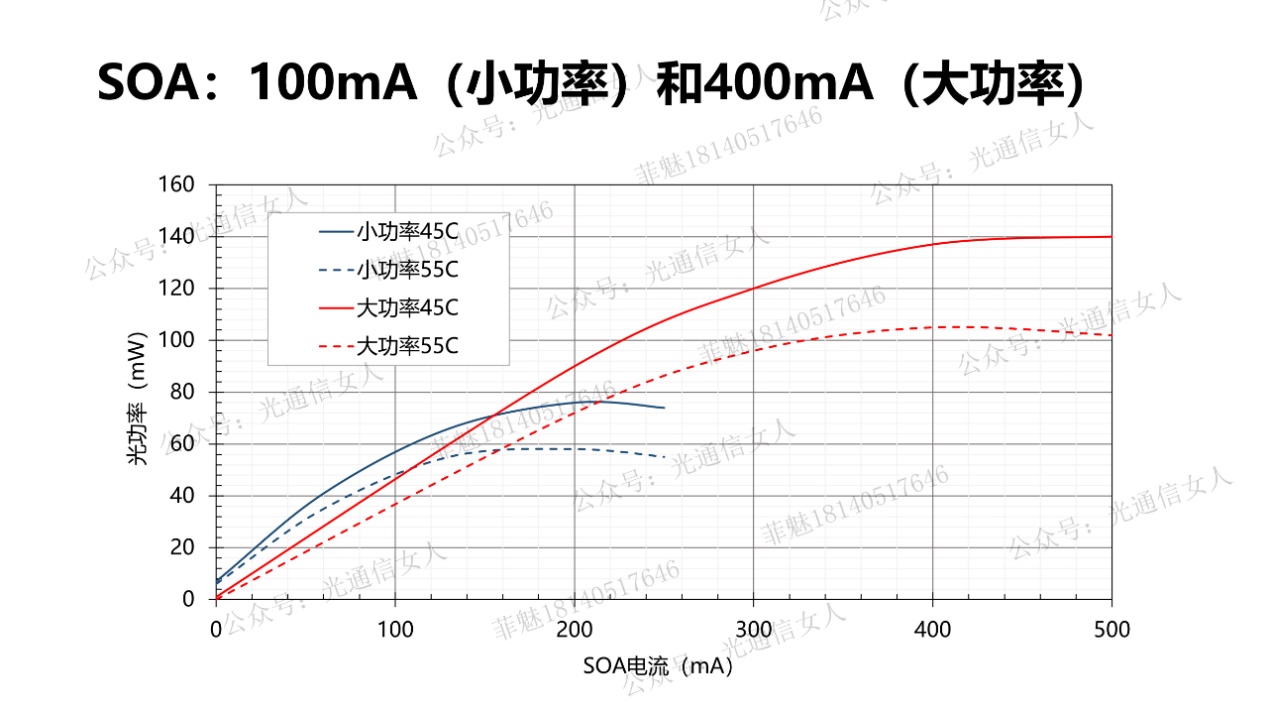
EML在PON的封装,是EML芯片--EML COC--EML TOcan--EML TOSA,是不同的封装阶段。
SOA 100mA和400mA做了COC的对比,在SOA 400mA是芯片中,进一步把COC封装成TOcan-φ5.6mm(就是TO56)做测试。
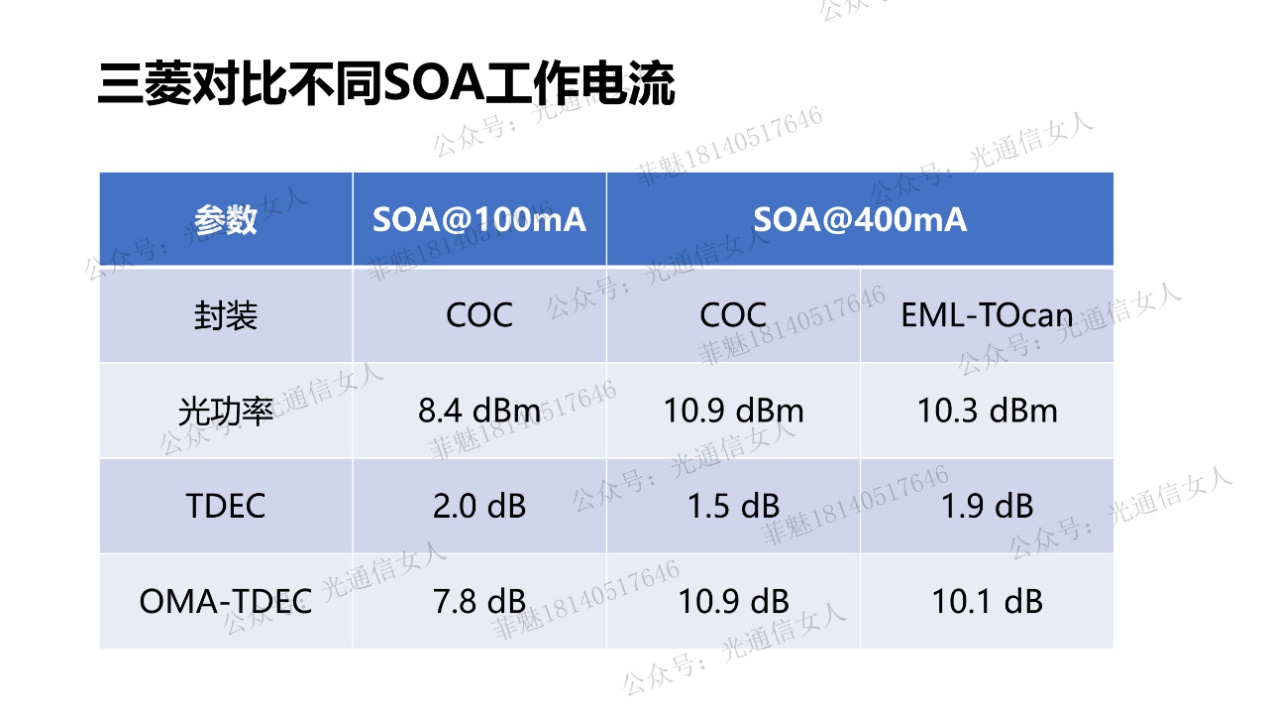
华为的EML-SOA,有DFB 100mA,SOA 100mA的测试,但坐标轴和三菱的不一样,我重新标定转换一下坐标轴,做个对比。