
信通院是工信部负责信息通信技术的战略、规划、标准化等工作的研究院,每年在光博会都会讲一些行业的技术与标准的进展。之前也写过很多,如
2021合集Y7T287 信通院:高速光模块标准进展
2023合集Y9T142 信通院高速光模块标准进展
今年信通院也有好几个报告提到不同领域的光模块技术进展,今天先写一个AI场景的。
Lightcounting在2024年中对以太网光学互联的带宽做了一个数据趋势表,随着AI产业的发展,AI光互联通信也开始逐步细分,从传统的以太网光模块用于计算的节点,衍生出以太网/IB的AI节点,以及NVlink采用光纤互联的节点,未来Memory之间的互联也会采用光作为通信载体。
~~,在《OFC2024 PPT合集》,我也整理了一些IB、NVLink、PCIe等节点之间的通信速率及厂家的观点。

对于AI应用,IMDD模块向高速发展,迭代周期明显加快,目前是基于100G/lane的技术形成的400Gbps、800Gbps光模块,且800G光模块数量超过400G。
1.6T的光模块技术预计今年年底头部厂家可送样,2025年成为商用起点年份。
同时,总体通信流量的增加,大规模组网,相干光模块的需求也是水涨船高,向大带宽发展。目前是128GBd进入商用周期,200GBd成为技术研究热点。
《OFC2024 PPT合集》,也写了一部分厂家相干模块或者相干调制器的技术细节,写了旭创等厂对于高速光模块的观点。

AI数据中心的组网,以胖树结构为主,模块数量数倍于GPU(DPU、CPU..)等芯片。谷歌目前是1.5:1,英伟达目前是2.5:1, 未来则会发展到10:1左右。
经过估算,GB200的GPU芯片,需要9倍光模块来配比。所以对低能耗与集成化需求十分强烈。

LPO,LRO、CPO都可以实现低功耗,这也是今年很热的几个词。
LPO虽然低功耗,但性能受限,2024年提出变体LRO的概念,用于提升性能。112G LRO初稿是2024年6月发布,224G LRO则预计明年初发布。
信通院引用了Arista对于LPO在OFC的演讲观点,其他家的观点大同小异。
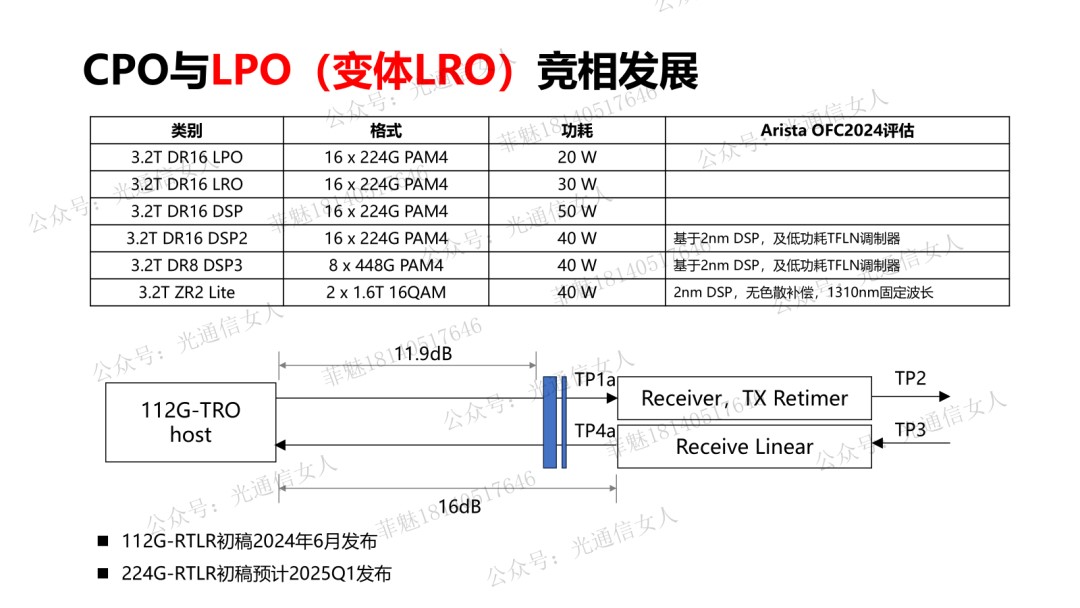
CPO则兼顾低功耗与高性能,但是光电合封需要更高的集成度,硅虽然具有高集成度的优势,但是硅是半导体,对电信号的互联损耗和寄生效应不友好。
2024年,主流的CPO厂家开始采用TGV过孔的玻璃封装、TMV过孔的扇出fan out封装来实现高集成度及电信号低损耗大带宽的结构。
我详细写过博通、Intel、Marvell、Cisco、AMF...等厂的晶圆级封装工艺。
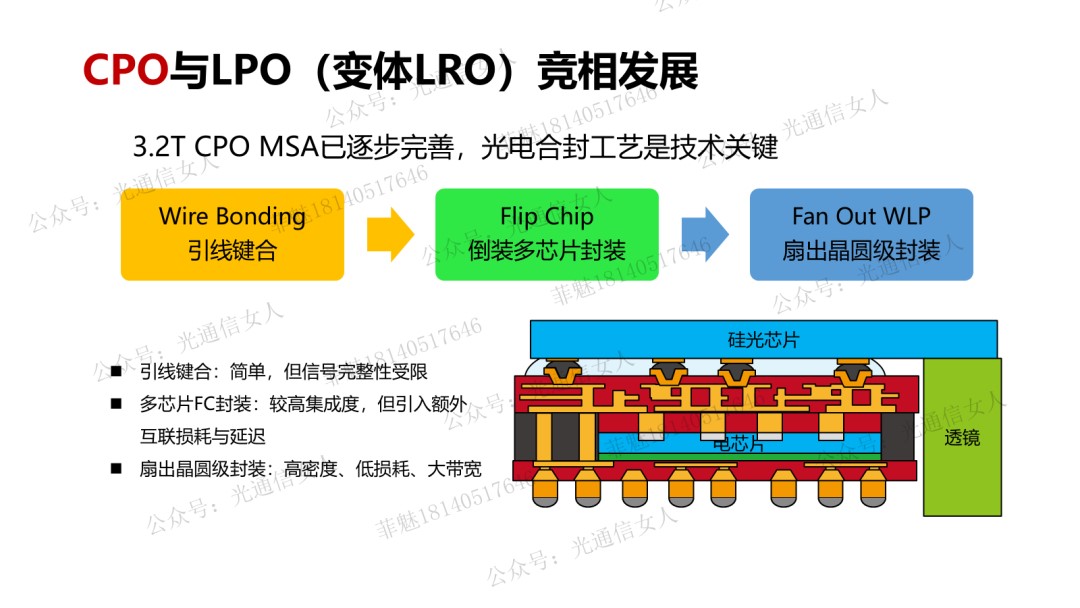
AI的组网需要大带宽高速光模块,推动了产业标准化工作的快速迭代。

另外,谷歌基于OCS的光交换可以实现速率兼容,低功耗等特点,已经开始商用,谷歌的mems OCS 136x136的结构,在2023合集以及2024的公众号写过很多,二维mems工艺,bidi光模块,光环形器,光纤孔板....
英伟达在OFC2024也做了光交换实验,收录在《OFC2024 PPT合集》。