Y7T158 OFC2021 II VI (Finisar)的co-packaging模块
更新时间:2021-06-07 14:06:31 阅读量:1166
OFC2021开始了,从昨晚八点到今天早上十点半,困的能横着走,不过确实看到一些内容。
咱们在5月30号的光模块硅光议题中,提到很多厂家的技术思路,基本上快得到印证了。
比如Finisar的用卡钩固定的co-packaging光模块,比如光电同口的ELS(合订本第146页,今天更多参与厂商),比如玻璃封装基板(在4月24号说的是射频性能,5月30号说的是光学性能),比如两个公司的边发射激光器的光路转换用于硅光芯片,等等。
挺有意思的。

下图是昨晚Finisar的CPO示意图,感觉我上面画的卡钩稍微窄了,是吧?不过原理基本就能对的上了。
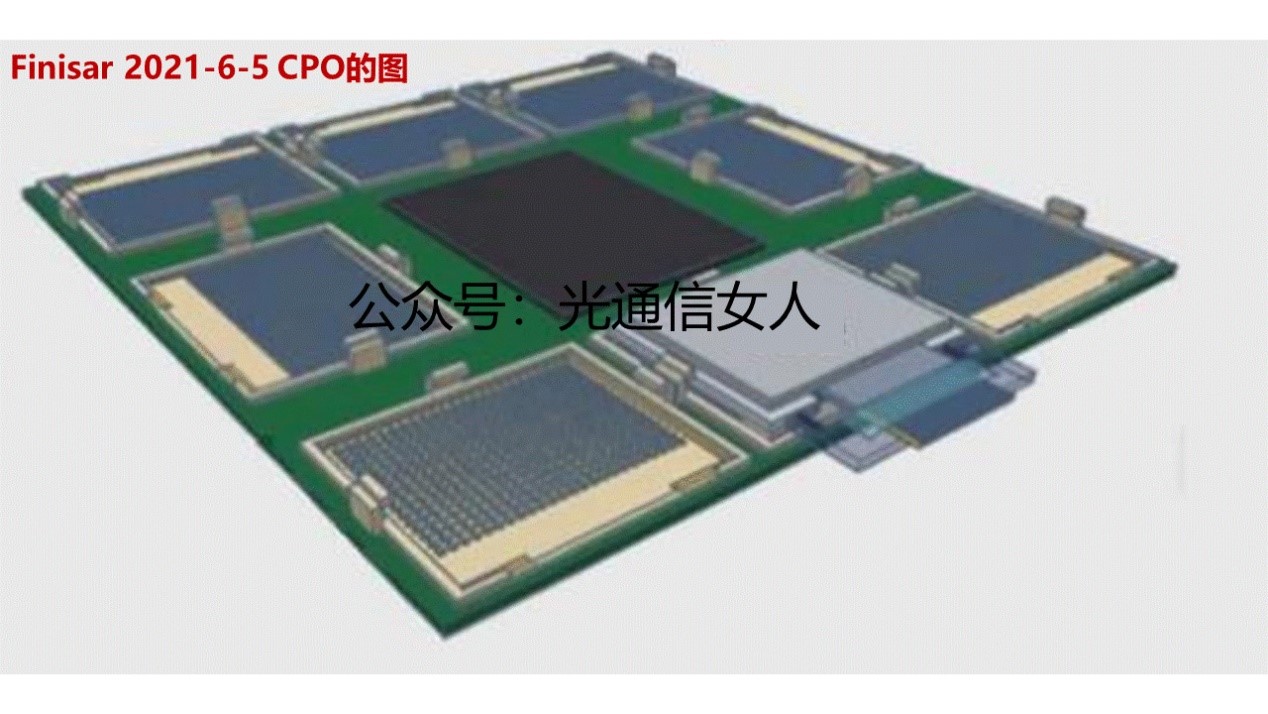
Finisar的硅光芯片与电芯片的图
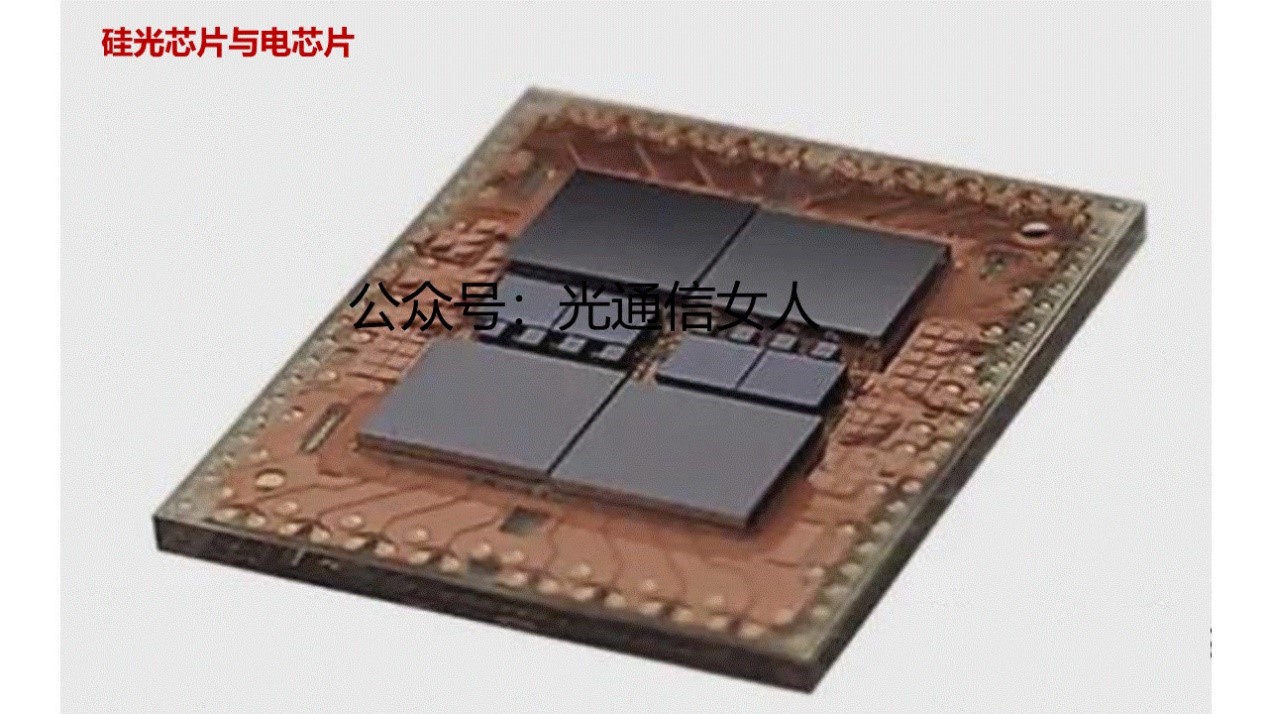
Finisar对玻璃封装技术,给出的图片,其实Finisar和康宁在合作,玻璃光学插件的部分是康宁的(合订本的第596-599页)。

虽然,Finisar推出co-packaging的模块样品,也推出GCL用于硅光的DFB激光器(合订本第649页),但基本的看法,则是倾向于热插拔模块的。
热插拔模块还可以延续到800G,除非co-packaging在这个量级上具有更好的成本以及功耗优势
co-packaging的封装,与Intel等公司的长波长单模应用不同,在多模领域还能存在市场机会,这个观点与十年前IBM用VCSEL阵列化做CPO共封装的思路很像(我们做OFC2020分析时聊到的)


简单写几句,回头不困时,再慢慢整理汇总。