Y7T168 康宁CPO封装概念
更新时间:2021-06-17 09:06:05 阅读量:2825
Finisar在OFC2021里,提到CPO封装的未来思路,
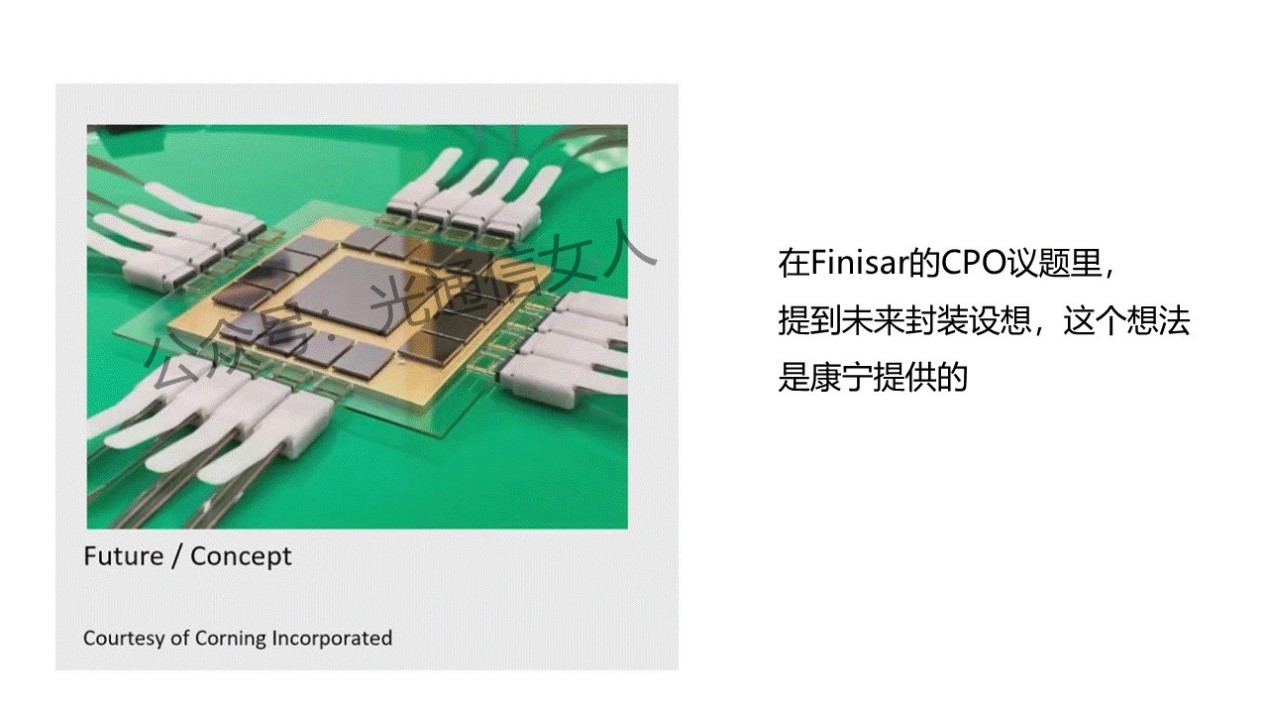
我画一下,绿色是玻璃封装基板,蓝色是光接口
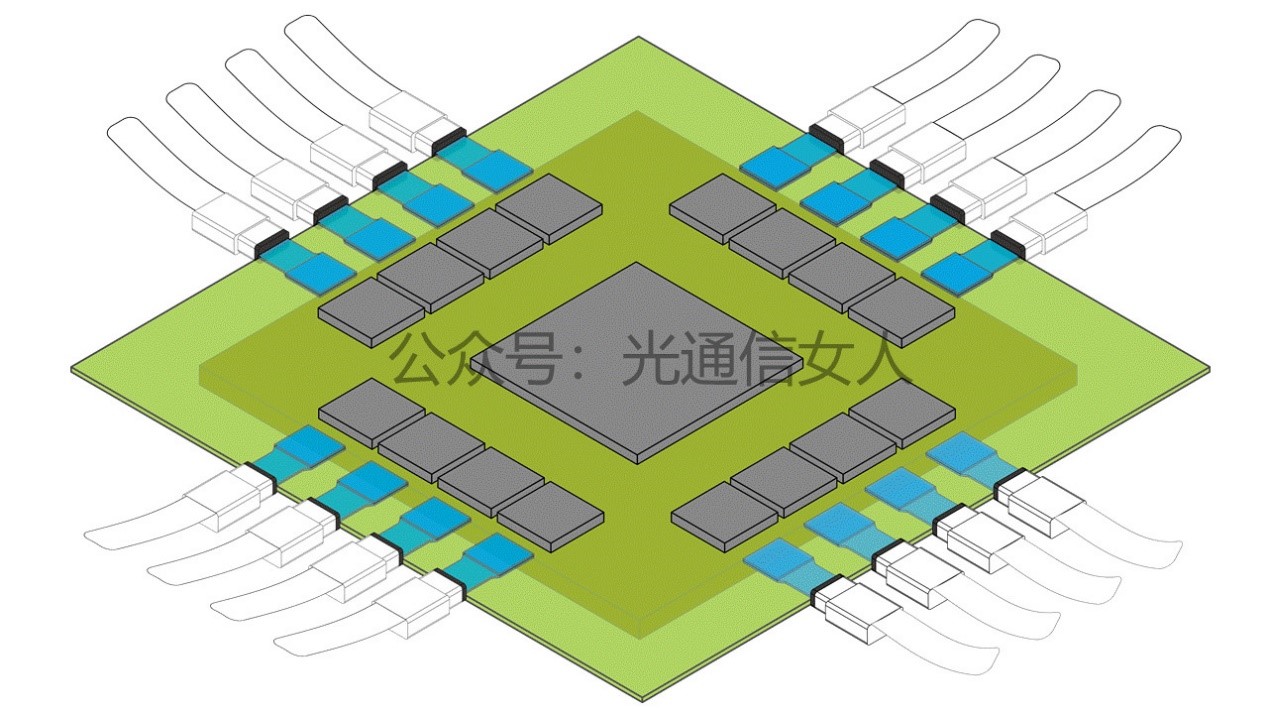
光接口,分两部分,一部分是蓝色的波导过渡区,用于连接CPO引擎中光的输入和输出。另一部分是白色的MPO接插件
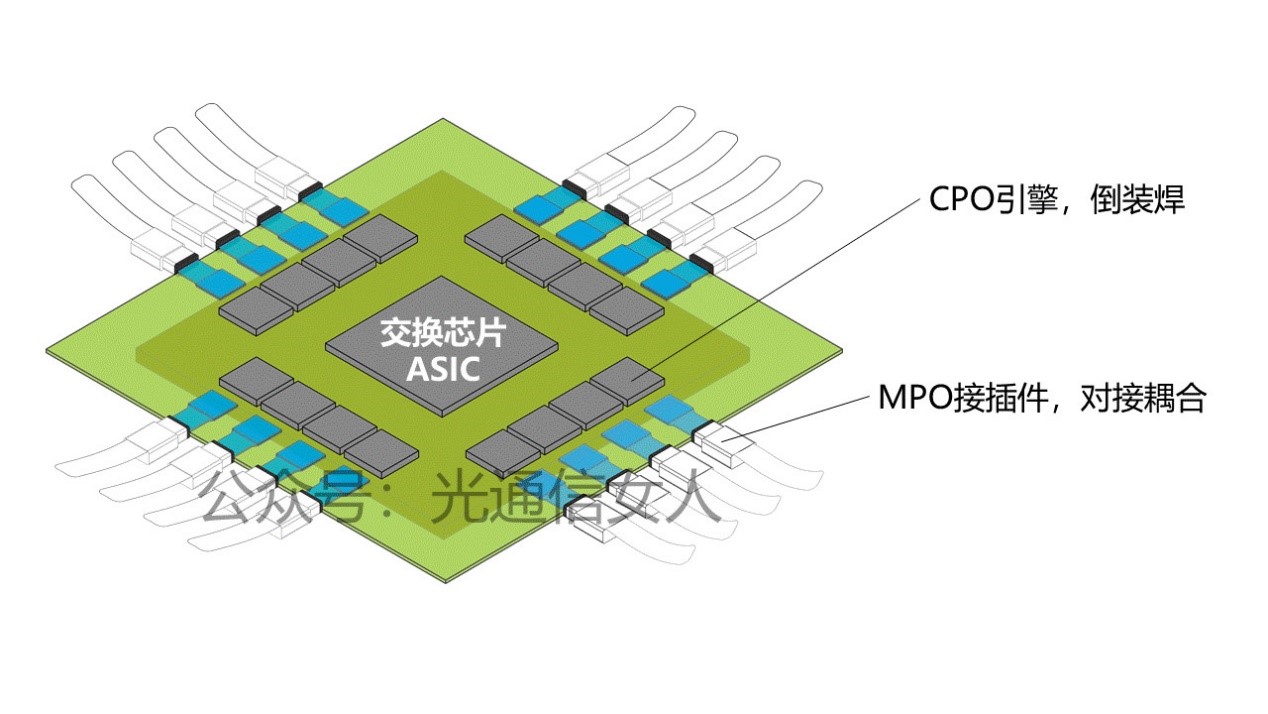
玻璃基板是即用于电信号互联,以及垂直孔在制作,也用于光波导的扇出。
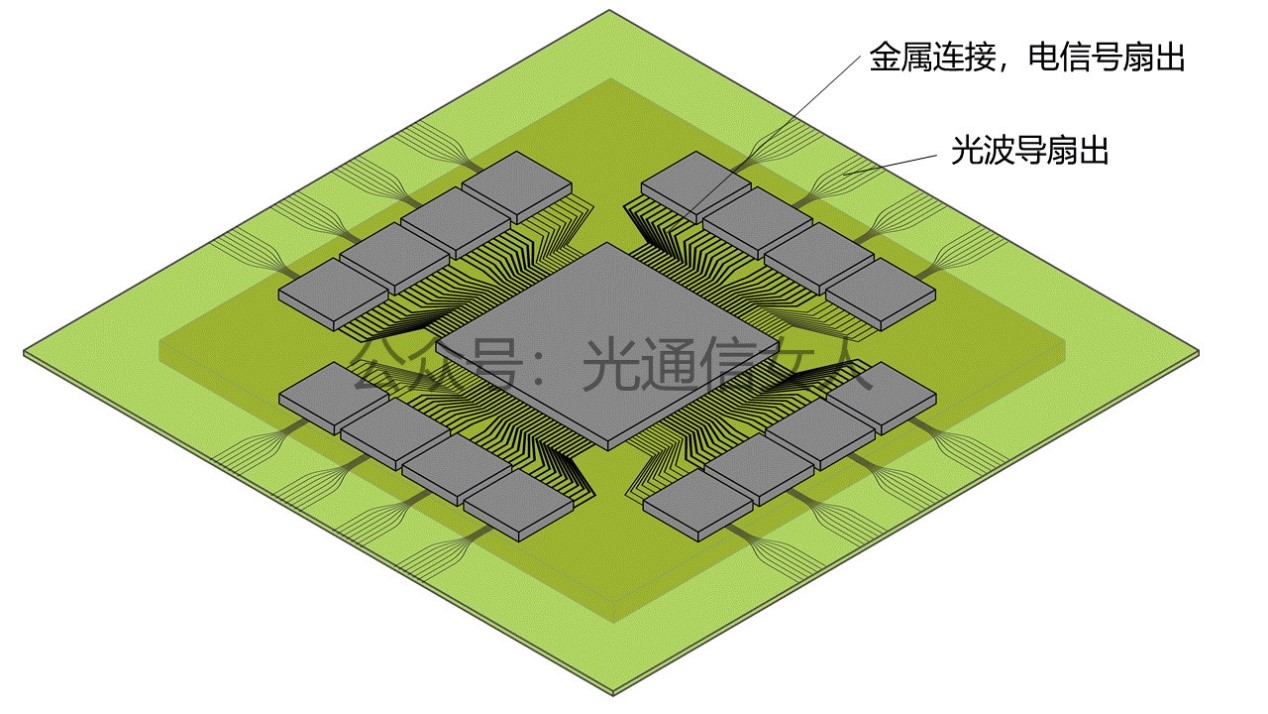
先看光波导部分,康宁在去年OFC上给出过一个CPO的光的扇出结构,硅光芯片的波导间距短一些,50微米,光纤的间距是250微米,所以需要做波导扇出,
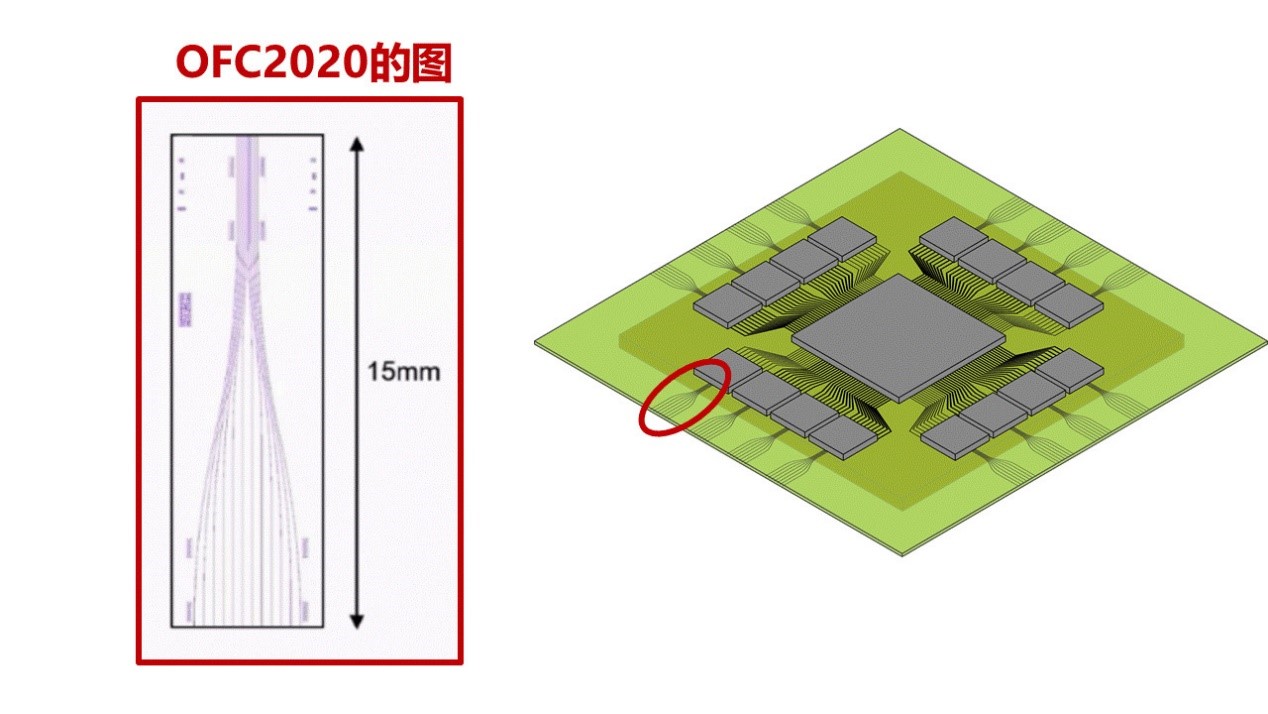
首先,CPO中的硅光波导要倒置,下图红色的波导,与玻璃基板中的波导做倏逝波耦合。
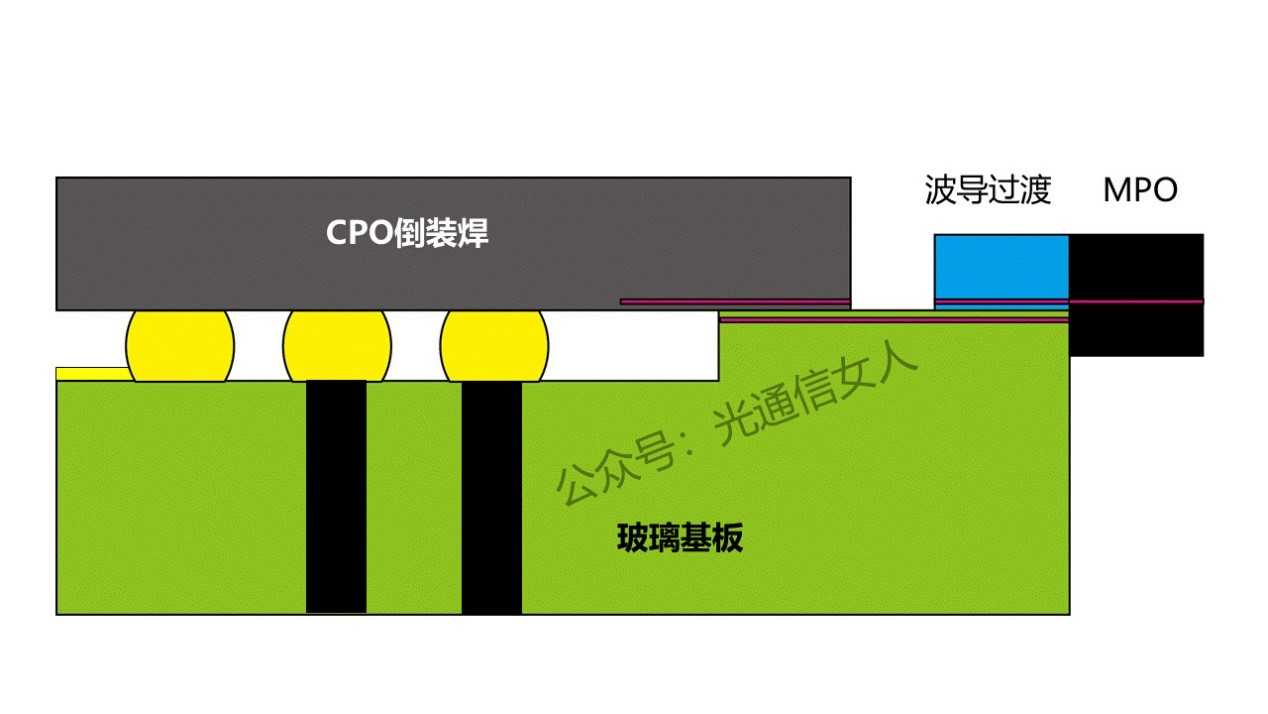
在玻璃中做波导,工艺流程在合订本里,客服18140517646,难度在于单纯做无源波导,温度变化不大,损耗可控。
用于CPO的波导,则由于ASIC的几百万功耗,光引擎的几百瓦功耗,让玻璃基板的热升高60-80摄氏度,对康宁来说主要处理高温下玻璃材料的折射率的指标,以提高耐温性。
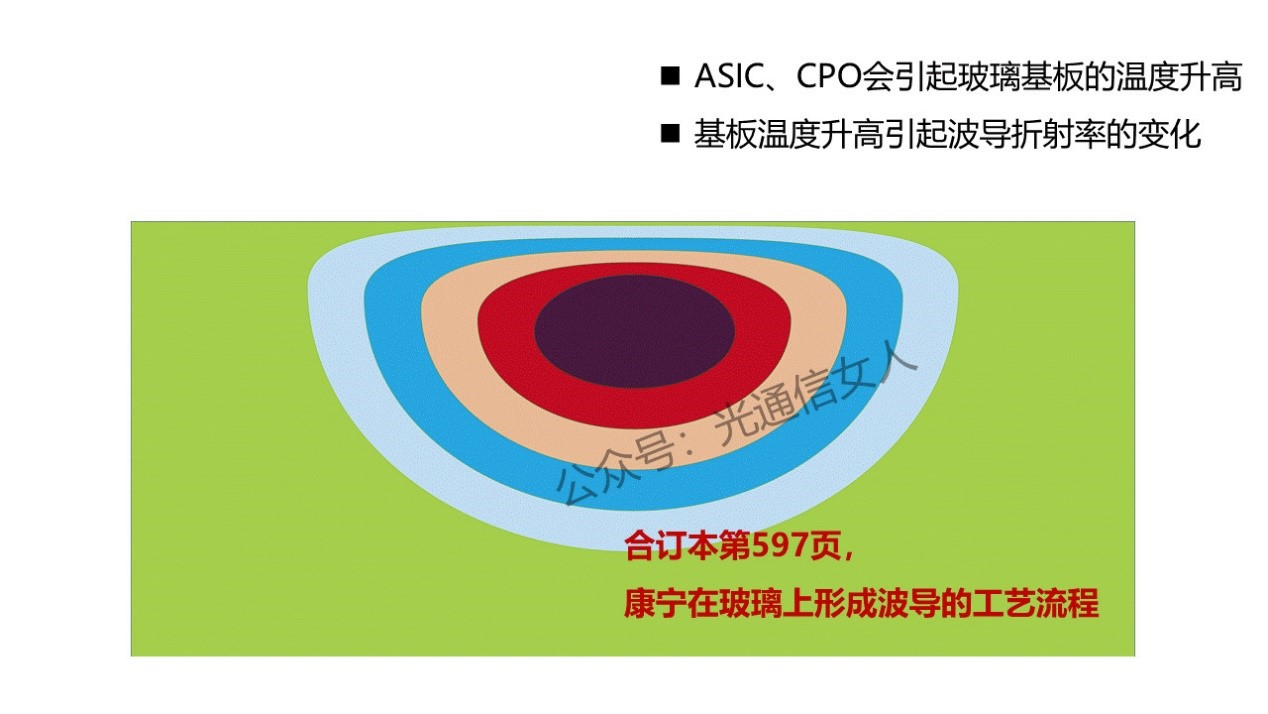
下图蓝色的部分,与玻璃基板的波导做倏逝波耦合,通过定位针,与MPO接插件做对接耦合。
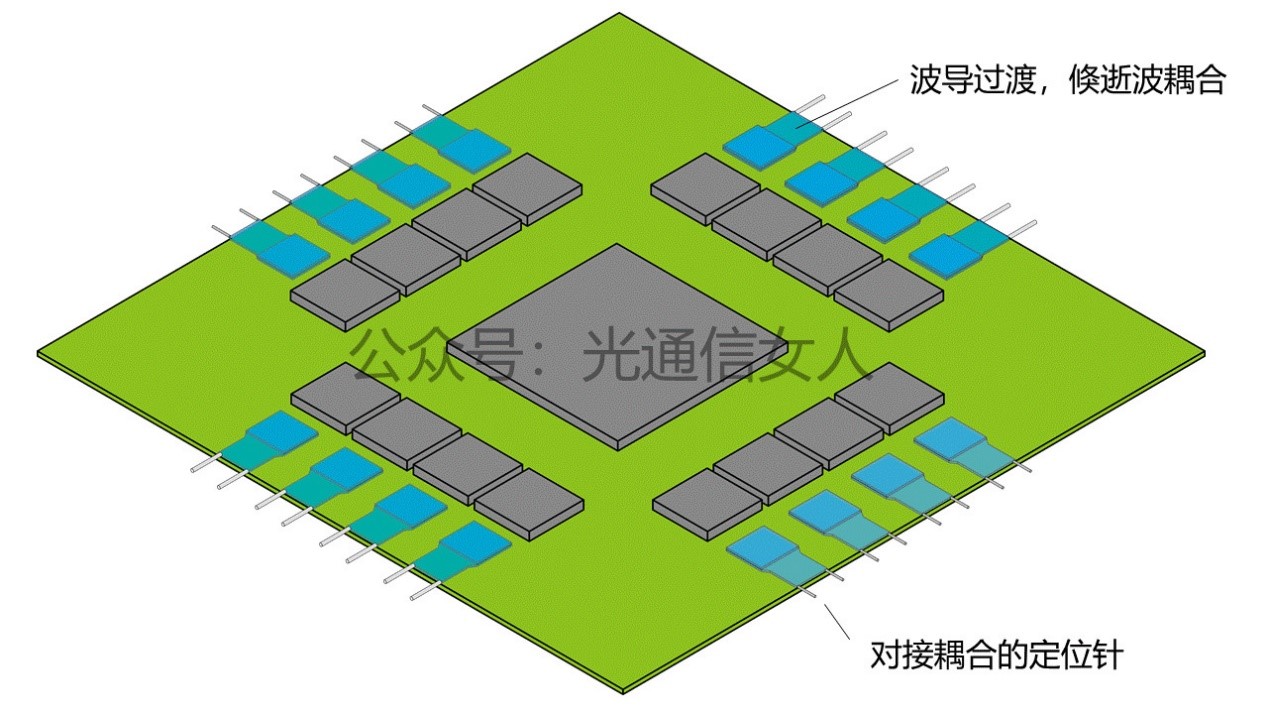


接着到电信号转换,硅,玻璃(主要成分是二氧化硅),陶瓷都可以做金属垂直通孔的封装基板,但玻璃和陶瓷适合高频,这是因为二氧化硅和陶瓷都是绝缘体。

而硅不适合高频,硅是半导体,为了防止金半接触的肖特基特性,需要在硅氧化后再镀金属,形成了一个半导体-氧化硅-金属的MOS型寄生电容,影响了高频信号的特性。
Y7T132是硅通孔的工艺流程。可以点击链接看, Y7T132 Inphi 用于CPO 3D封装的硅光芯片后道处理
陶瓷基板,在咱们行业做电信号的过渡与封装,非常普遍,但是需要额外做光学互联,陶瓷制作电通道,做不了光学路径。
硅和玻璃,都可以,光电兼容。
