Y7T179 光组件COG封装工艺
COG,chip on Glass,在玻璃基板上做封装,我们的液晶电视啥的,这个领域很多。
咱们光模块,比如Finisar用的多一些,前几天吧,写Finisar的CPO封装,里边提高了硅光集成、玻璃封装以及空间封装三个技术路线,其中有个图我理解错了,感谢小伙伴提醒。
下图应该是COG,
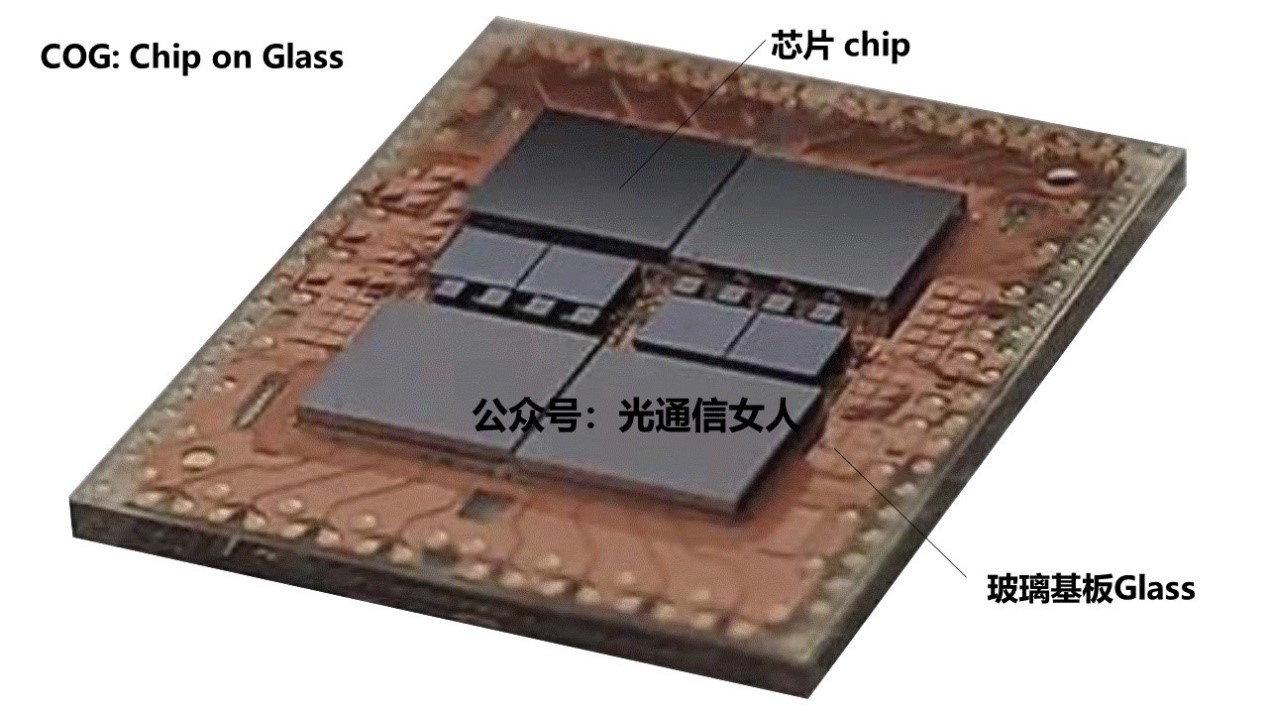
因为可供参考的资料很少,这几天,我去翻了康宁/Finisar的一些资料,做辅助理解,总之惯例,错的那就是我的错,对了说明是她俩的技术好。
下图放大,那几条小黑线彩色信号线,红棕色的并不是金属,而是涂层。
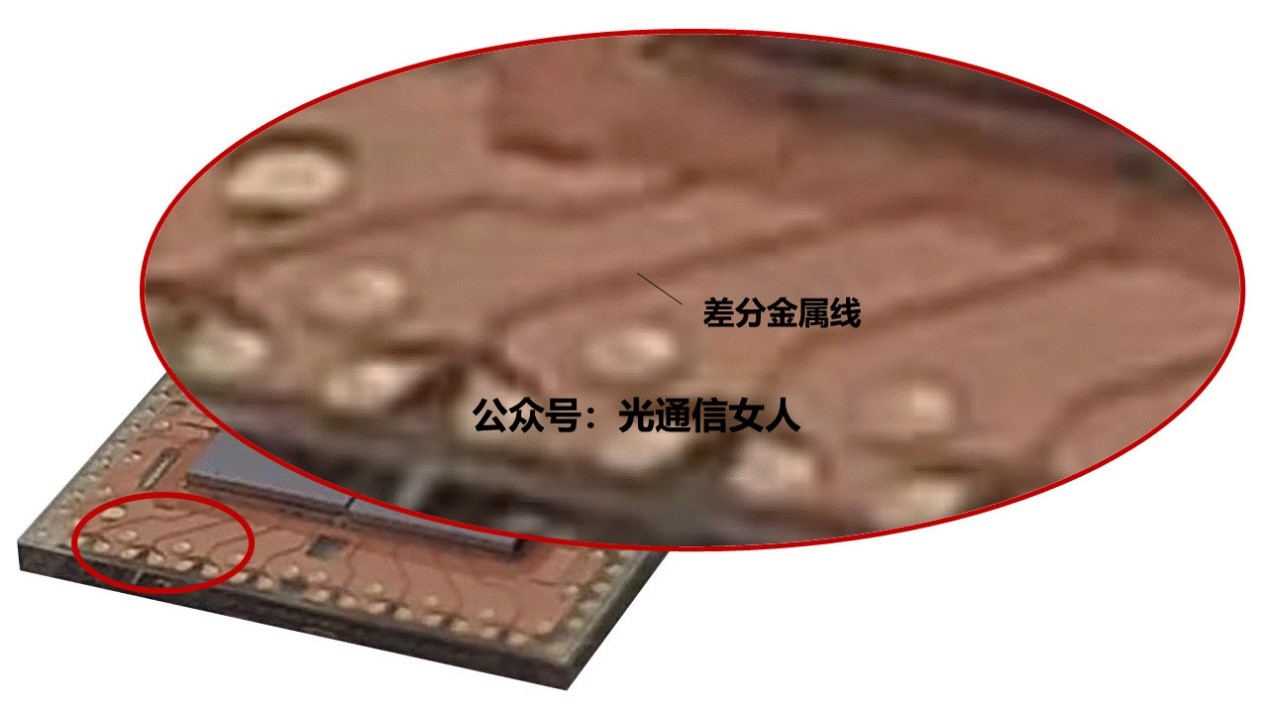
我画一下哈,
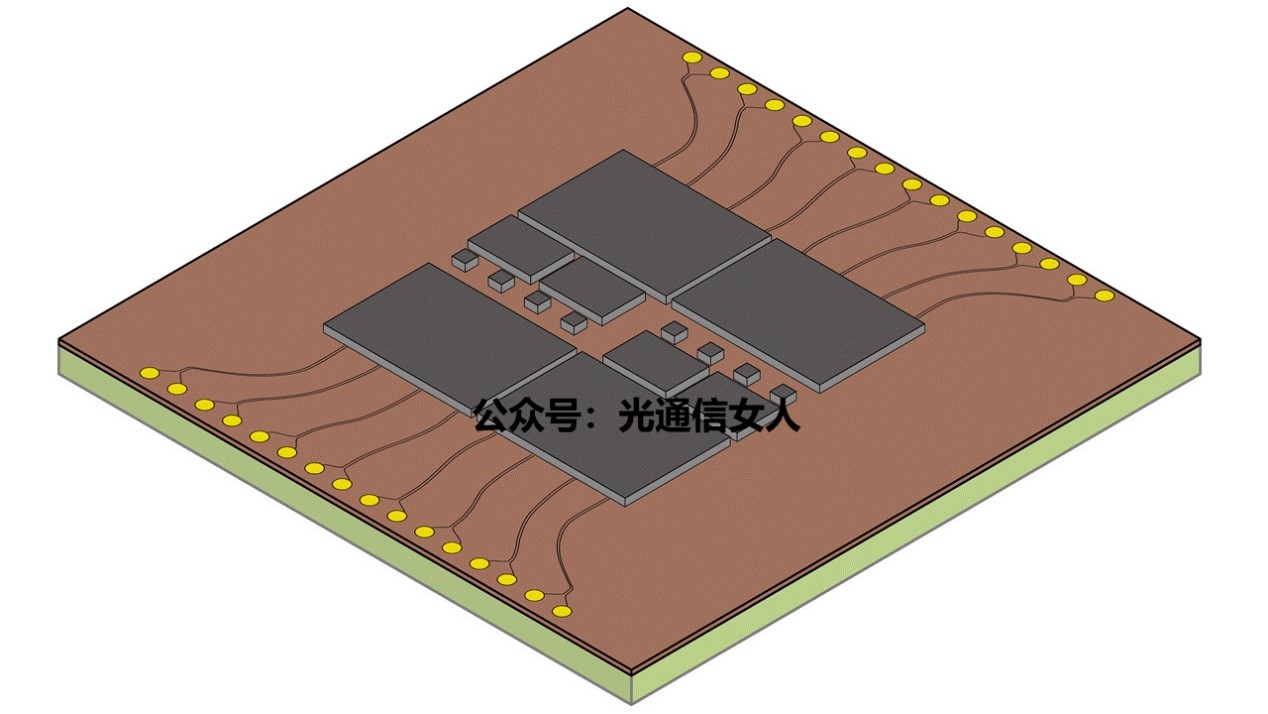
局部放大,涂层,可以用聚酰亚胺/铁氟龙啊,这些介电常数很好的材料,降低射频损耗,提高传输线的带宽。
焊垫布在周边,一会儿和PCB焊接
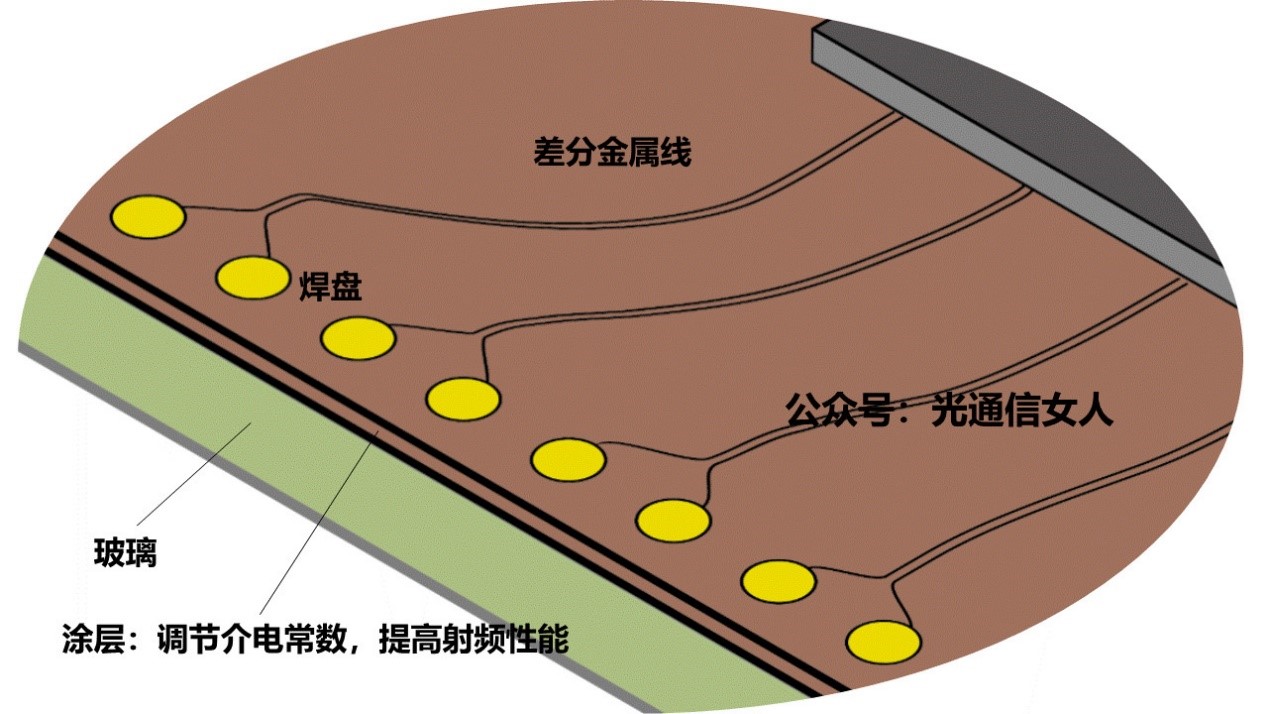
涂层在光学部分,开窗,利用玻璃的透明性,做测试窗,光路进出窗口。
封装基板的侧视图如下,这也是为什么Finisar提到CPO的时候特别倾向于VCSEL和PD方案,光路容易和COG实现,另外,Finisar的GCL激光器,光路也是边发射转为垂直方向,(GCL激光器名词解释,在合订本第648页)
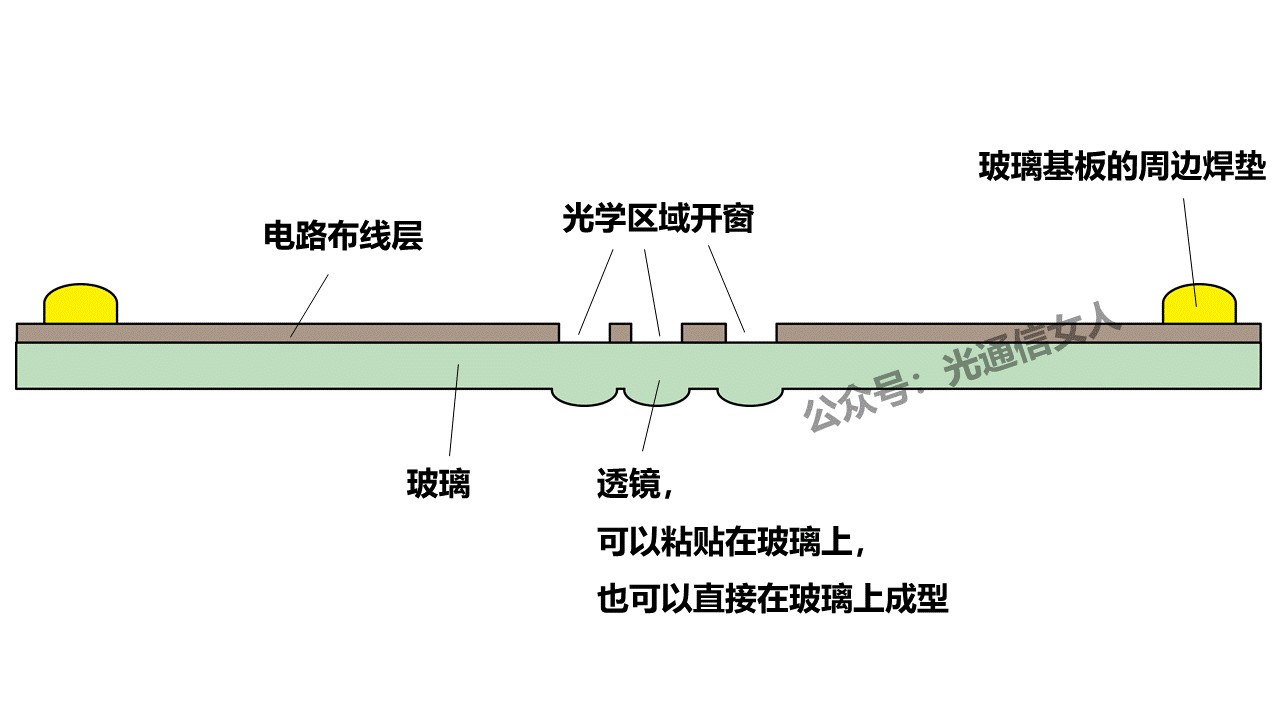
用玻璃做基本封装,和陶瓷以及硅基板的区别如下。

芯片COG焊好,且光学芯片对准测试后,从wafer上切割,开始后端封装
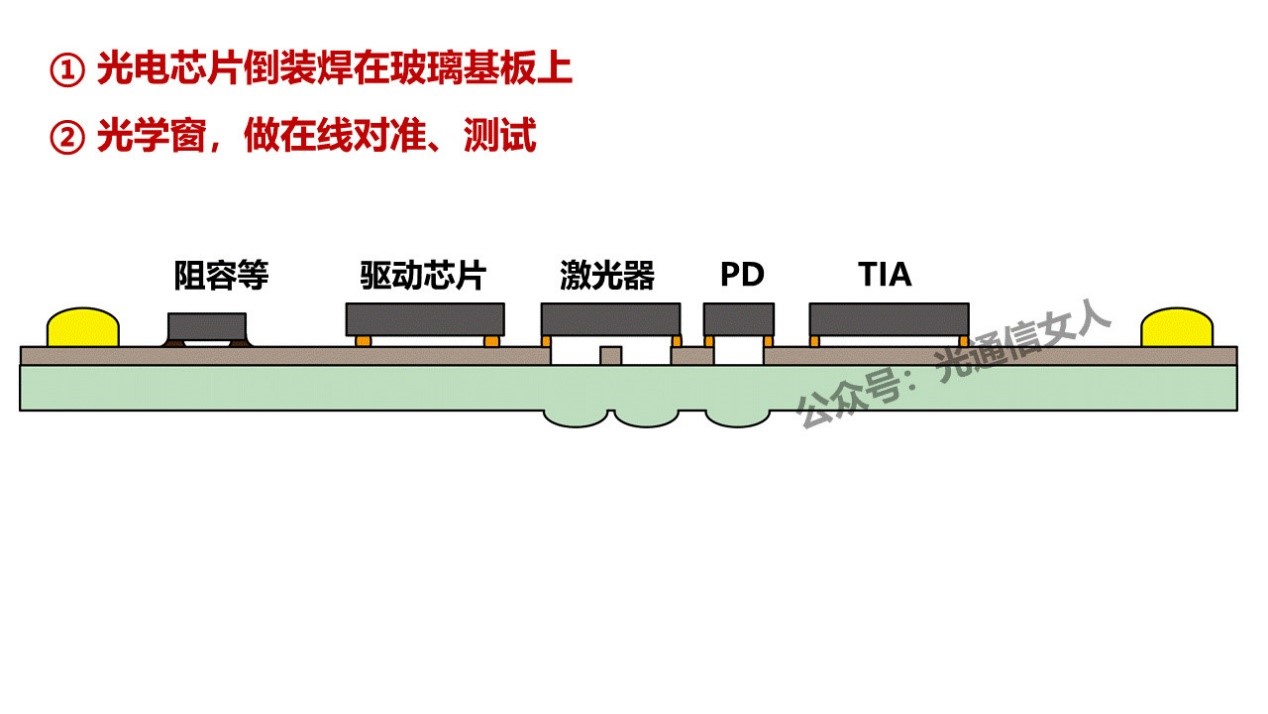
接着,对芯片做灌胶水,有几个作用,一是折射率匹配,不影响激光器和探测器的整体光路,第二对倒装芯片起到机械支撑的作用,第三对光学芯片起到半气密性封装,提高可靠性。

芯片底部注胶工艺,在合订本的第497页。
多说两句,合订本很厚,起不到完整的系统性的理解,(这个是在光模块/器件/芯片的解析章节,是随着我的学习不断更新和梳理),合订本的作用怎么说呢,像个词典吧,对应的一些名词/工艺,拿起来翻一翻。
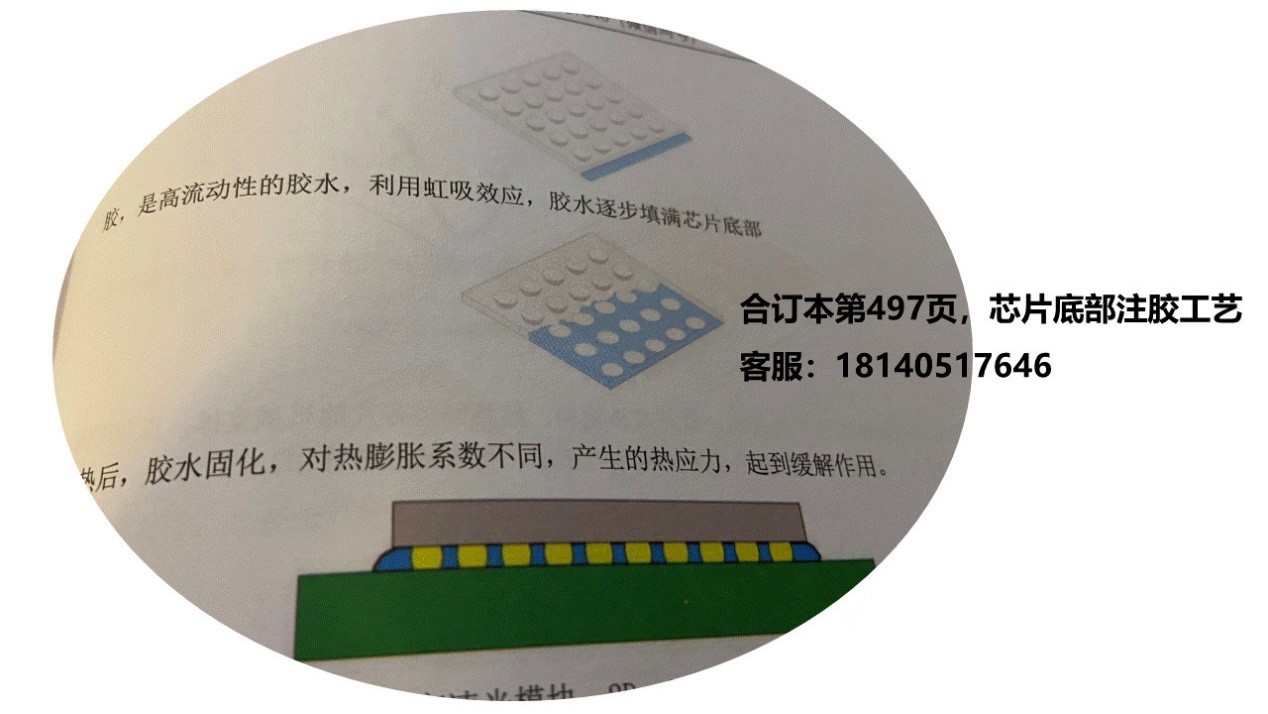
COG焊好光芯片电芯片后,注胶,再之后封盖,金属盖内部贴导热硅胶,硅胶软一些,保障的是与芯片的良好接触,建立导热路径。
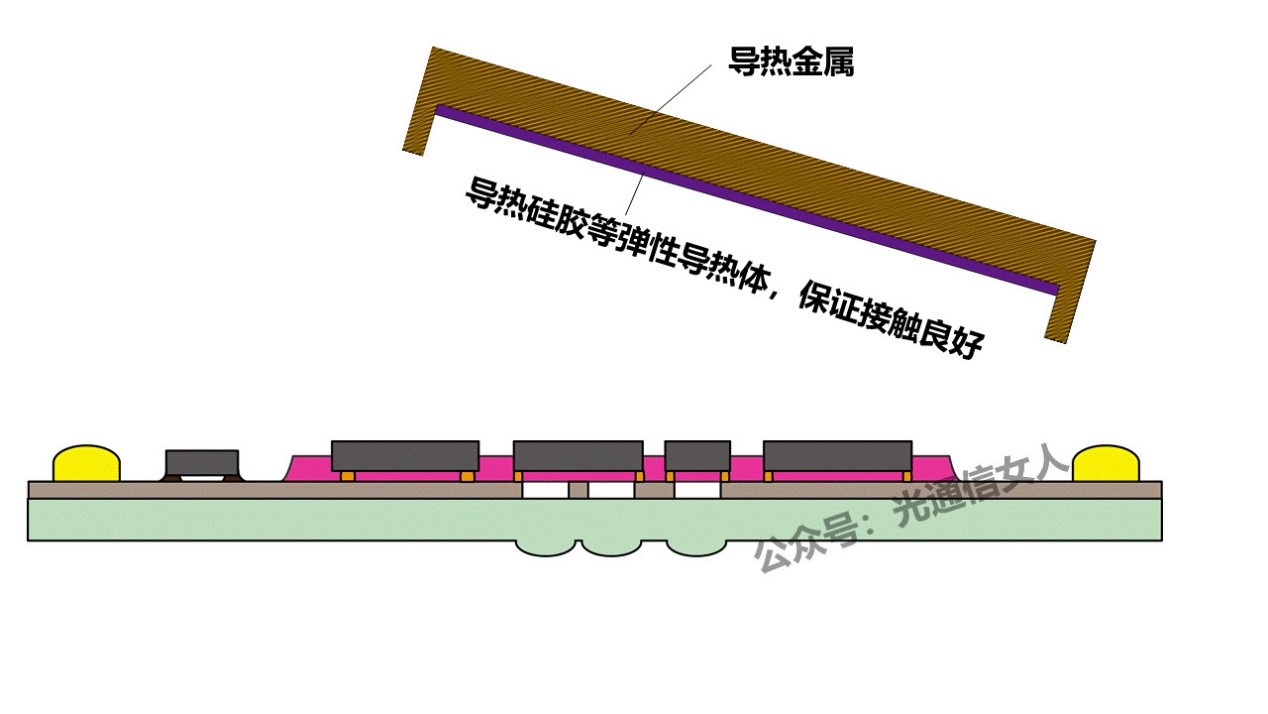

COG子组件,还漏出周边的焊点,与PCB(中空)做电连接,中空的部分置于铜或钨铜基板,用于导热。