Y7T266 华为:数据中心内部800G方案
上周,华为在ECOC有个报告,对数据中心内部,也就是2km以内的800G光模块的方案倾向性。
800G 小于2km传输,先说结论
一:使用IM/DD直调直检,而非相干。
二:使用热插拔,而非CPO
三:使用200G/通道,而非其他
四:使用PAM4格式,而非其他,如PAM6等。
先论述,200G/通道的光信号速率是一个大节点,电信号可以是100G或未来提升到200G,这个光学通道速率可支持到下一代热插拔的800G,以及下下一代的OBO/CPO封装的1.6T应用。
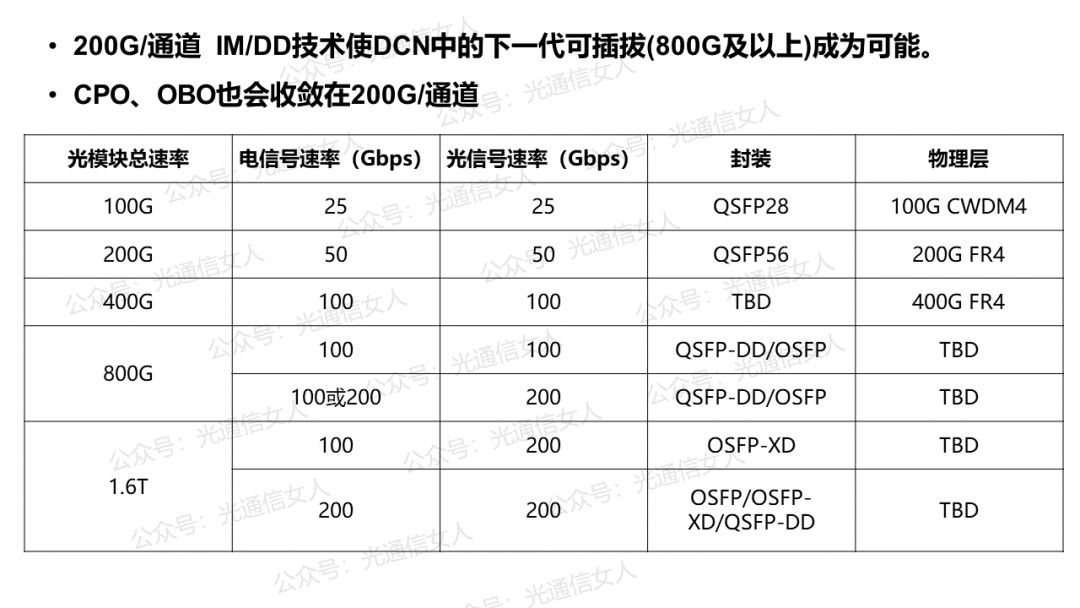
原因是,采用直调直检成本低,且200G/通道,光学器件少,成本低且功耗低。
4x200G IM/DD,性价比最高。比相干的性价比高,也比单通道100G的性价比高。 (国华备注,这个结论与Intel不同,Intel的激光器是集成在硅上的的,成本计算方法不一样)

接着华为论述,在2x400G,PAM4格式的光学优势更明显,国华备注:华为的这个结论和之前咱们写的Broadcom和Inphi不同

单波200G的产业链可实现性,
高带宽的光电器件,DSP的FEC以及调制格式(格式已倾向PAM4)
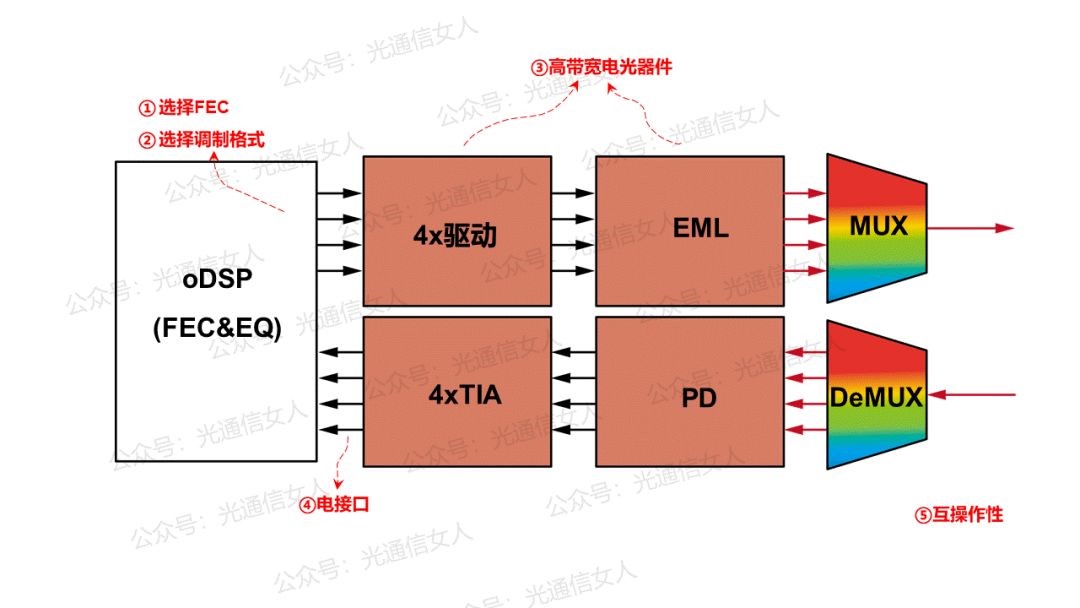
FEC在400G,采用了级联方式,在800G要做超级级联,来增强编码增益。

单波200G,各个节点的带宽很重要,不过单一功能的带宽,产业链基本有产品提供,具备推动成熟的产业基础。
另外,要关注通道间的延时,以及噪声。
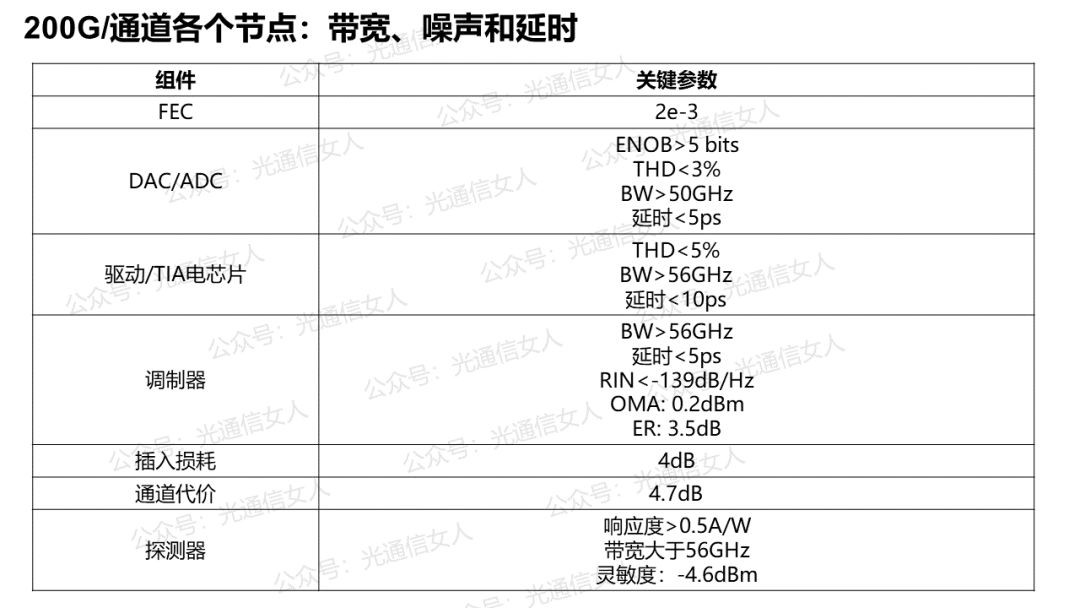
800G的4x200G方案,不能选用传统的器件封装方式①,目前400G光模块的封装以②为主,将来800G要以③为主。
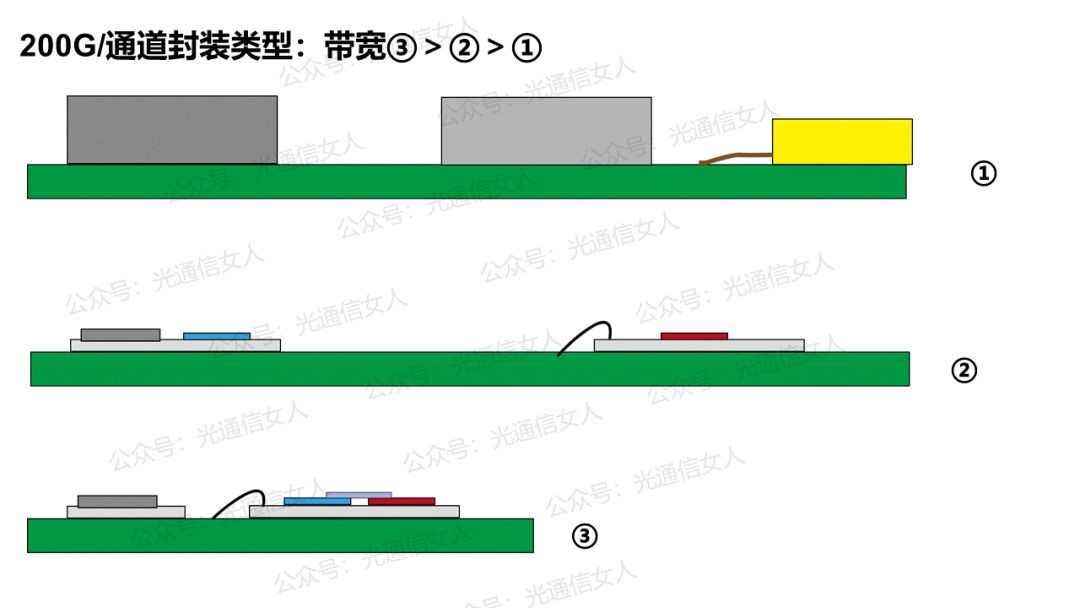
第一种类型,传统结构,DSP独立封装,光器件独立封装,通过柔性板连接。电信号的连接距离长、节点多,不适合更高频的封装应用。

高速光模块,电芯片很多是裸Die,做chip on carrier/PCB/Galss等等,缩短距离,降低高频电信号衰减。
光芯片也做非气密的COC/COP/COG/COS等封装,取消柔性板,降低电信号传输距离,减少电磁波的反射节点。

进一步的封装,模拟电芯片驱动芯片/TIA等,靠近光芯片,且不用金丝做过渡,采用中介板,比如GSV、TSV等。前几天写过的。Y7T257 带TSV的硅光集成中110GHz下的高频仿真与建模