Y7T364 TIA/Driver等芯片的的铝焊盘与金丝的键合
更新时间:2021-12-30 07:12:57 阅读量:2132
TIA/Driver芯片上,有些产品选择铝做焊盘,Al是活泼金属,很容易氧化,但铝的氧化物薄膜反过来又是一个保护层,可以保护内部的铝不被氧化。
成为一种低成本焊盘的选择材料
是咱们光模块COB中常见的键合材料

其次,铝焊盘厚度大约在2-3μm,太薄则在金属键合后引起弹坑效应,导致焊盘破裂,或者产生内部应力,影响电路性能。
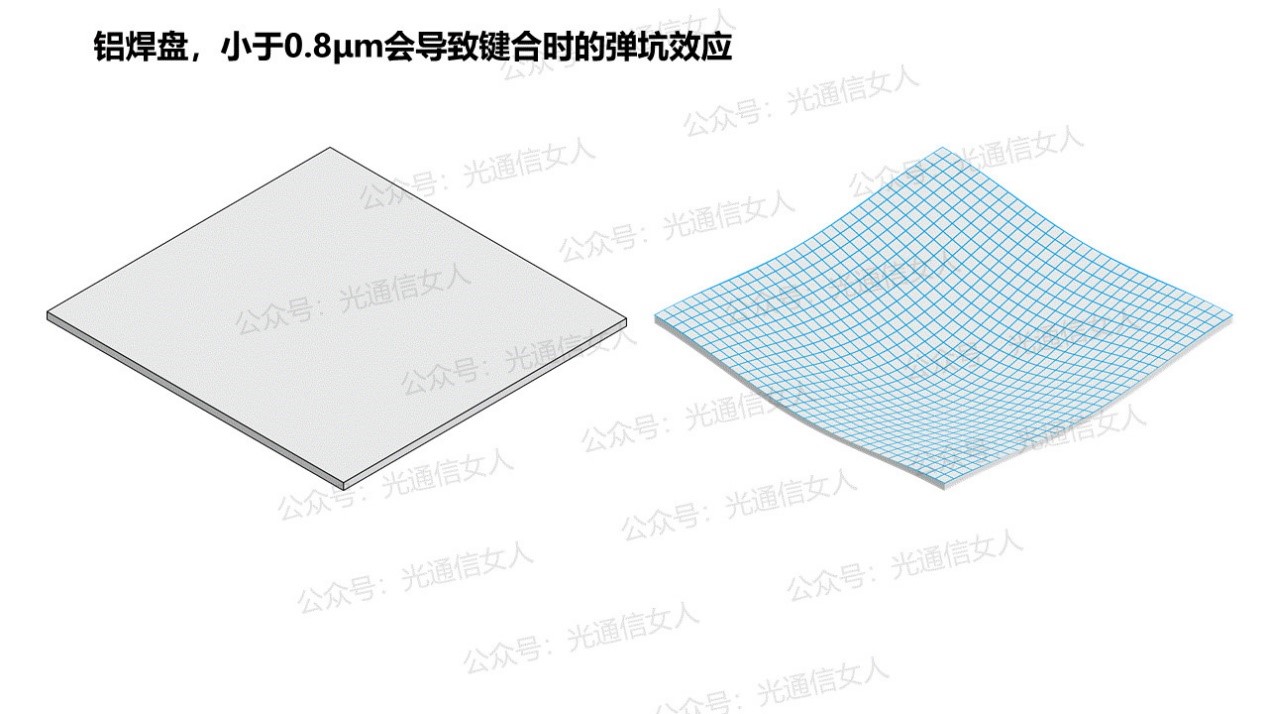
第三,在略厚一些的铝焊盘上做金丝键合,是有超声波摩擦,并加热金丝成球,这个过程将氧化膜去除,金和铝产生合金,形成键合力。

这个过程,非常重要,除了咱常见的金丝弯曲等等,产生的金属疲劳导致的可靠性风险外,

键合的超声波频率、温度、外部环境等等,都与键合可靠性相关。

先说外部环境,如果只有单纯的氧化铝,键合后如上图,没问题,电通道中间没有氧化铝,整体的电信号通道是低阻型的。
但是如果后期有水汽附着,以及环境中存在水溶性离子们,就有可能对氧化铝或金-铝合金层产生腐蚀,腐蚀后,露出内部的铝,铝被氧化,在电流通道中形成氧化物聚集,就增加的电信号通道的电阻,影响整体的电路性能,且会出现过热,出现可靠性风险。
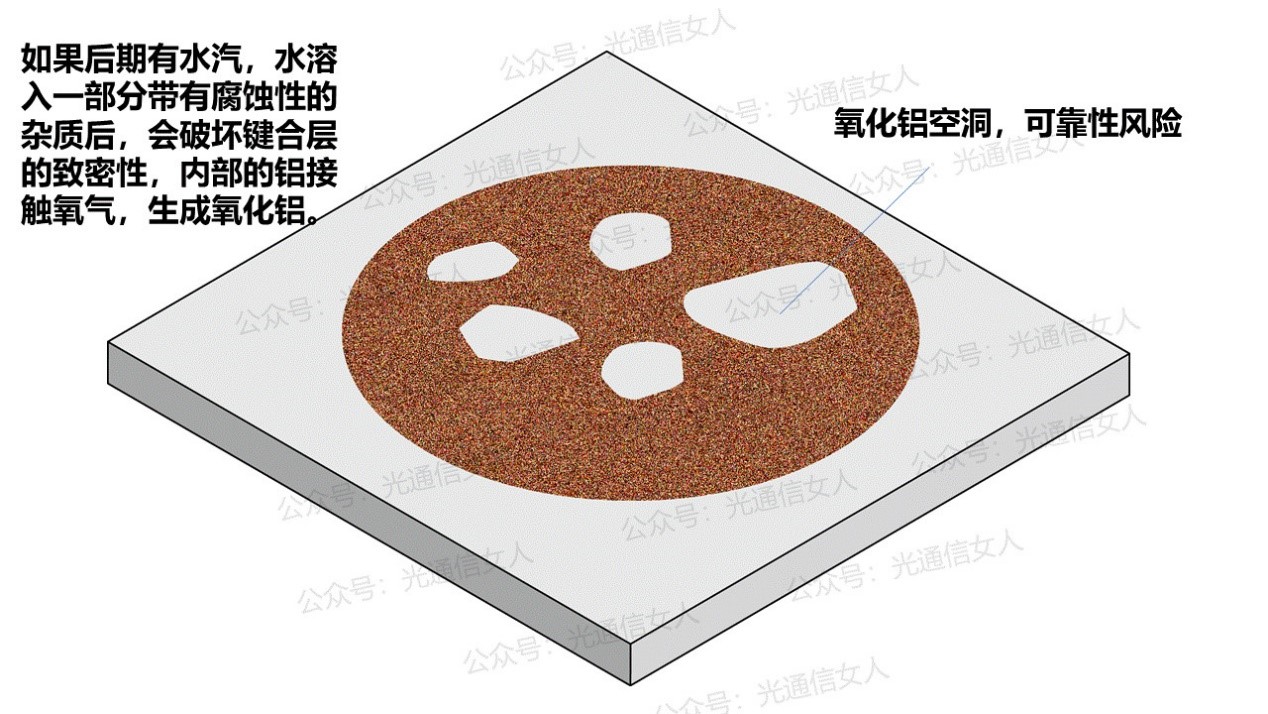
再说键合时的超声波频率和温度设置,理想的金铝键合如下,产生足够的键合力,保持低电阻特性。

但是,金和铝由于金属扩散性,金向铝中扩散,铝向金中扩散,二者的扩散速度不同,就会导致空洞,扩散速度和温度相关。
这是键合条件的一个可靠性隐患。
另一个则是,金-铝的金属间化合物,有一些金铝成分导致材料分层,裂纹,导致键合失败。