Y8T192 博通 CPO 引擎GBA焊盘
更新时间:2022-07-11 09:07:17 阅读量:898
在PCB板上采用SMD焊盘,焊盘与PCB的结合力要比NSMD要好一些。2022年,CPO的光引擎标准已经到2.0版本,底部可以采用BGA焊接方式

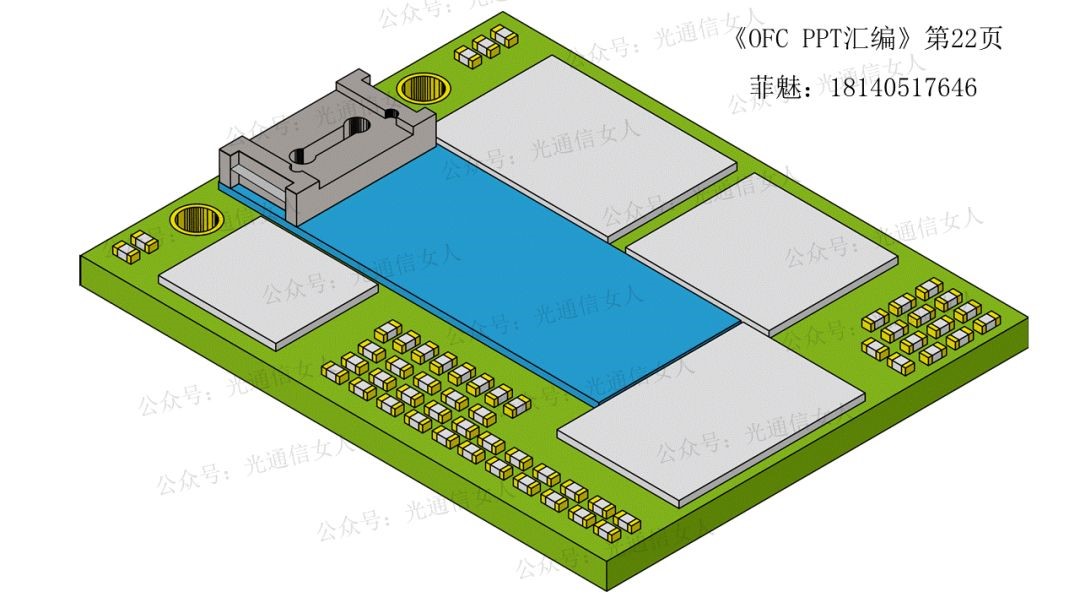
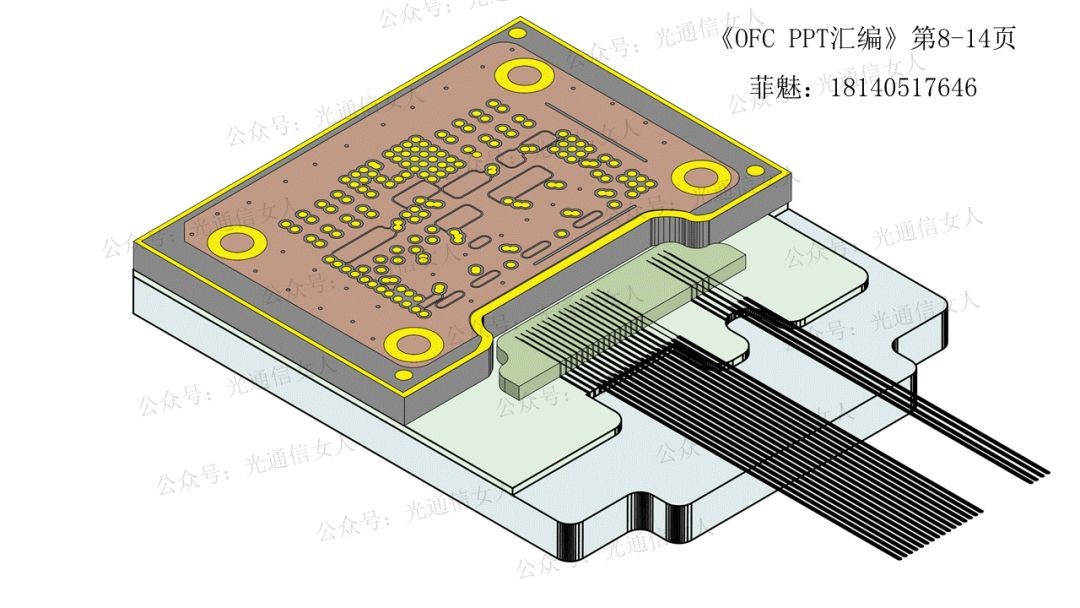
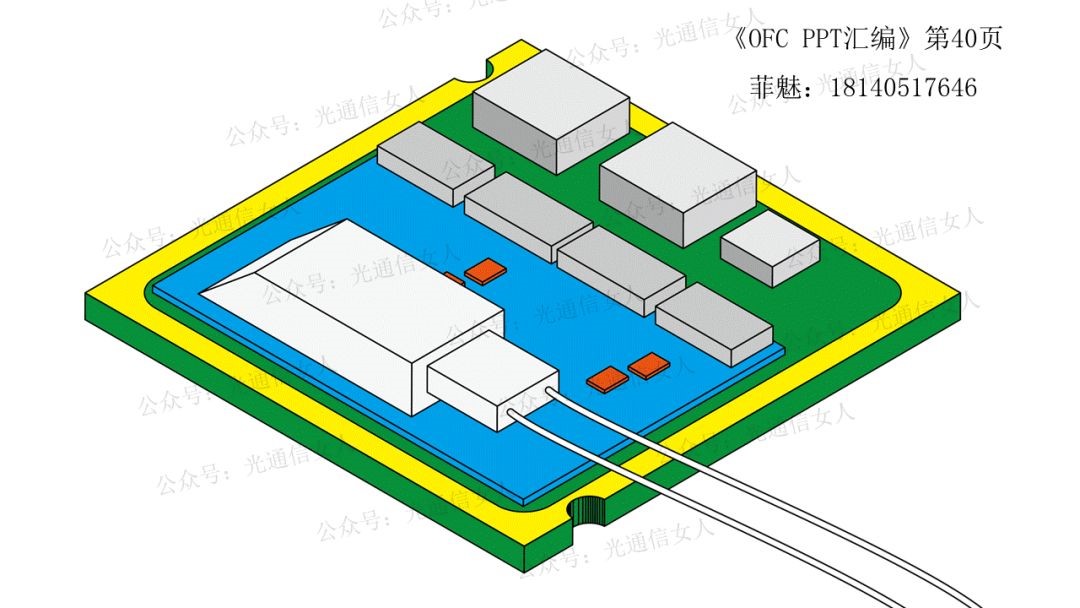
PCB的底部植入BGA 焊球,对芯片而言,可以用单面贴片,也可以用双面贴片

如果是双面贴片,底部贴片高度要控制,要低于焊球的高度


CPO底部焊球,低速部分是600μm间距,高速部分是600μm和900μm的纵横间距。
由于CPO的底部焊球非常多,要考虑高频特性外,还需要考虑可靠性,防止焊接后产生焊盘剥离。
我把底部焊盘,翻个面,看一下博通的做法。
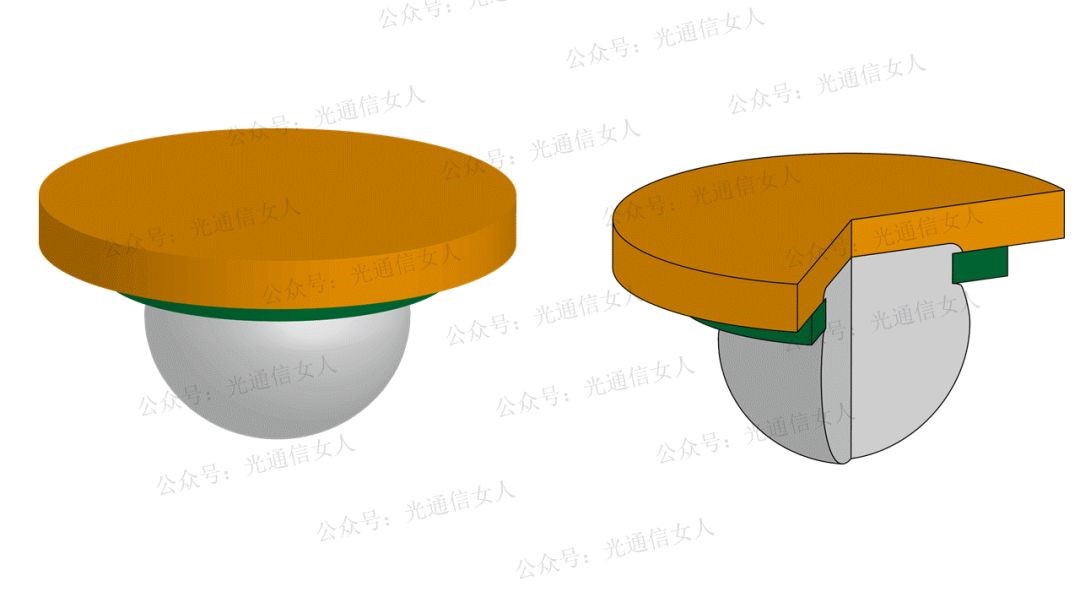
首先,焊球不在HDI板的底层焊盘植入,而是在倒数第二层的铜箔处进行植球,增加附着力,防止剥离。
高速PCB板,一般用改良半加成法来做HDI高速PCB,在解释旭创PCB工艺里,合集2021上第183页,有工艺流程图。
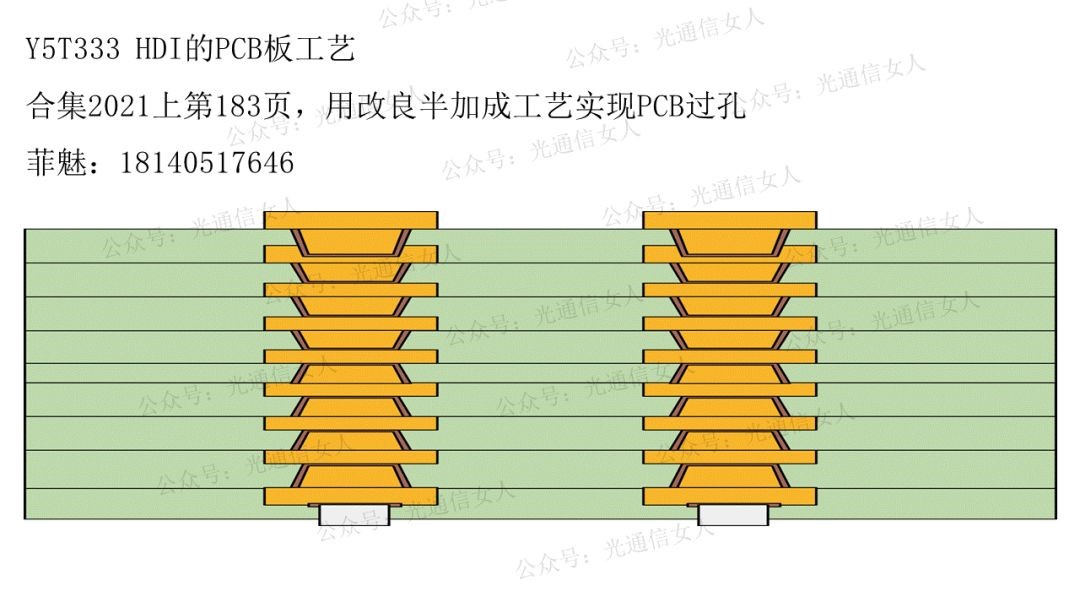
把底部翻面后看,增加一道焊盘的“微刻蚀”工艺,把焊盘刻蚀浅槽1-4微米的深度。 在Y8T177写过铜箔厚度,0.5盎司在18μm厚度,1盎司是36μm厚,这些焊盘上刻蚀一个前凹槽,用于增加附着力。
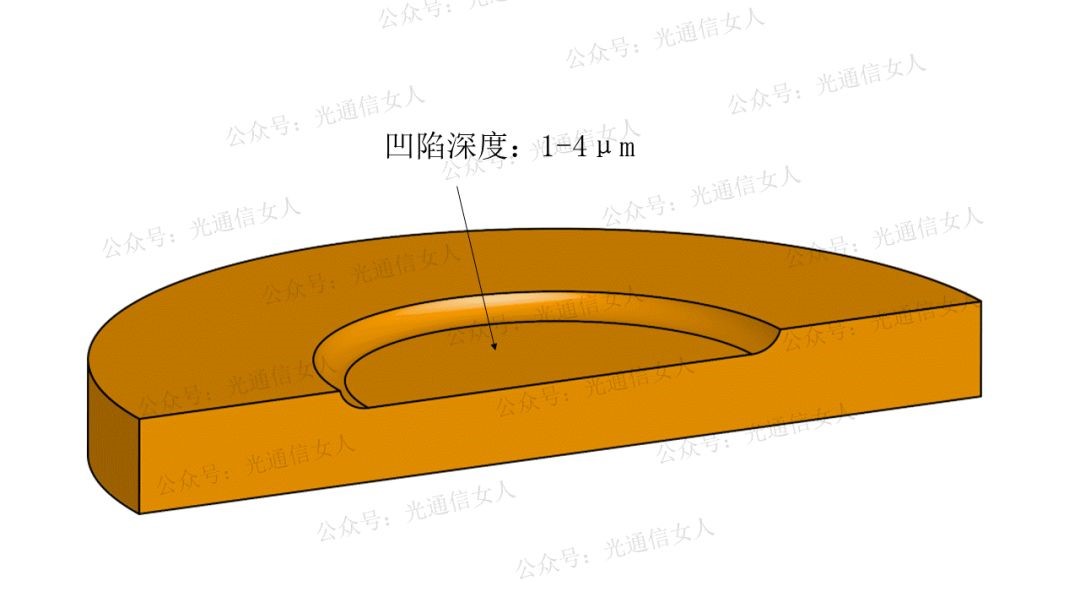
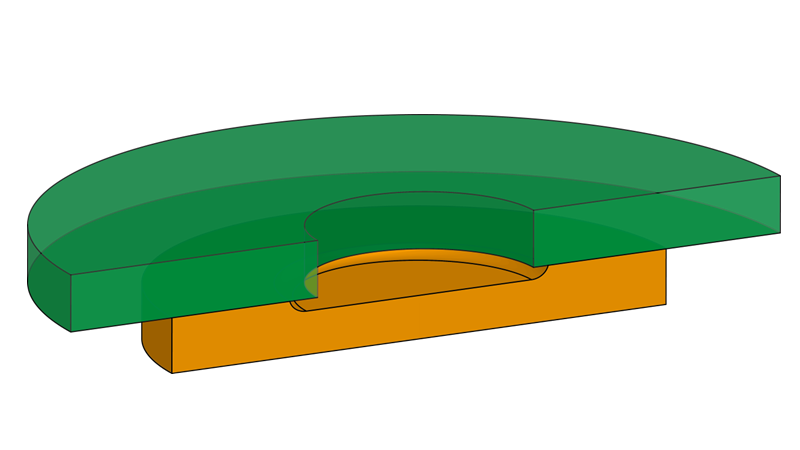
阻焊油墨要大于浅刻蚀凹槽的直径

阻焊油墨的位置,铜箔凹槽,有3-5μm的内嵌距离比较合适,这样CPO的焊点强度才能保持住。

