Y9T79 NTT Flip Chip的EML芯片封装
更新时间:2023-03-24 08:03:57 阅读量:2872
大多数EML封装,采用金丝键合,有一些采用台阶来降低金丝长度,如华为、Lumentum等等,提高带宽。有一部分采用金丝并联,降低寄生电感,提高带宽,如Broadcom。这些在合集里写过多篇,也不赘述了。在今年OFC,另一家提到2021年NTT的Flip Chip倒装焊的EML,可以将金丝的等效长度降低到75μm左右,进一步提高带宽。
NTT的这个细节,在2023年初做了一些技术披露,写一下,EML的DFB电极,电吸收信号电极,如果有SOA的话,SOA的电极,这些都是P型半导体接触,传统EML,采用N型衬底,很多家也选择的N型底面电极,NTT选择的N电极表面沉积,一方面Flip Chip,需要GSG在一个平面,另一方面,可以提高一些带宽。
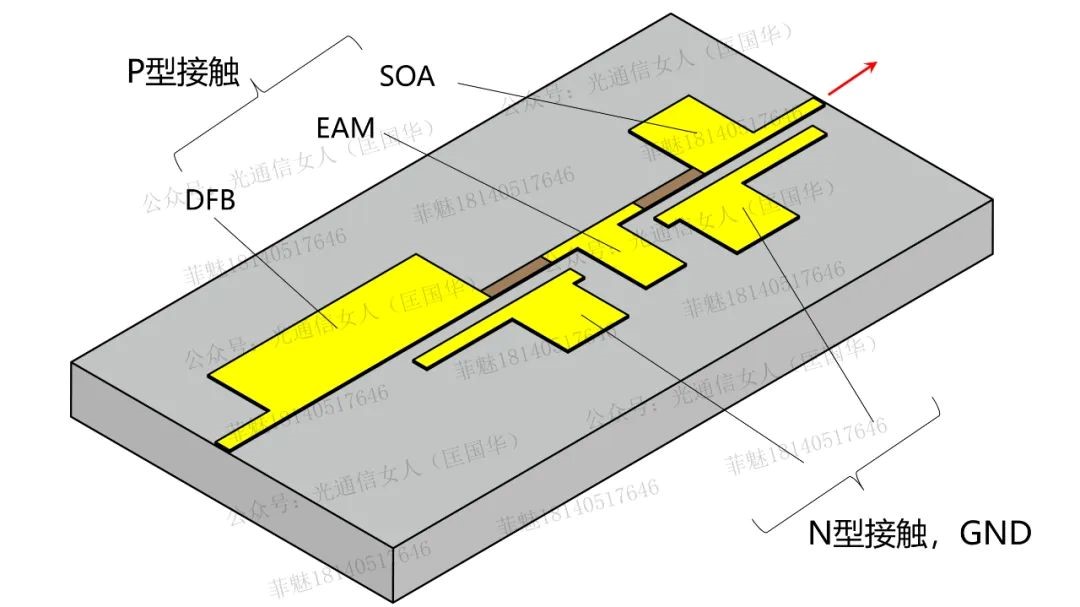
EML采用了SI-BH结构,合集2021上第106-110页是这个结构的工艺流程。P型表面电极与N型表面电极,截面如下
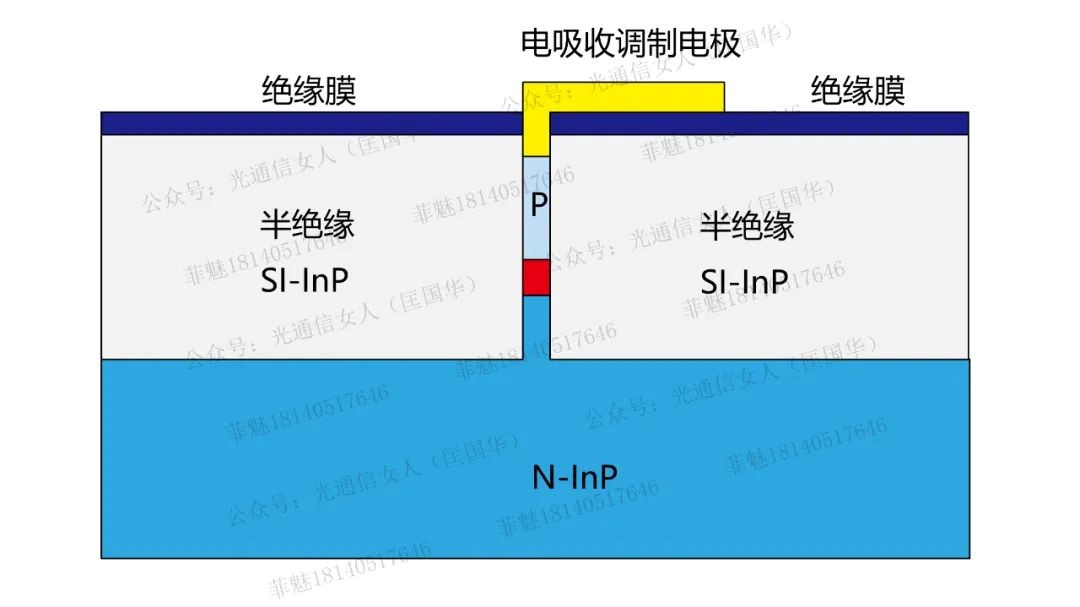
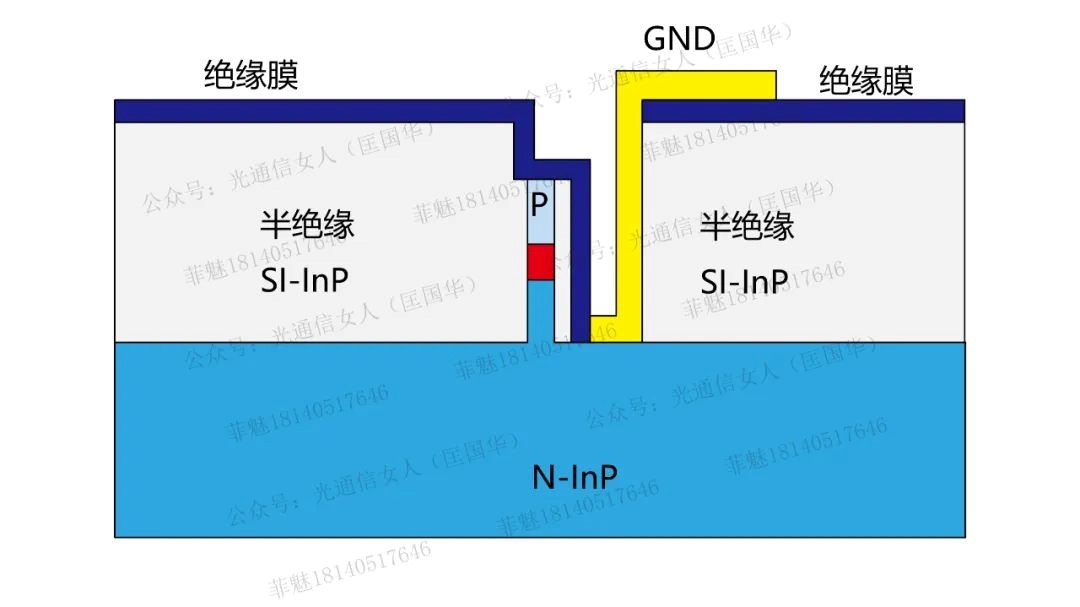
EML的封装,GSG的信号通过一个过渡基板提供,基板的高度与EML的芯片高度一致,然后覆盖焊接端接电阻板。
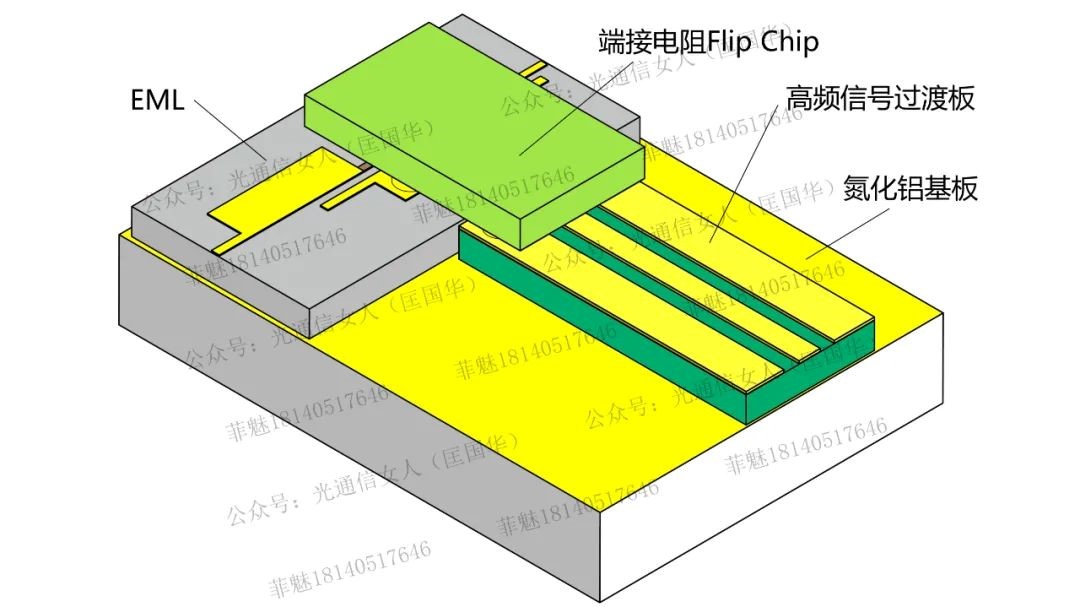
将电阻板做透明化,EA通过端接电阻板的表面布线,将EML与过渡基板连接,其次采用薄膜电阻置于EA的信号电极与GND之间。
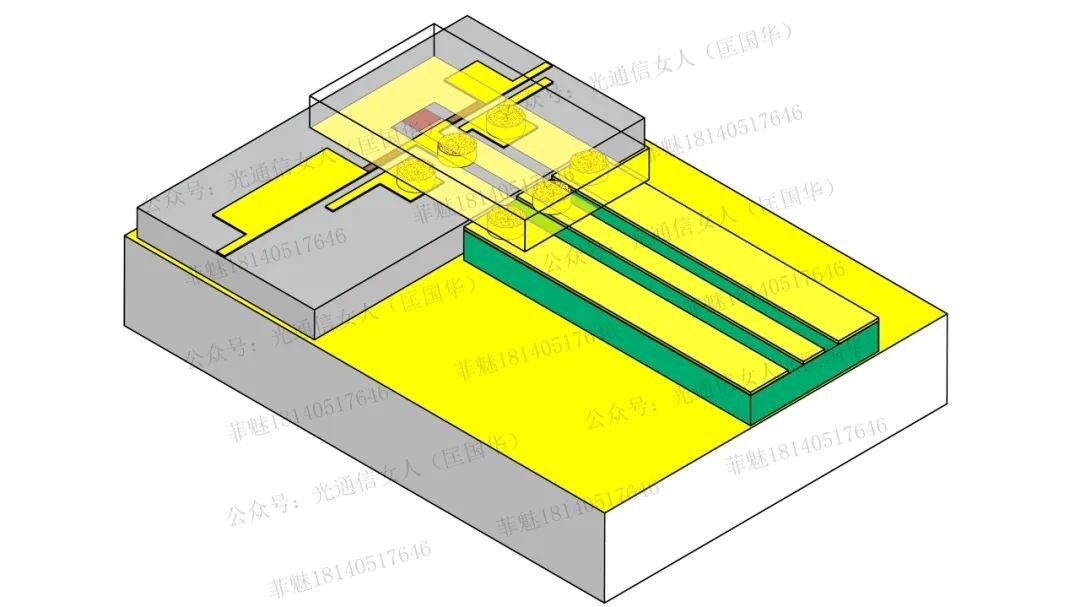
端接电阻板,翻个面,
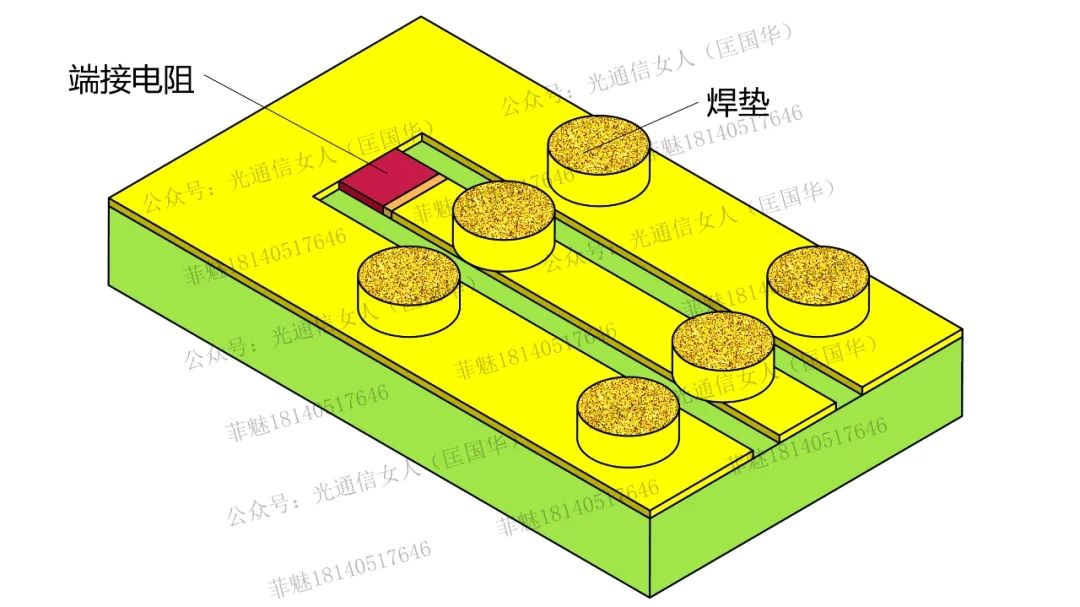
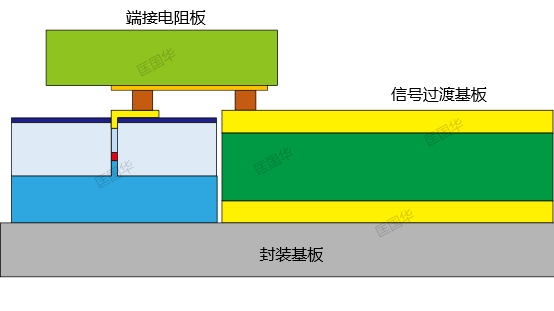
EA电吸收区长度,在200G EML中通常<100μm,在OFC2022合集,ECOC2022合集,都整理过这两年200G EML的设计,如果采用表面N电极,则带宽还能进一步提升。

电吸收区75μm长度下,带宽曲线如下所示,底面N电极在90GHz左右出现振荡,带宽下降。采用表面N电极,则带宽大于90GHz,可用于单波200G PAM4调制