Y9T167 光学芯片焊点本身的应力
昨天聊了一下光学芯片焊接,如果温度过高会产生较大的内应力,需要考虑各个芯片以及封装基板的热膨胀系数。
末尾聊到,降低焊接温度也可以缓解芯片材料不同导致的内应力。但是考虑低温焊料,是可以缓解芯片的应力,焊点本身会产生新的应力。
芯片要进行电信号互联,咱光模块里常见的就是这些类

金丝键合,用的很多,本质上是在高温也一定压力下,产生金属的键合力,是直接结合,无需中间物料

银胶用的也比较多,优点是便宜,但是不适合激光器等高热量的芯片应用,也不适合高频器件的应用,也不适合高精度光路的芯片焊接工艺。所以MPD用的多一些,低速探测器用的多一些,这些都是很大的光学孔径,低速,且探测器热量不高的场合。

使用钎料是最为常见的焊接工艺,PCB里边的锡膏,BGA上边的锡球,激光器金锡共晶焊料等等。都是钎焊,利用一种焊料,加热熔融把需要焊接的两类金属有效结合。
钎料,有一个液化过程,所以既需要高温来融化焊料,也需要考虑熔融金属的横向坍塌。
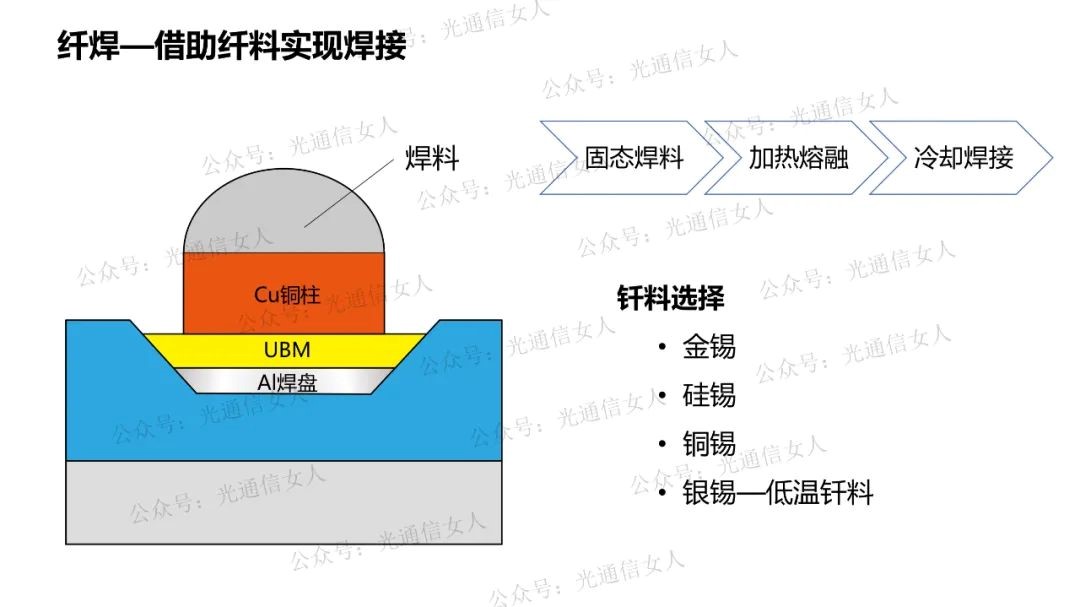
咱的激光器金锡共晶,这个金锡材料就是典型的纤料,所以很多结构中有设计焊料熔融坍塌后的光路影响程度,以及各种补救措施。

今年也有很多厂家提到银锡低温焊料,这就回到昨天的话题了,低温焊料有助于降低焊接温度,保护激光器芯片,硅光集成芯片等等,金锡共晶的焊接温度278℃,银锡共晶的焊接温度221℃,属于低温焊料。
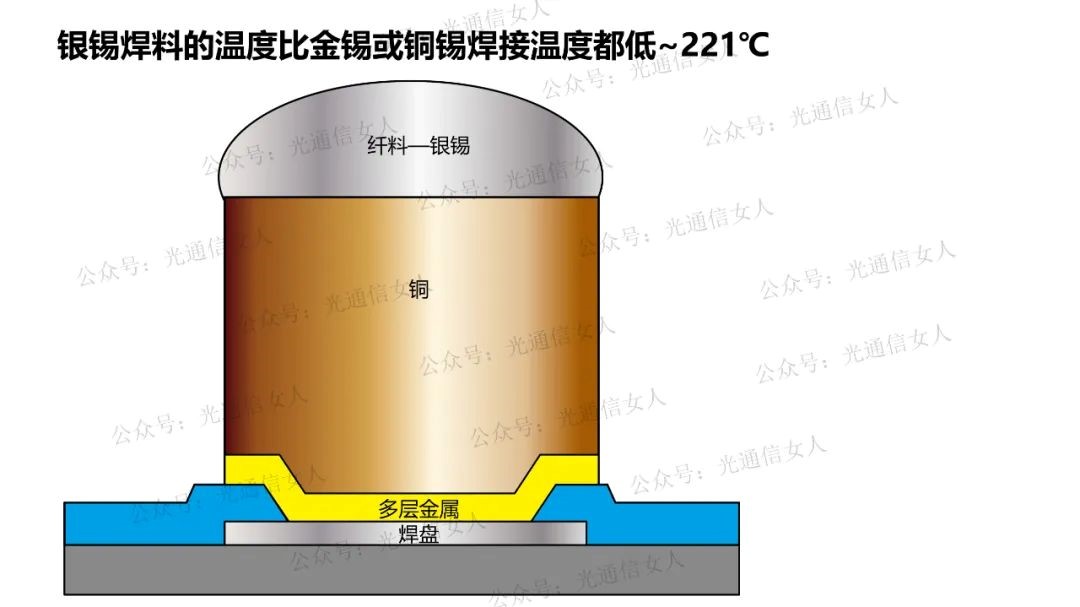
银锡焊料最大的难点在于控制焊点本身的内应力
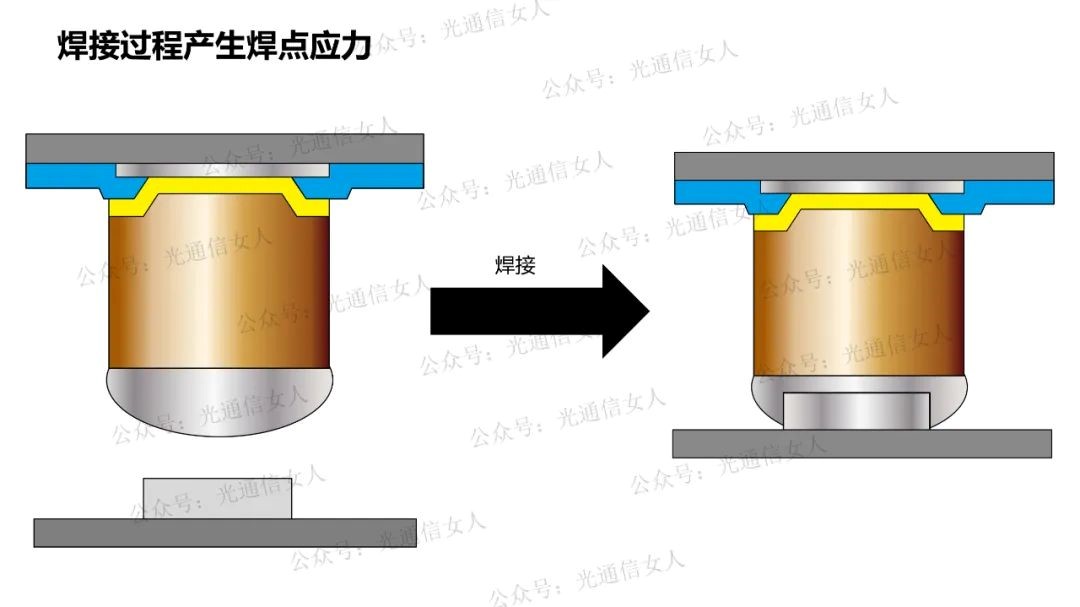
银和锡的配比,如果不合适,就无法产生共晶,而是形成包晶等不希望出现的合金状态。但是银锡共晶配比刚好容易出现一个焊接间接产生,块状的大膨胀系数的产物。
另外,焊料熔融后需要降温冷却,冷却的速度不同,银锡也会在块状与线状之间产生差异,焊点出现不同的膨胀系数的合金层。

烧结工艺,也是最近这几年高频高热光学器件所青睐的工艺,所谓烧结,以前写过几篇,是金属固态与固态的结合,由于不存在焊料/钎料的液化过程,非常适合高频芯片,因为高频芯片的信号线与GND回流路径与电磁波波长有关系,高频信号是短波长,需要很近的回路距离才行。
烧结,是同一个材料的固体结合,金银铜是高频材料,这些材料的热导率都很高,避免使用一些热导率不太好的材料比如锡,各种锡基合金的导热率其实没有金、银、铜那么好。这是附带的优势。
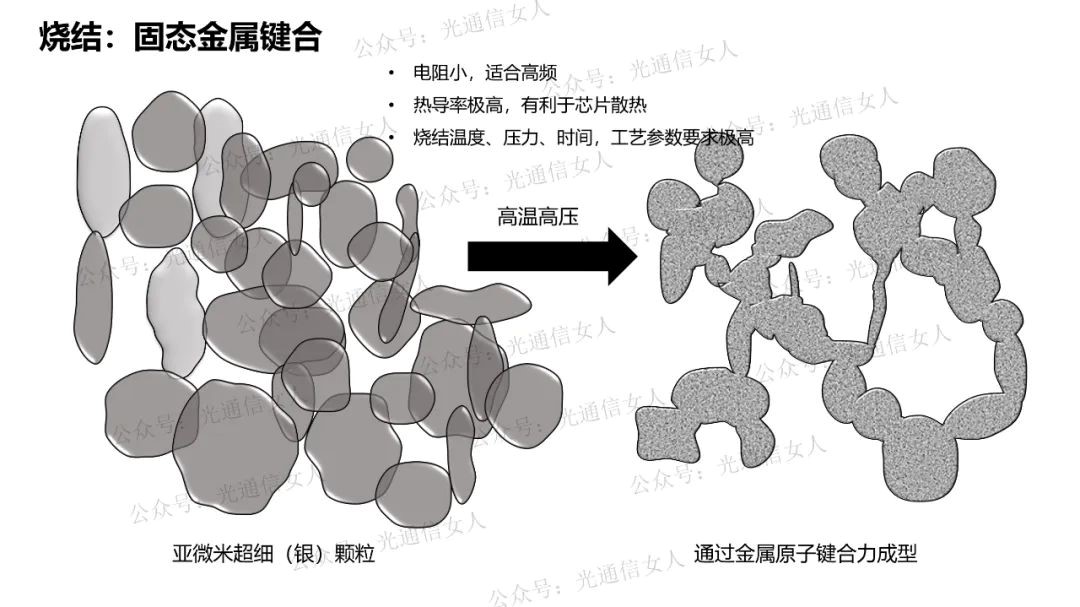
之前写过的一个表格。

2022合集写激光器与薄膜铌酸锂的组装工艺,也提到一个金金热压焊的烧结工艺,与上图的银烧结工艺,思路是一样的。
这个工艺的难点在于如何有效的控制烧结的温度、压力和时间,这三者温度过高,压力过大或者烧结时间过长,都会引起芯片的可靠性风险。
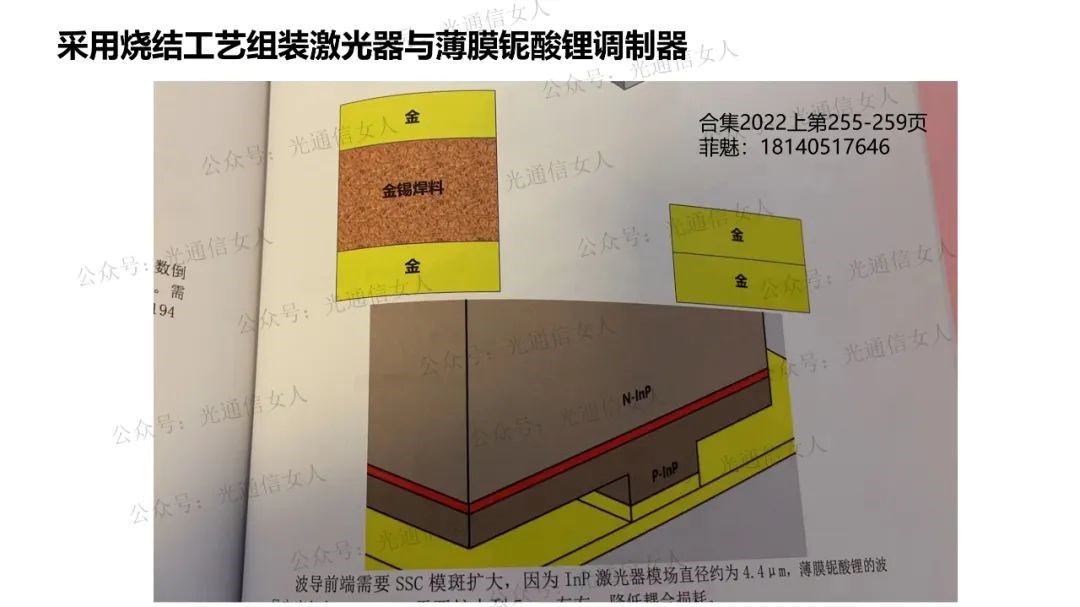
对于高频芯片,焊盘间距从早前的几百微米,逐步降低到几十微米,对于高密度封装的芯片,热密度增大,需要考虑各个工艺流程中的应力,今天是昨天的续集,昨天是芯片焊接应力导致的翘曲考虑,今天是焊接工艺对性能的影响。
