Y9T242 Al焊盘与BGA焊接
天晚上群里聊天,说起焊料和芯片Al焊盘倒装焊工艺。今年OFC PPT汇总里头,有个是Al焊盘上的锌镍合金层。
就提起一个问题,如果是锡银焊料,可以和铝焊盘直接倒装焊吗?
如果焊料是锡和银,一个是银多锡少的银锡焊料,另一个是锡多银少的锡基焊料。如果是银很多,银和铝存在金属间化合物,平时的铝焊盘上打金线,铝和金之间也有金属间化合物。
这些合金层,就是产生焊接效果的结合层。
锡基焊料,锡铜、锡铅、锡银等,都是锡比较多,锡银焊料的话,银焊料较少,则不参与和铝的金属间化合物层,锡也不参与。
以Y9T167的焊点图,和英飞凌的芯片铝焊盘的解读,画图解释一下。
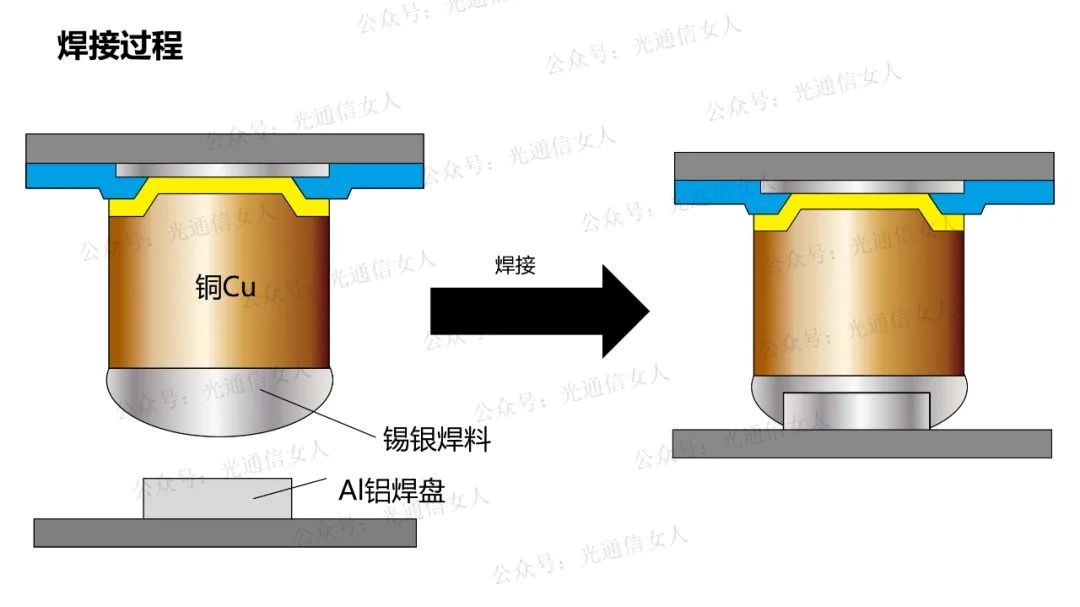
对于铝焊盘的定义,很多时候并不是我们理解的纯铝,因为铝非常容易被氧化,生成的氧化铝是不导电的。
如果是传统焊接,需要用到助焊剂中的一些酸性成分去氧化铝腐蚀掉,露出铝层。Y5T360 回流焊
通常回流焊的工艺,用在带有封装的芯片上,露出Al焊盘的chip Die,现在咱们的光模块里,比如VCSEL和DVR是用金丝键合的,比如硅光芯片和PCB很多也是用金丝做键合的。
如果基于Die的chip芯片和BGA焊球,这个焊盘很多时候并不是单一的铝。就如OFC里边PPT提到的含有镍层,钛层或锌层。这种焊盘也被称之为铝焊盘。
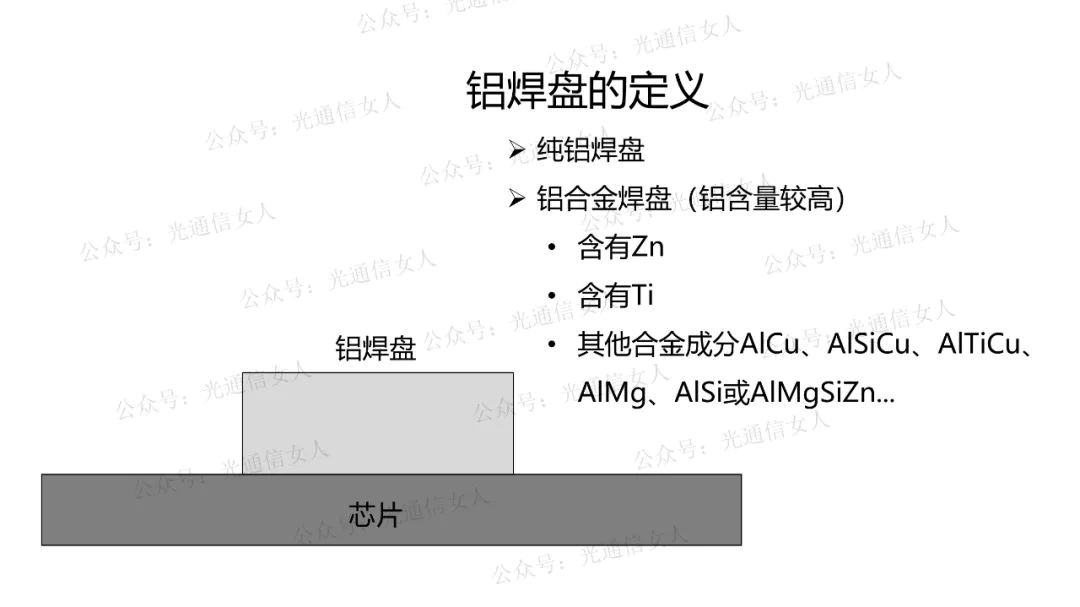
Al焊盘,通过锌做表面处理,是一种很常见的工艺路线,来避免铝的氧化。

其次焊点,对于锡多银少的锡银焊料而言,金属的键合层并不包括焊料。(常规的金属表述,含量多的在前,含量少的在后,群里写的锡银,我按照锡多银少来理解,银多锡少,如前所述。)
之前的合集写过铝金,铝镍,锌镍,等结合层。今天写个铝铜。

把铜--焊料层--结合层--铝,这一块逐步放大。
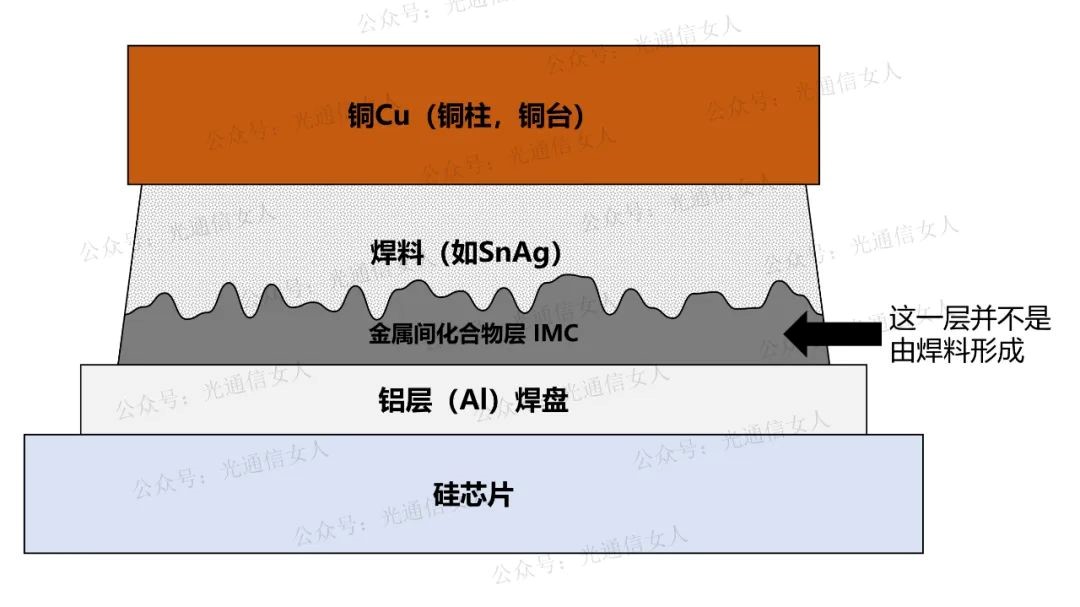

焊接过程中,铜会向焊料中扩散,在锡银焊料中,产生了一部分的铜锡合金,这些铜原子,会扩散到与铝的金属界面,形成铜和铝的合金

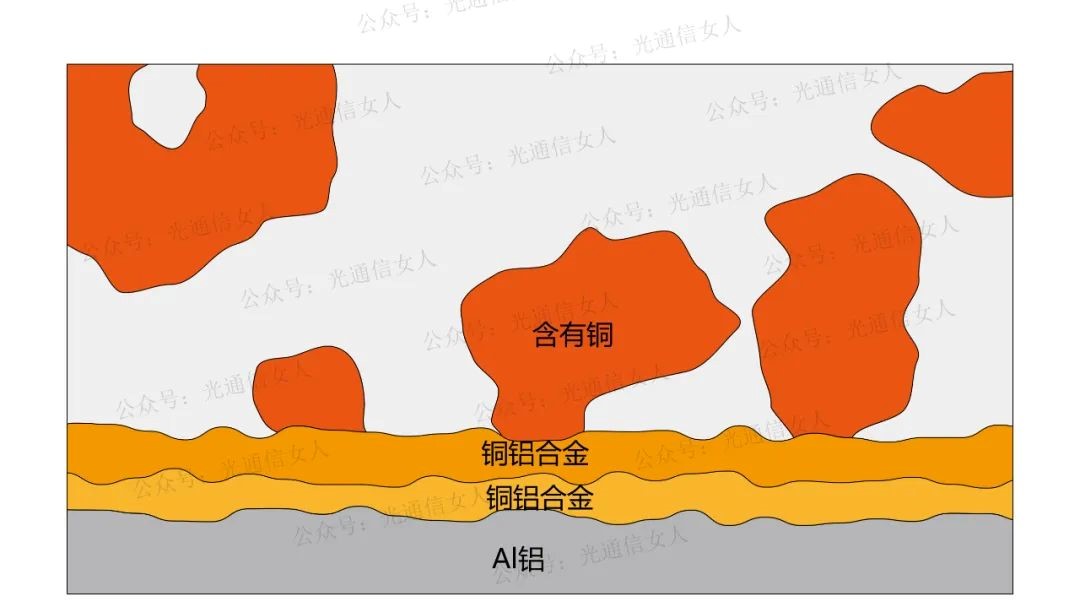
金属间化合物Intermetallic Compound,缩写为IMC,它是金属界面反应的产物,是焊接工艺要研究的一个挺重要但也挺难的。千变万化。
周末还是聊一聊光模块的外型吧,聊光模块可比弄清楚焊点金属工艺要简单多了,
