Y10T38 高速PCB的亚微米粗糙度铜箔处理
华为官网上有三个“黑科技”视频,
一个是400G数据中心光模块,这个内部结构在他家代工厂之一的公开专利技术里有详细的解析,我放在《2022合集下》
一个是10G PON光模块,Y10T34 华为黑科技Class D模块,
一个是高速PCB的铜箔,叫“零微米极致光滑铜箔”,视频中没有提到具体的技术细节,有两句话,一个是铜箔粗糙度0.3-0.6μm,另一句是使用了特殊的分子键合表面处理技术
正文已结束。
附录,我的盲猜
高频信号的趋肤效应,这是背景,当频率越来越高,区域表面的信号对于铜箔的粗糙度变得极为敏感。

粗糙度量化,一般使用Ra,或Rz来表示,二者的定义略有差异。

在不同的标准体系里,对于PCB铜箔的粗糙度有类别划分,具体的划分线有略有差异,但大多数有一个范围的共识。

降低铜箔的粗糙度,并不是难以攻克的困境,比如压延铜的粗糙度就可以达到0.3μm

比如用激光退火工艺,在特定的铜箔区域,快速扫描一下,表面的铜原子会熔融再次冷却,变成原子级光滑,~0.2微米粗糙度
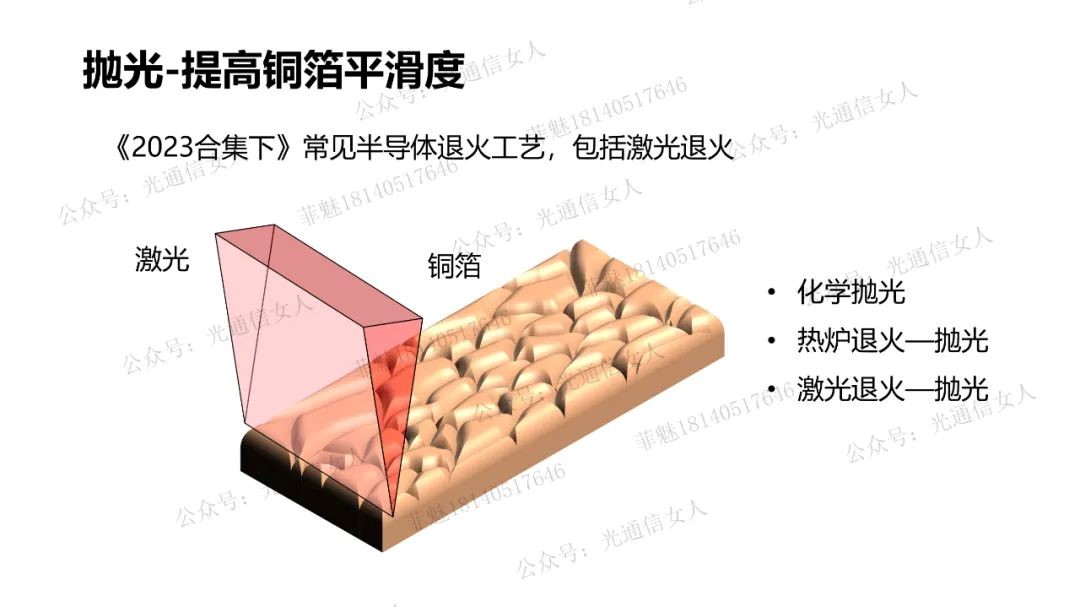
其实很多时候的“粗糙”是刻意而为的,对铜箔做粗糙化处理,如表面瘤化等等,再加上黑化棕化等等,来增加铜箔与树脂的附着面积,提高他们的结合力。


如果放弃表面的瘤化,粗化,棕(氧)化,钝化等等工艺,铜箔可以非常光滑,接下来就要考虑,光滑的表面怎么才能贴上树脂。
所谓的树脂,就是有机高分子聚合物的各种聚合类型。
这就用到了“分子键合”层。
键合,在半导体工艺里很常见。硅的氢化物就是硅烷,之前写InP激光器的波导刻蚀气体,就用到硅烷或氢气。
硅有四个共价键,硅烷偶联剂设计了X、Y两个键合机制类型。
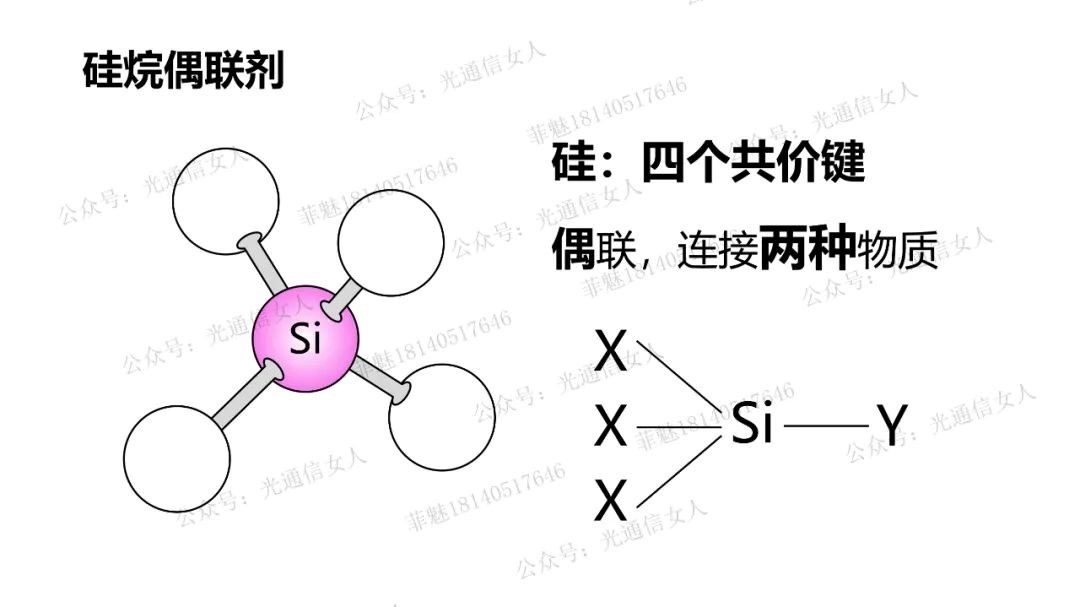
比如下图中子硅烷偶联剂

基于Si的四个共价键,一侧可发生水解反应,形成氧原子作为中介原子的键合力,这个键合就是Intel硅光调制器键合InP激光器增益层时,硅和铟通过表面氧化物层实现的氧原子桥接面。
《2021合集下》 硅光wafer异质键合InP工艺流程,提到键合原理,和亲水面的处理,水分子的逸出机制等等。
采用硅烷偶联剂,也是利用了这个亲水(或水解)进行氧原子桥接键合力的方式与金属层互联。 这样就“不再需要刻意”对铜箔做粗糙化了。
偶联的另一侧,硅烷偶联剂中分身有有机聚合体,等于和树脂的高分子有机聚合物,俩塑料熔融结合在一起了。
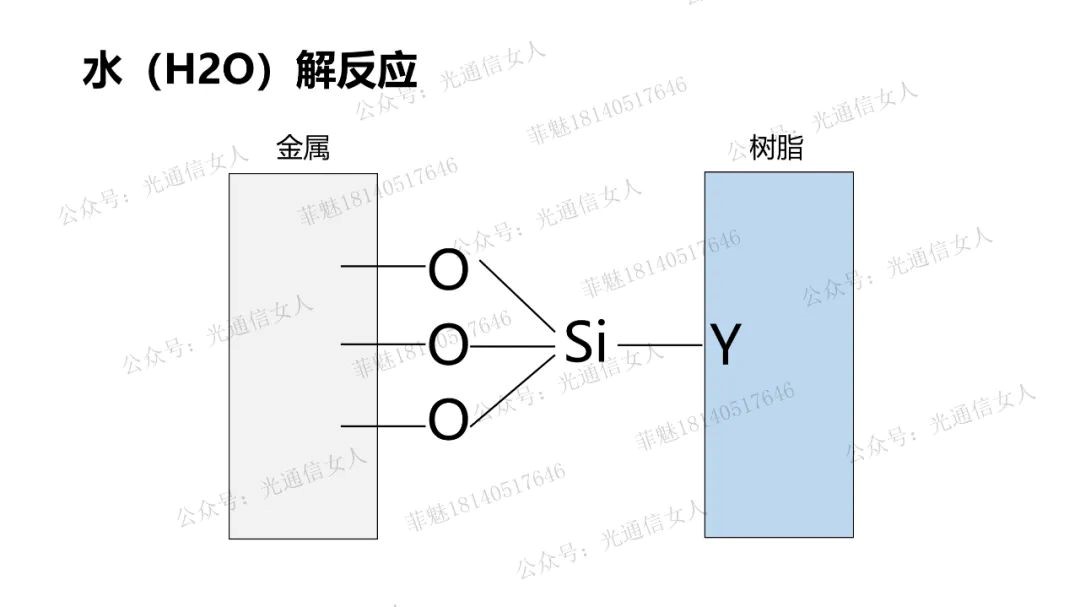
铜可以直接涂覆分子键合的偶联剂,也可以插入银层或锡层来避免铜的表面被氧化。银的射频性能更好一些。银或锡都可以采用电解工艺实现。