Y11T32 【通信基础】打线、WB、键合、焊线
在光模块里有个随处可见的工艺,有的厂叫做打线,有的叫WB,有的叫键合,有的叫焊线....
简单说,就是通过打金丝实现芯片封装的工艺路线。
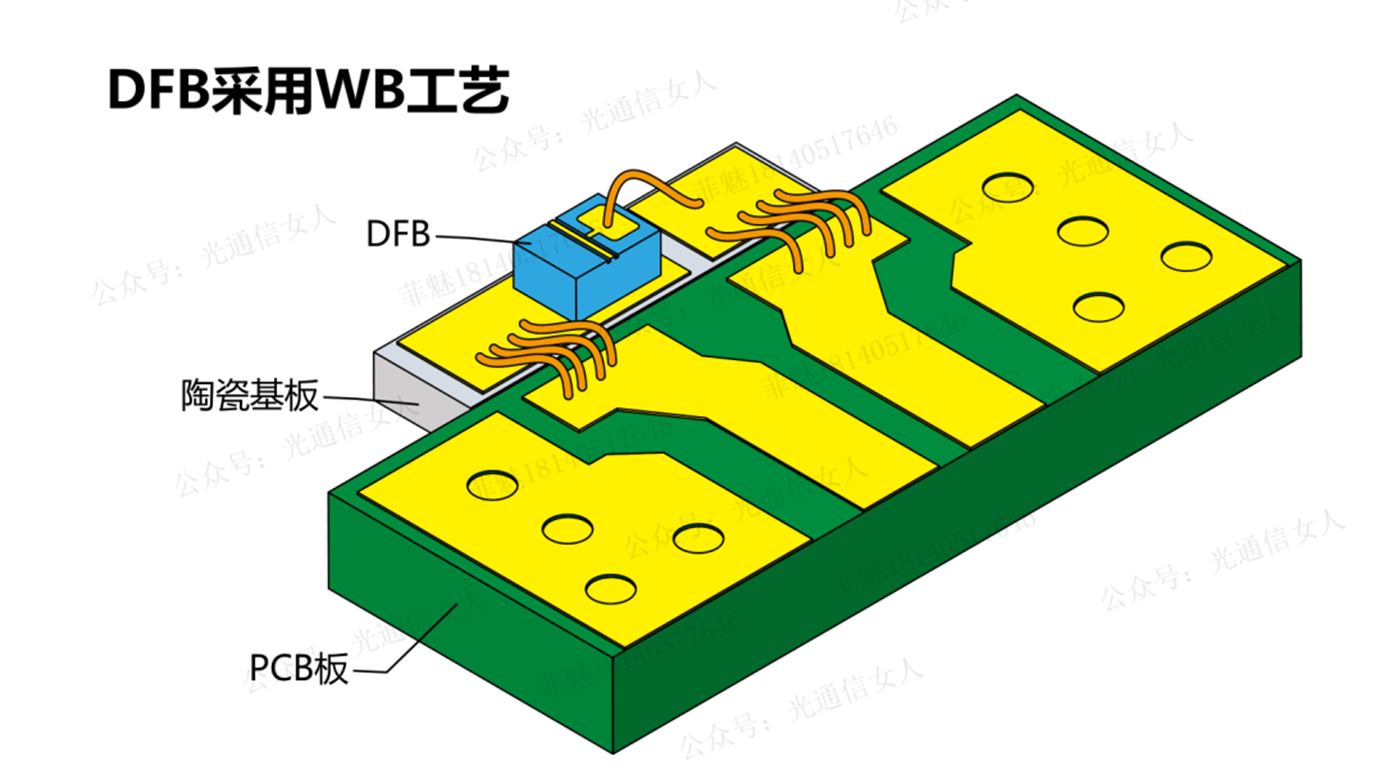
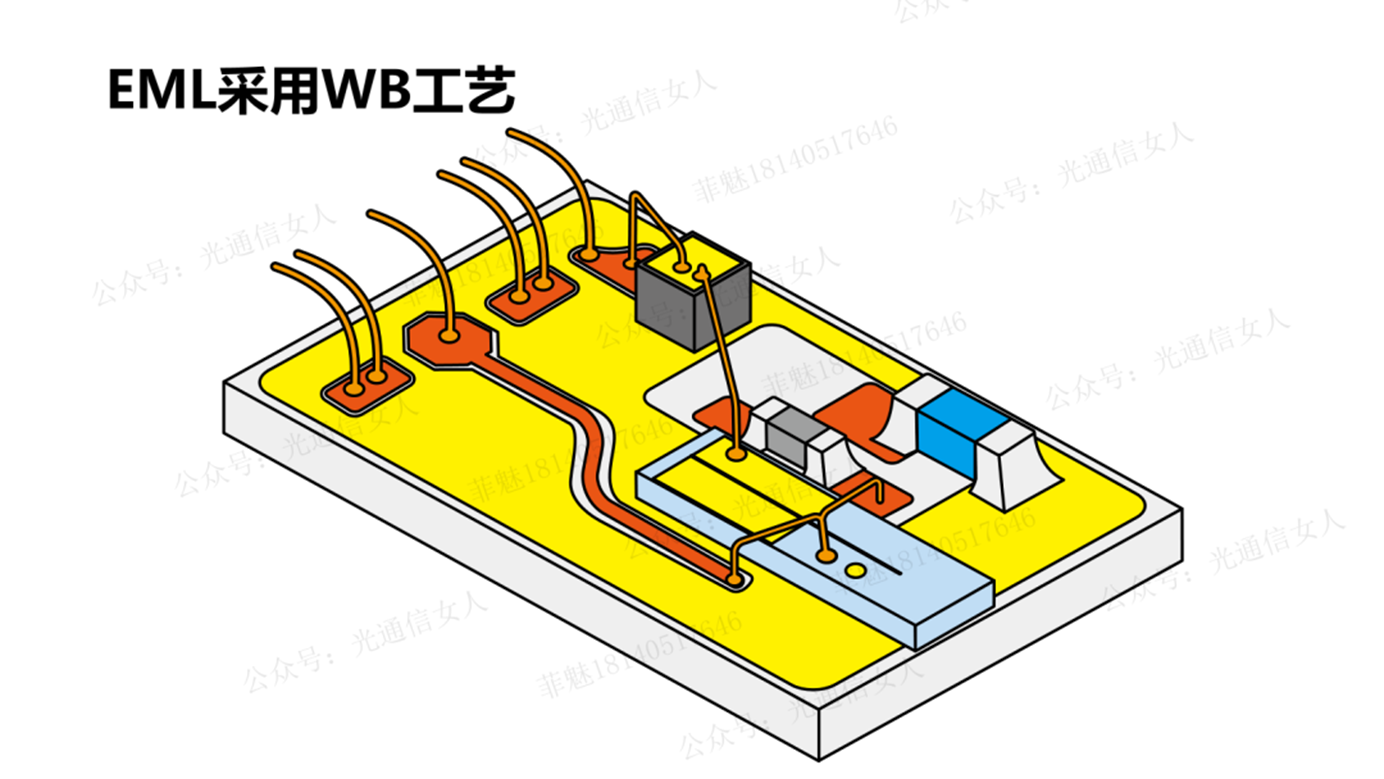
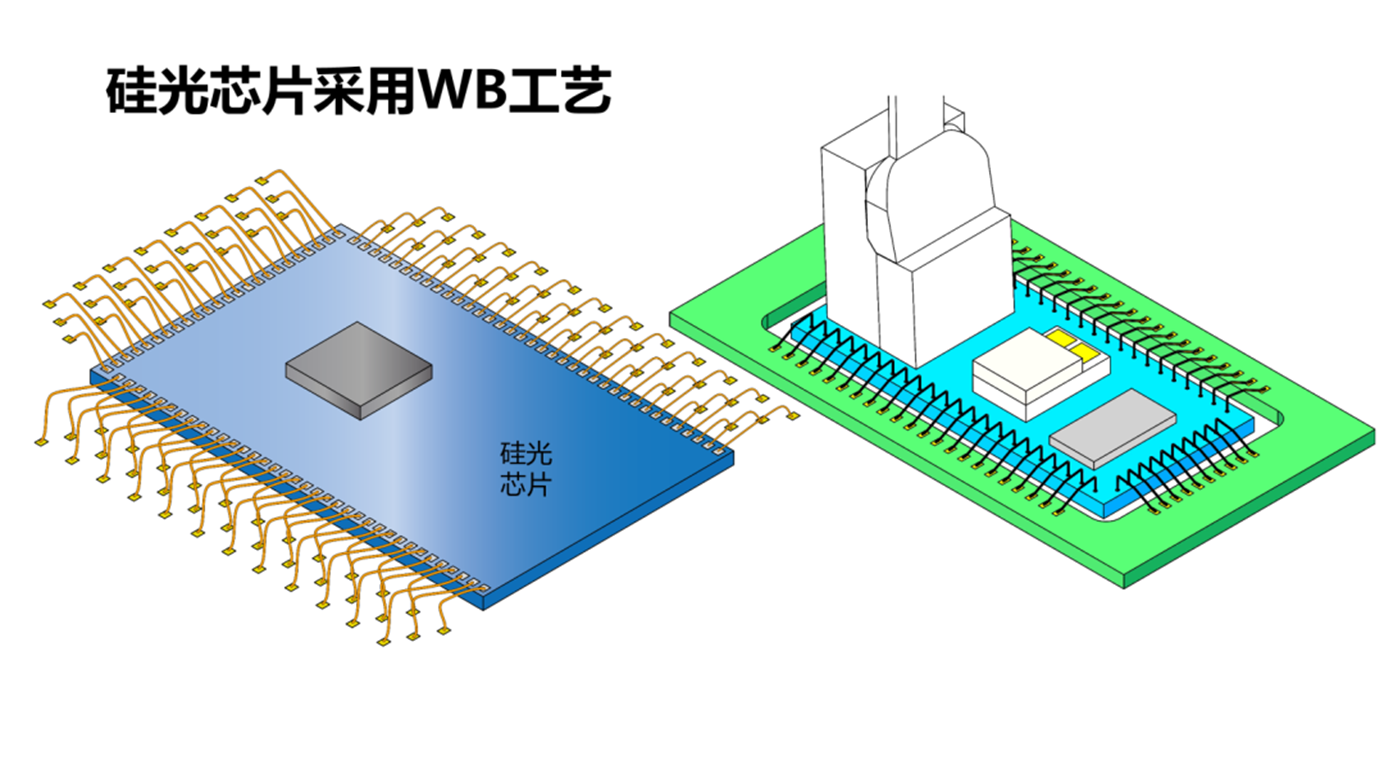
WB,Wire Bonding,这个Bonding通常翻译成“键合”
键,是化学键的简称,原子间强烈的相互作用力的统称。通过这种作用力,实现金丝的固定,建立电信号连接通道。

常用的键,咱们有两大类,一大类是共价键,另一大类是金属键。
共价键(covalent bonding),是化学键的一种,相邻原子通过共用电子并形成强烈引力作用叫做共价键
金属键(metallic bonding),也是是化学键的一种,主要在金属中存在。由自由电子及排列成晶格状的金属离子之间的静电吸引力组合而成。
InP激光器、InP探测器,GaAs激光器,这些都是共价键。

今天聊的键合金丝的键,是金属键的作用力。

打金线,会用到压电陶瓷与劈刀工具。

劈刀是用来输送金线,控制金线位置,切断金线。留有线孔,以及粗糙压力切断面


压电陶瓷的作用,则是通过超声波产生机械能,让金丝与焊盘摩擦
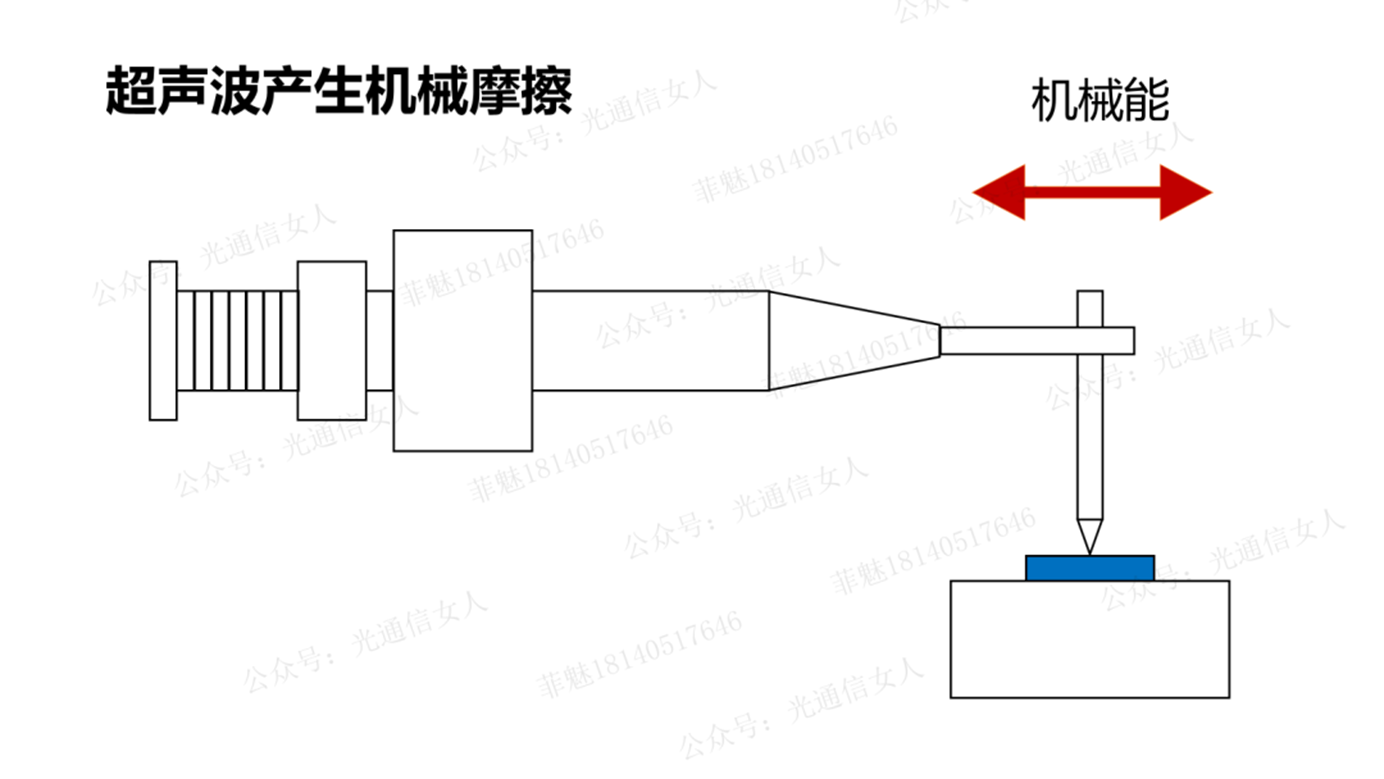
要想实现化学键的强键合力,就得让原子足够靠近,而通常材料的表面比较粗糙,甚至留有污染物。用等离子清洗掉表层的污染物,在通过机械模场产生压力与热,实现金丝与焊盘的“金属键”合力。

常用的金属键合的形貌有三大类,球焊、楔焊、反向焊
球焊采用圆形劈刀嘴结构,一端通过加热成液滴球形,另一端则通过劈刀压断形成鱼尾型。
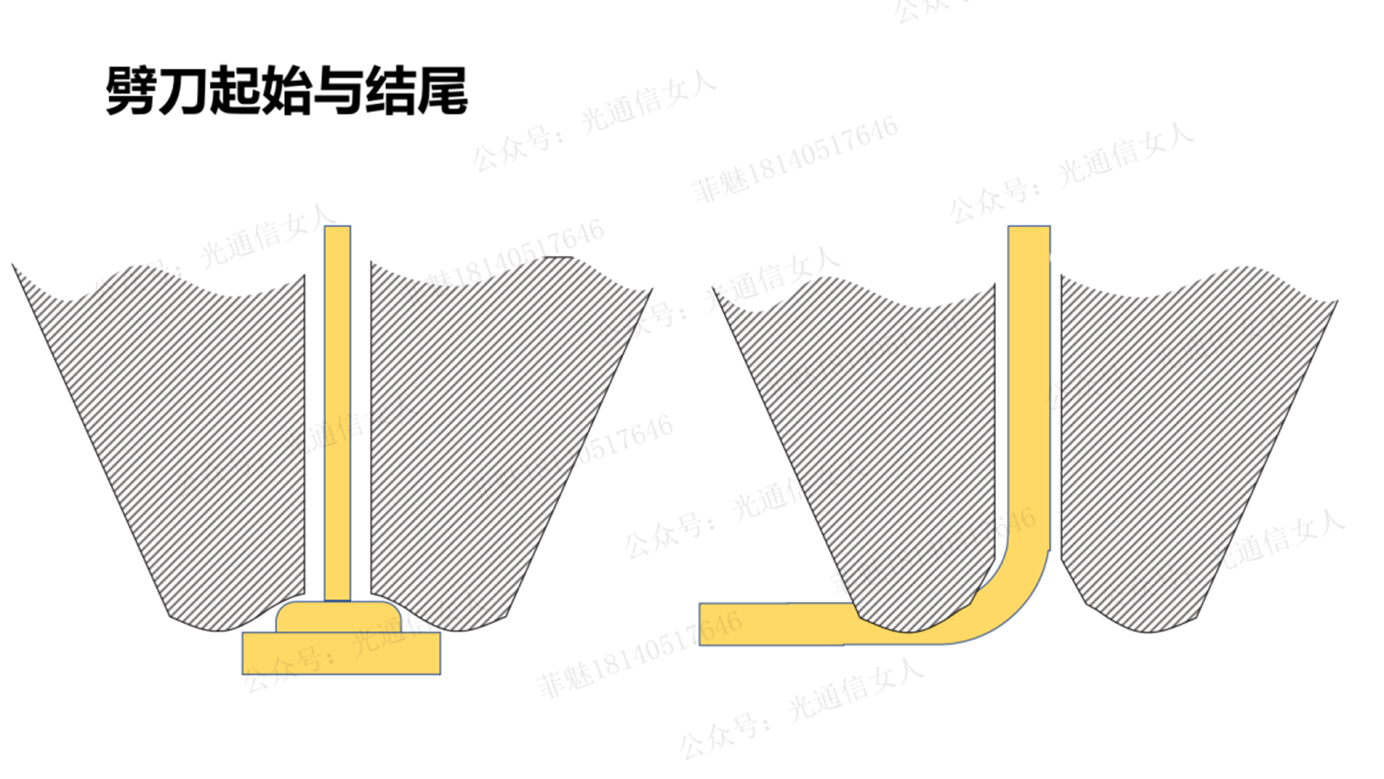



球焊的好处是简单,可靠,结合力强,但劣势是弓较高,线较长,寄生参数复杂,阻抗不连续。

楔形焊,则与球焊相反,阻抗更连续,高度降低,有利于射频性能。
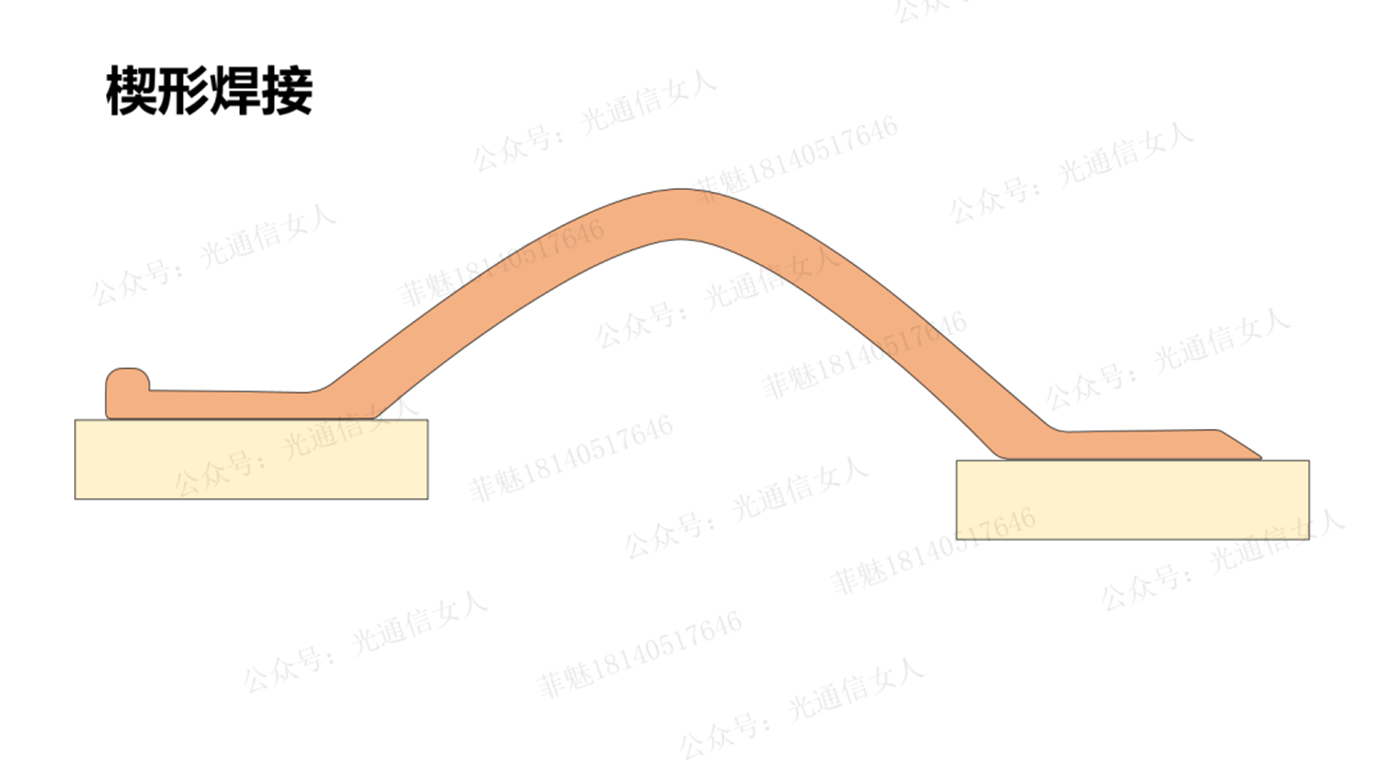

还有一种反向焊,兼顾了球焊的牢固性,与较低弓高的射频特性,只是需要值球,焊接,反向回结,工艺稍复杂些。


键合金属会有寄生的长导线的电感,以及趋肤效应导致的高频大寄生电阻,这些寄生参数会引起谐振,影响封装带宽。这也是好多厂家考虑FC工艺替代WB工艺的原因之一。



另外,咱们行业的键合,光芯片大多用金焊盘,而DRV、TIA、硅光集成芯片等常用铝焊盘来降低成本。
PCB板上则是铜焊盘镀金,或镀镍金,镀镍钯金,本之上也属于金焊盘与金丝的键合,但需要考虑金属离子之间的迁移导致的金层减薄,影响键合力。
在铝焊盘上打金线,比金焊盘打金线更复杂,金与铝之间会有合金界面、空洞,以及铝的活泼性会导致被氧化,很容易引起键合不良的可靠性风险。
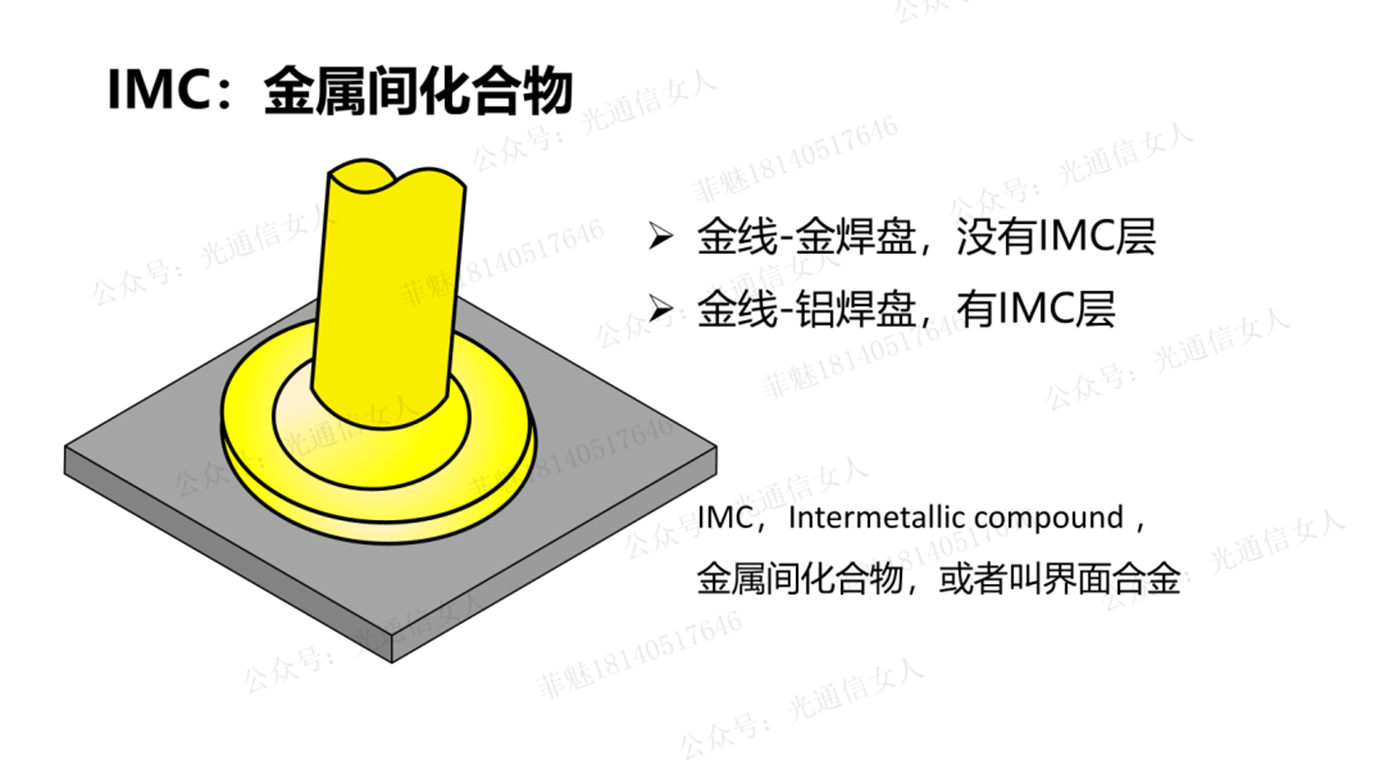

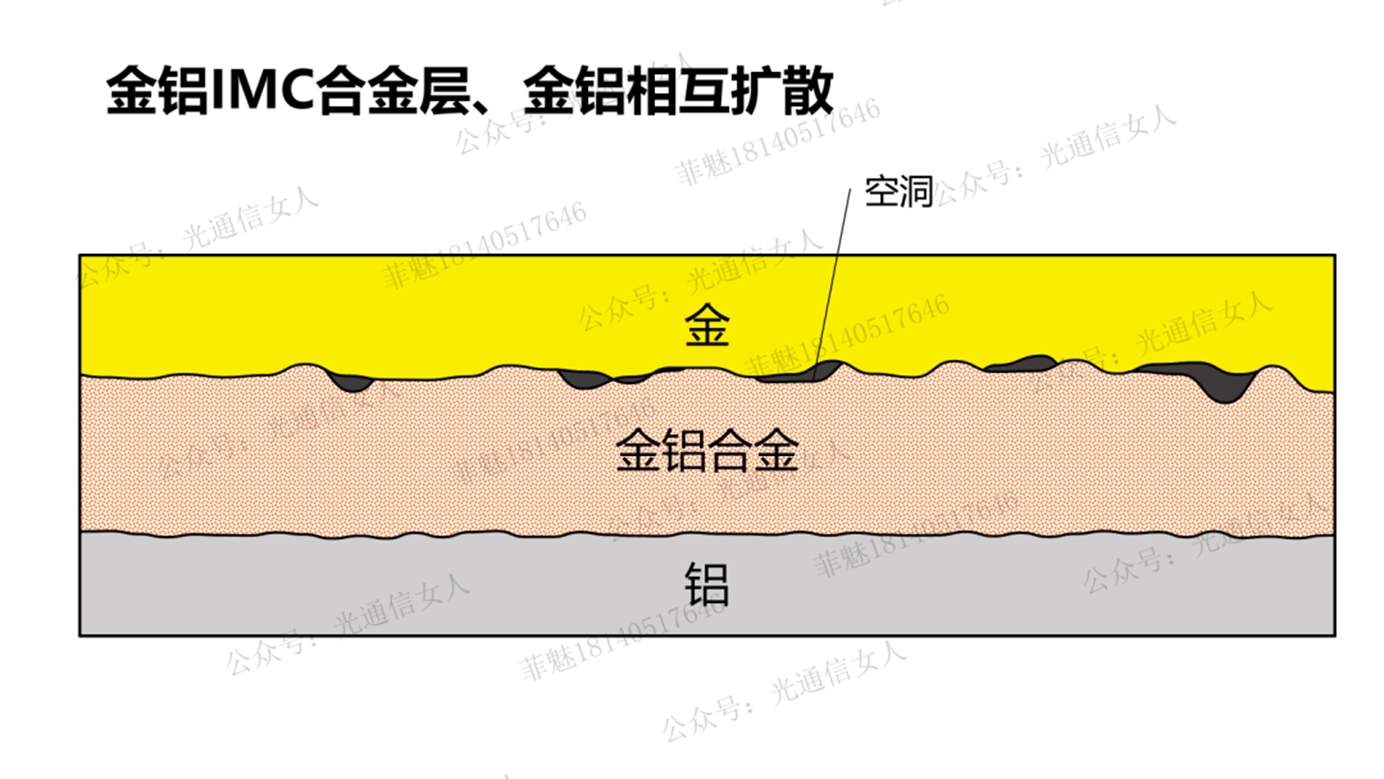
完成WB键合,还需要做可靠性分析,如常见的推拉力试验,通过拉力和推力来检验键合强度是否满足要求。
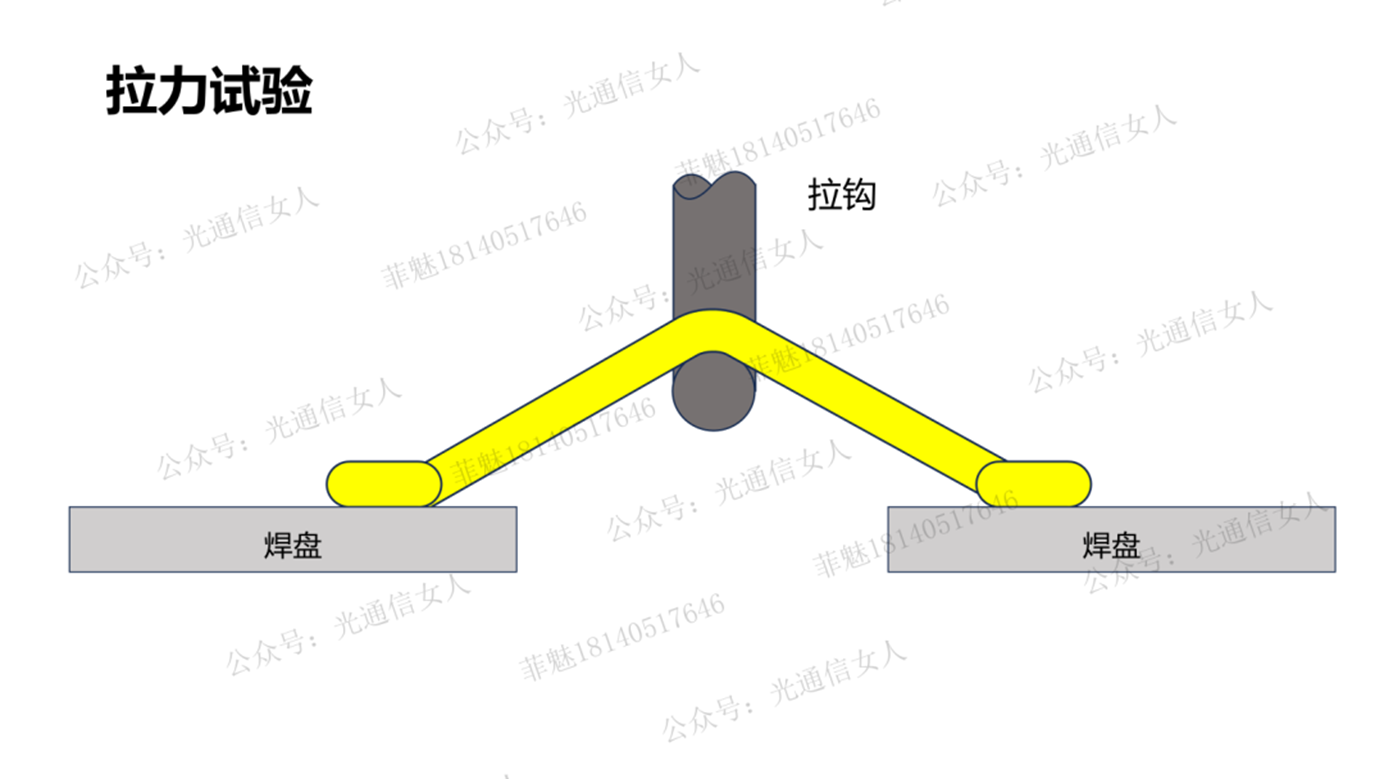
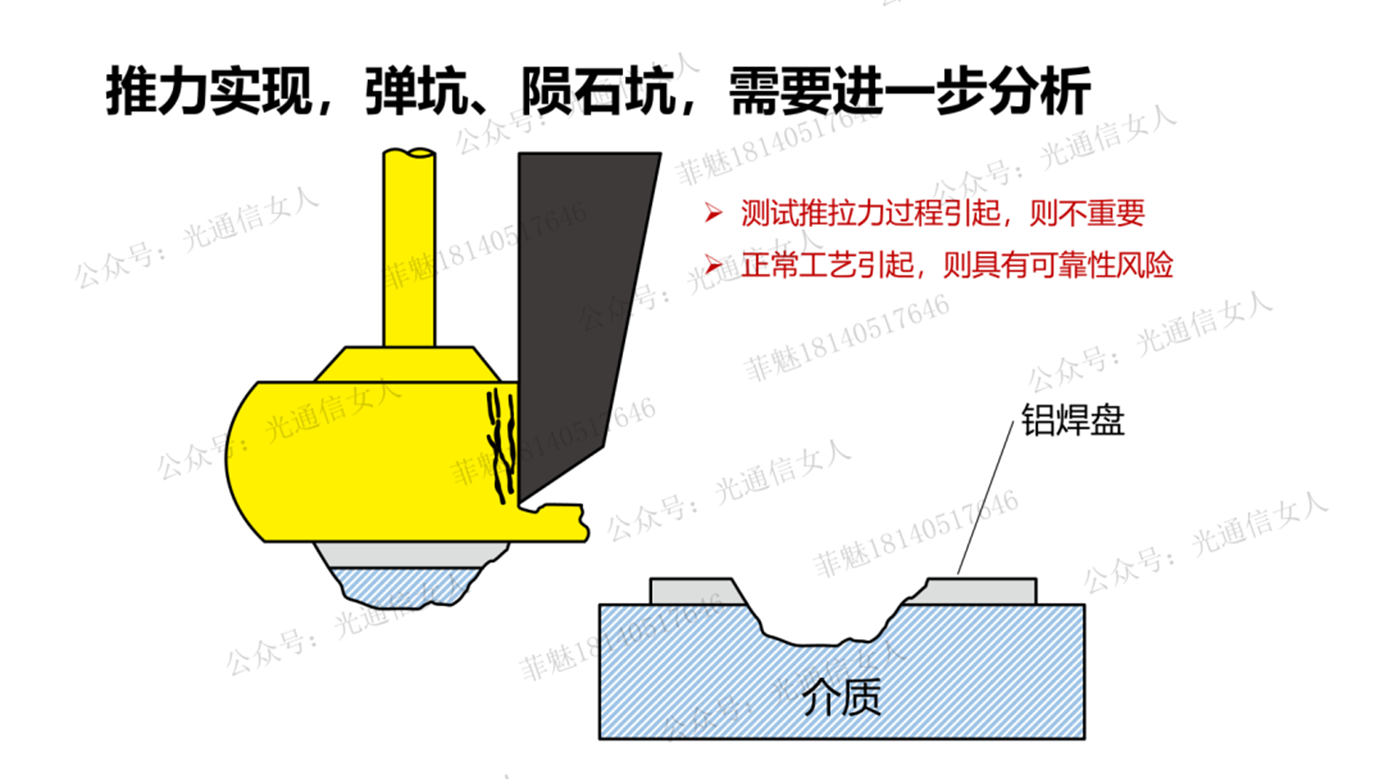
先写这么多,后续展开聊一下FC与WB的区别。
