Y11T52 哈佛:薄膜铌酸锂调制器的直流漂移现象分析
更新时间:2025-02-21 09:02:42 阅读量:1227
哈佛做了一部分薄膜铌酸锂调制器工艺或结构引起的直流漂移现象的分析。《2023合集》 ETHZ 铌酸锂干法刻蚀的侧壁沉积分析干法刻蚀分为物理刻蚀与化学物理刻蚀,物理刻蚀用氩气离子刻蚀,化学物理刻蚀是通过氟基或氯基其他发生化学反应然后再通过物理方式将反应物挥发去除。这就是等离子刻蚀以及反应离子刻蚀的基本原理。今年哈佛分析了这两种刻蚀方式对薄膜铌酸锂直流漂移的影响。纯氩气的惰性气体的等离子刻蚀,是物理刻蚀,用氩气离子来轰击铌酸锂材料,由于锂原子很轻,其次较轻的是氧原子,很容易被氩气轰击脱离铌酸锂材料,导致较重的铌原子残留在波导表面。影响了铌酸锂材料的原子配比。
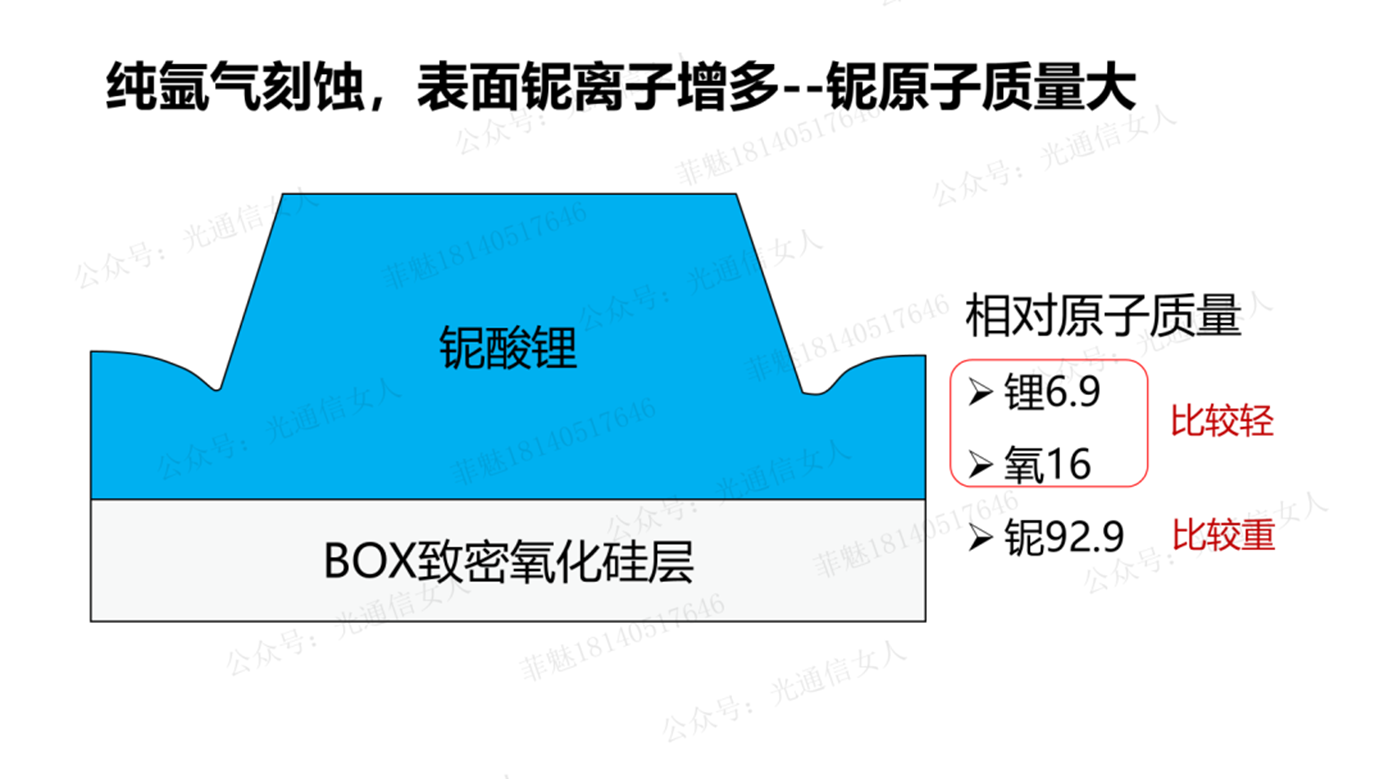
而化学刻蚀的主要问题是,铌酸锂含有铌、锂和氧,采用氟基材料来轰击铌酸锂,锂与氟的化合物是固态物,很难挥发。需要额外的清除工艺,选择化学清除或物理清除,也会导致其他的原子残留,引起直流漂移。
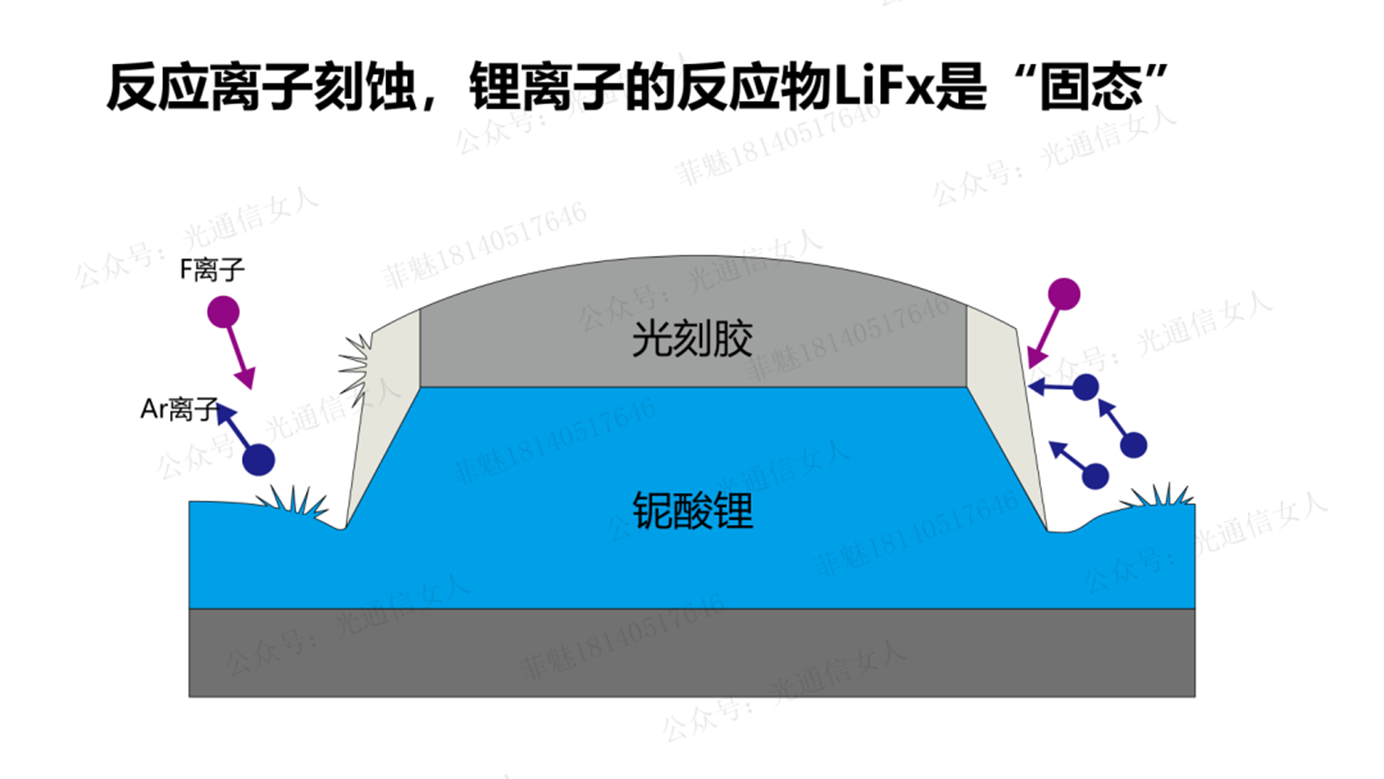
少数残留的锂氟化合物,会成为介质,影响了铌酸锂的电光响应。
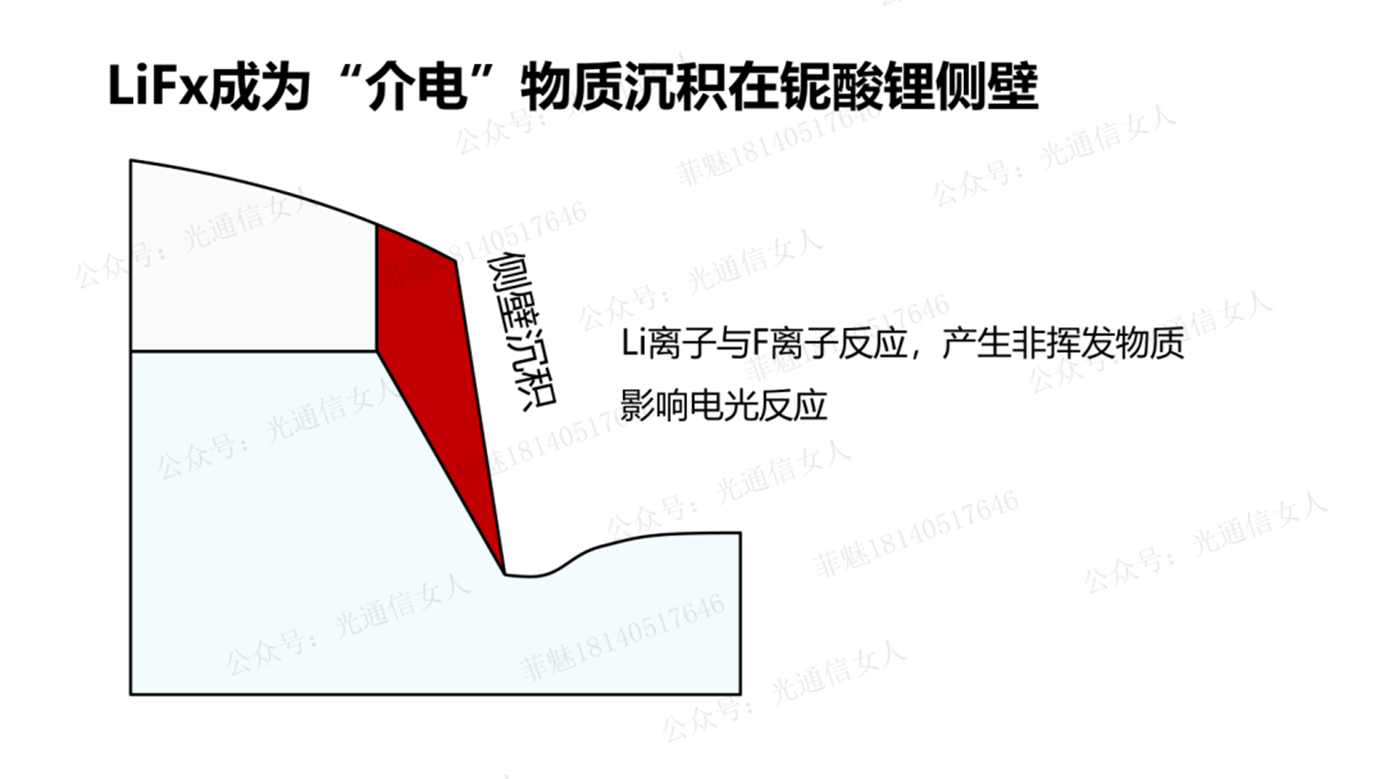
这两种波导刻蚀工艺与后期电极产生的金属界面,具有一个肖特基势垒,而非理想的电阻接触,导致漏电流,产生的直流漂移,哈佛做了一些数据分析工作。
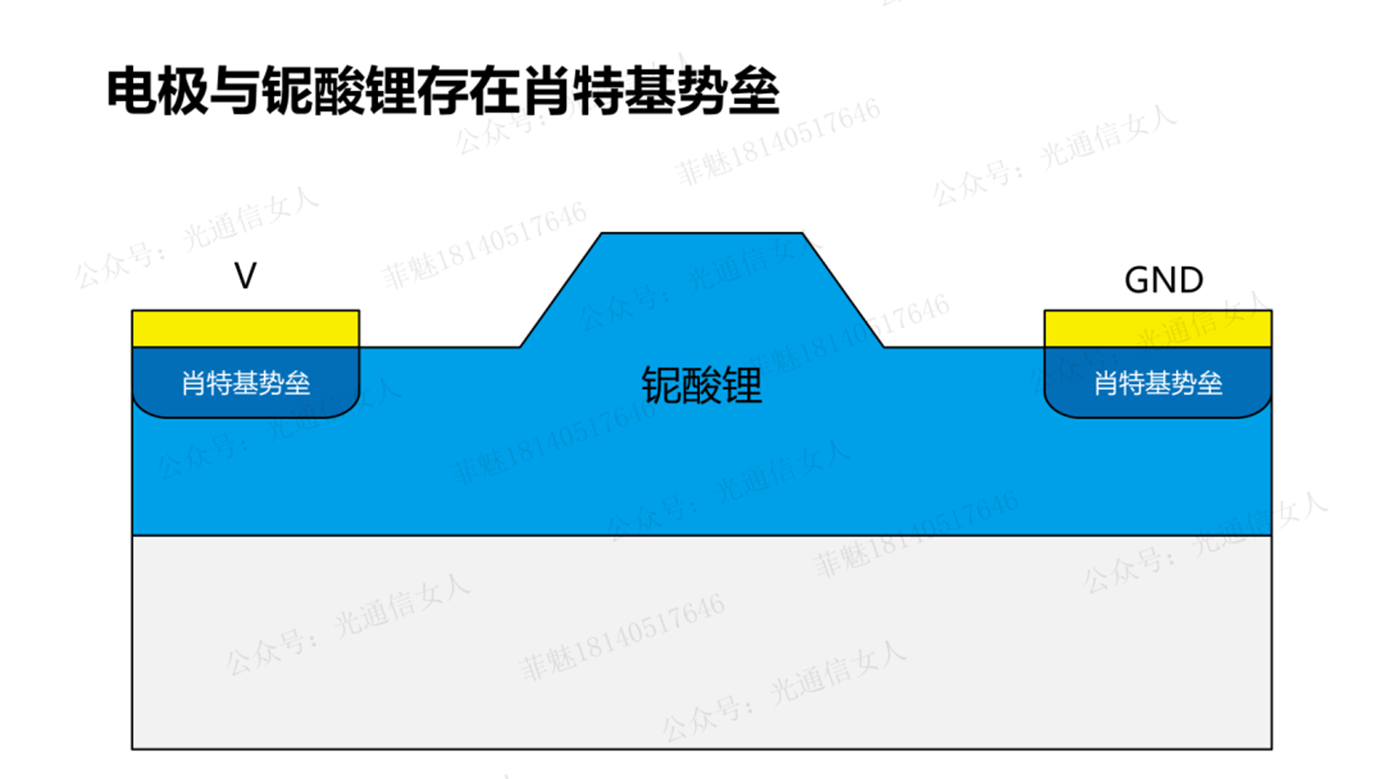


除了这个金属与铌酸锂的界面存在的电势势垒,波导上方覆盖氧化物包层,也会导致直流漂移。
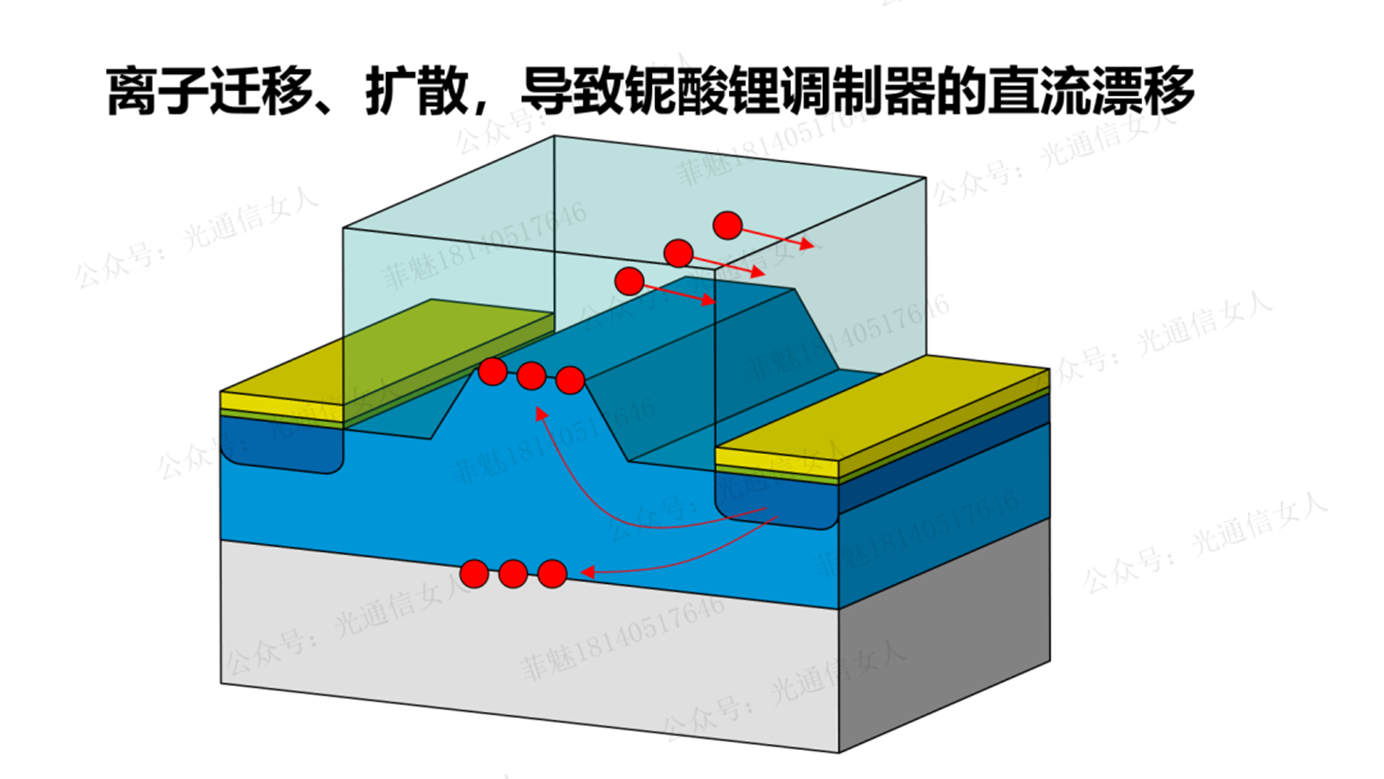
这主要是后续沉积的氧化硅,如PECVD工艺,氧化硅的致密度不足,较为疏松,在退火工艺时导致离子扩散,退火是加热再降温的工艺,退火的高温段(~200℃)会导致铌酸锂的锂离子会向氧化硅扩散,导致铌酸锂中的锂离子不足,调制器性能变化。
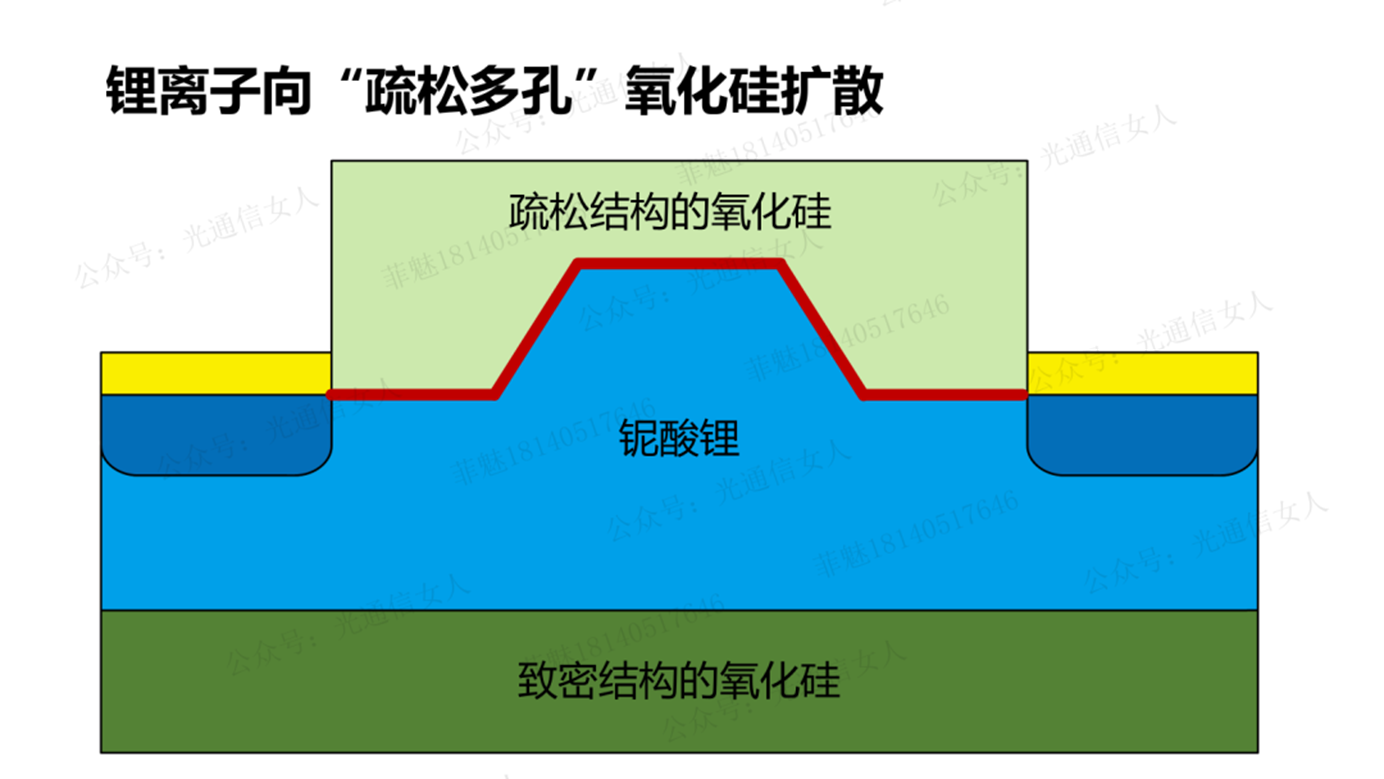

氧化硅的致密度越高,锂离子向氧化硅的扩散程度越低。反之,氧化硅的致密度越低,锂离子的扩散程度就越高。
菲魅:18140517646
