Y11T220 光模块里电芯片的几类封装形态
写了很多光模块里的光学芯片封装,今天略写一点常见的电芯片封装。里边的一些图示,包含光模块上下游产业链里多个公司的示意结构。
现在的高速光模块的电芯片,主要有几个大类。
一类是模拟芯片,VCSEL、EML、DFB、SiPh集成、InP集成的发射端的驱动芯片,接收端的TIA跨阻放大器。
这一类的芯片的特点,对噪声和射频带宽很敏感。
因为驱动电流、驱动电压、和跨阻输出电压,这些个模拟信号如果叠加噪声,会严重影响信号质量。这些模拟芯片是配合高速的光芯片来用的,射频信号带宽要与光学信号的带宽相互匹配才行。
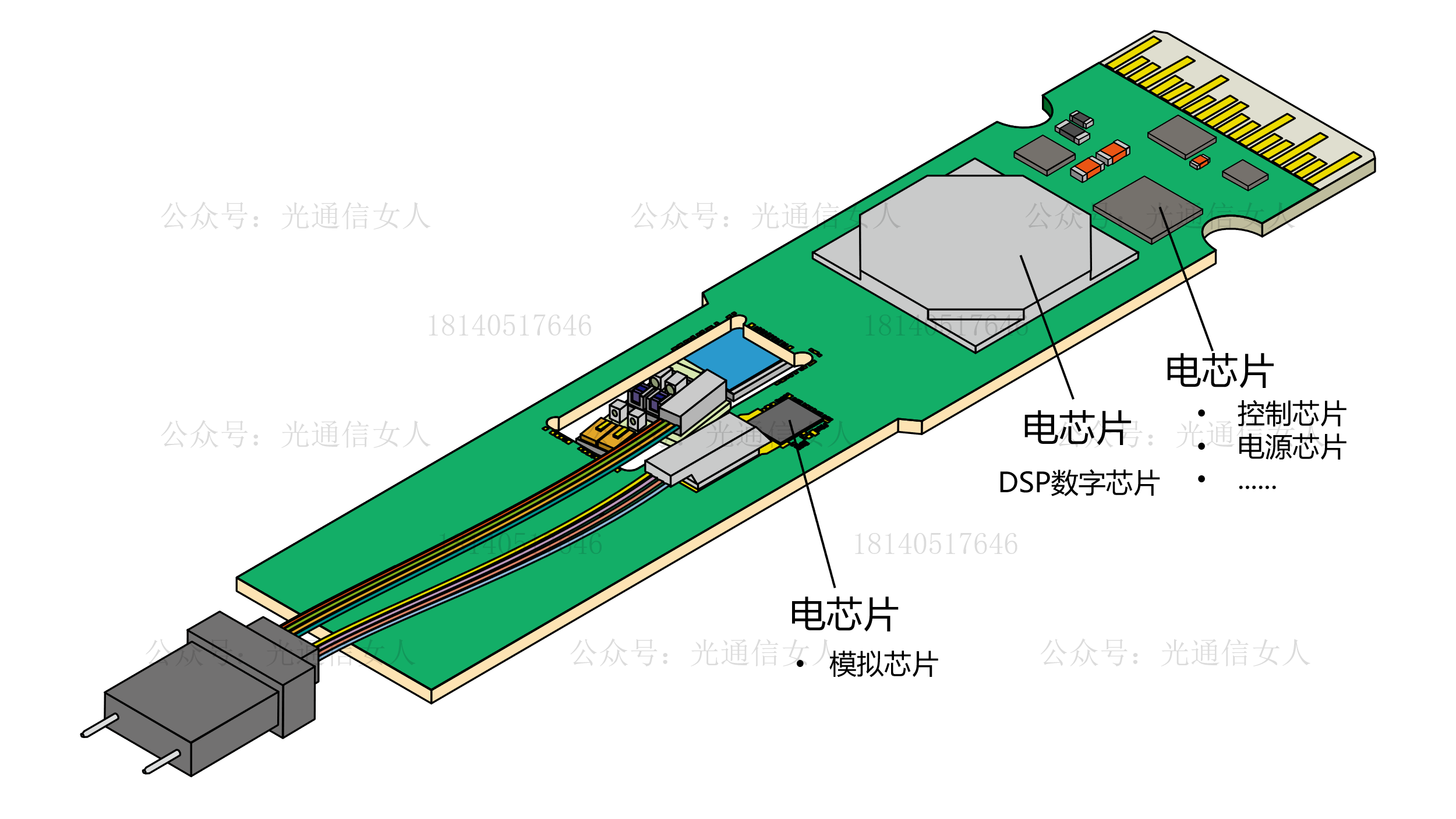
一类是数字芯片,主要指DSP,数字芯片对功耗、散热以及射频带宽要求很高。对带宽敏感,与模拟芯片是同一个原因。
对功耗和散热能力的处理,主要是DSP内部集成了超大规模的电路,用于高速的以太网模块或者是相干模块里的色散控制,相位控制、误码纠错、脉冲整形等等功能,且把这些模拟量采样成数字量再通过大量的数学计算模型进行分析,并进行补偿。这需要海量计算。导致了DSP的功耗巨大。
还有一类是常规芯片,比如电源处理芯片,低速的控制芯片等等,这些芯片功耗不大,速率不高,对封装的要求也可以降低。
进入正文
低速低功耗的常规电芯片,一般用表面贴装焊接方式,采用环氧树脂做简单塑封,内部打线实现集成电路的Die的信号引脚互联。
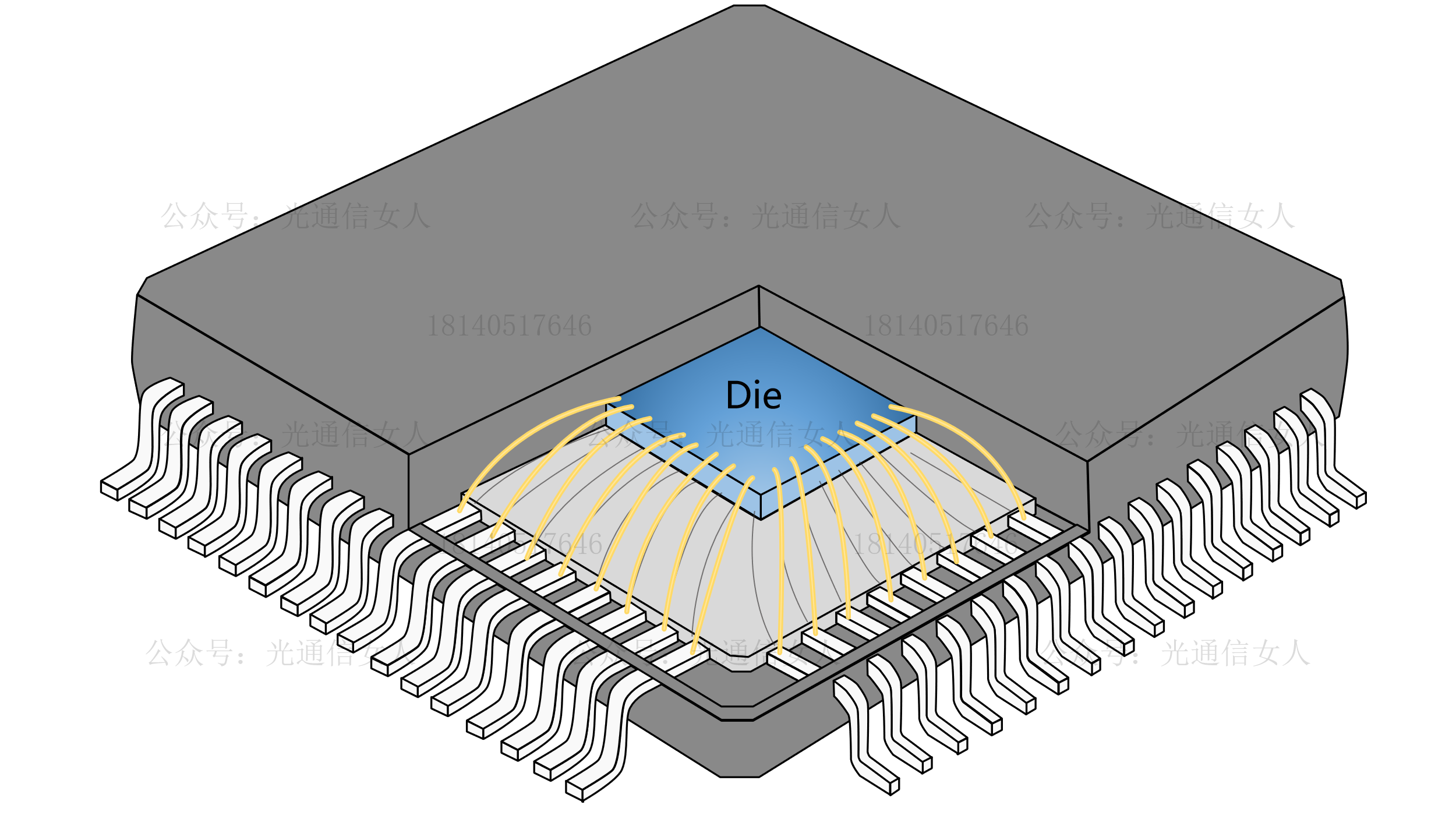
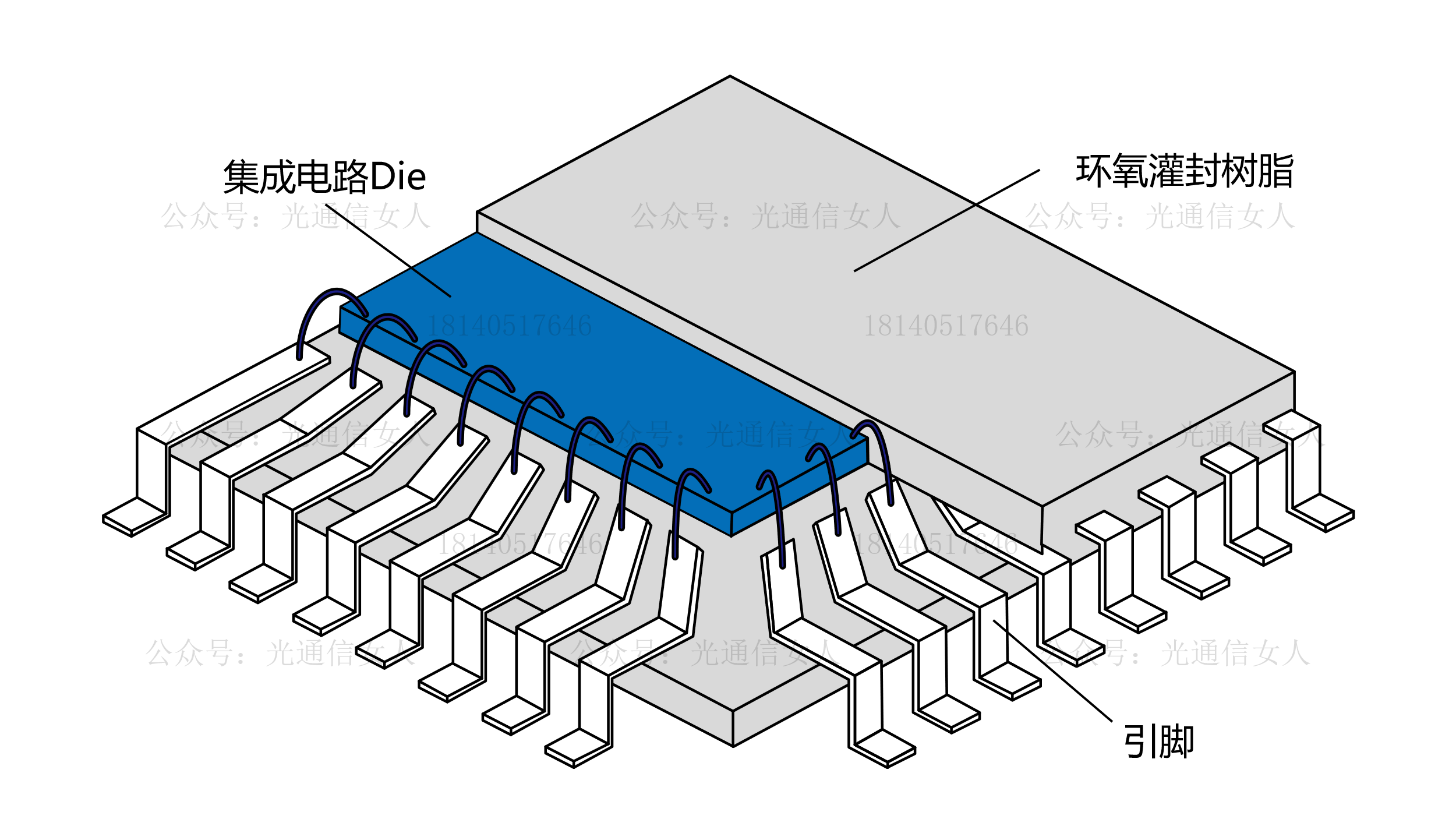
DSP,目前主要采用BGA封装用于提高封装带宽与引脚数量,并金属盖封用于散热。
DSP如果需要进一步提高带宽,未来可能用裸die直接Flip chip在光模块的PCB板上。
先说常见的含封装的DSP,

底部是一个小的PCB基板,目的是做信号的扇出,适配BGA的球间距离。BGA的间距一般在0.4-1.0mm范围内,BGA间距越小,支持的封装带宽就越大。

PCB扇出基板侧视图

PCB板上,焊接了集成电路芯片的裸die。也是采用BGA的阵列焊点。
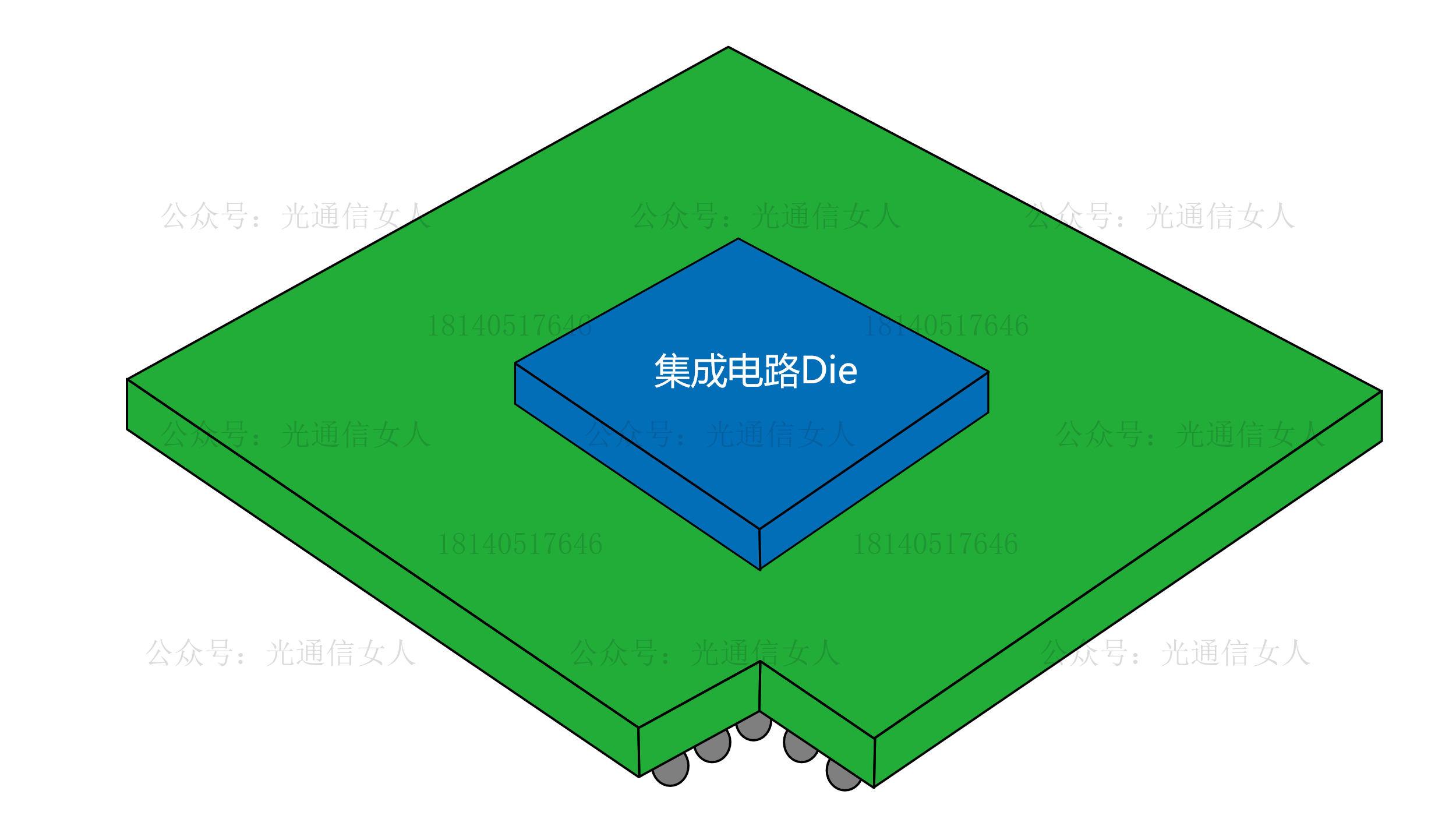
PCB的热膨胀系数很大,集成电流通常采用硅晶圆来制作,硅的热膨胀系数很小,这俩材料的焊接,硅芯片非常容易在回流焊环节产生翘曲。
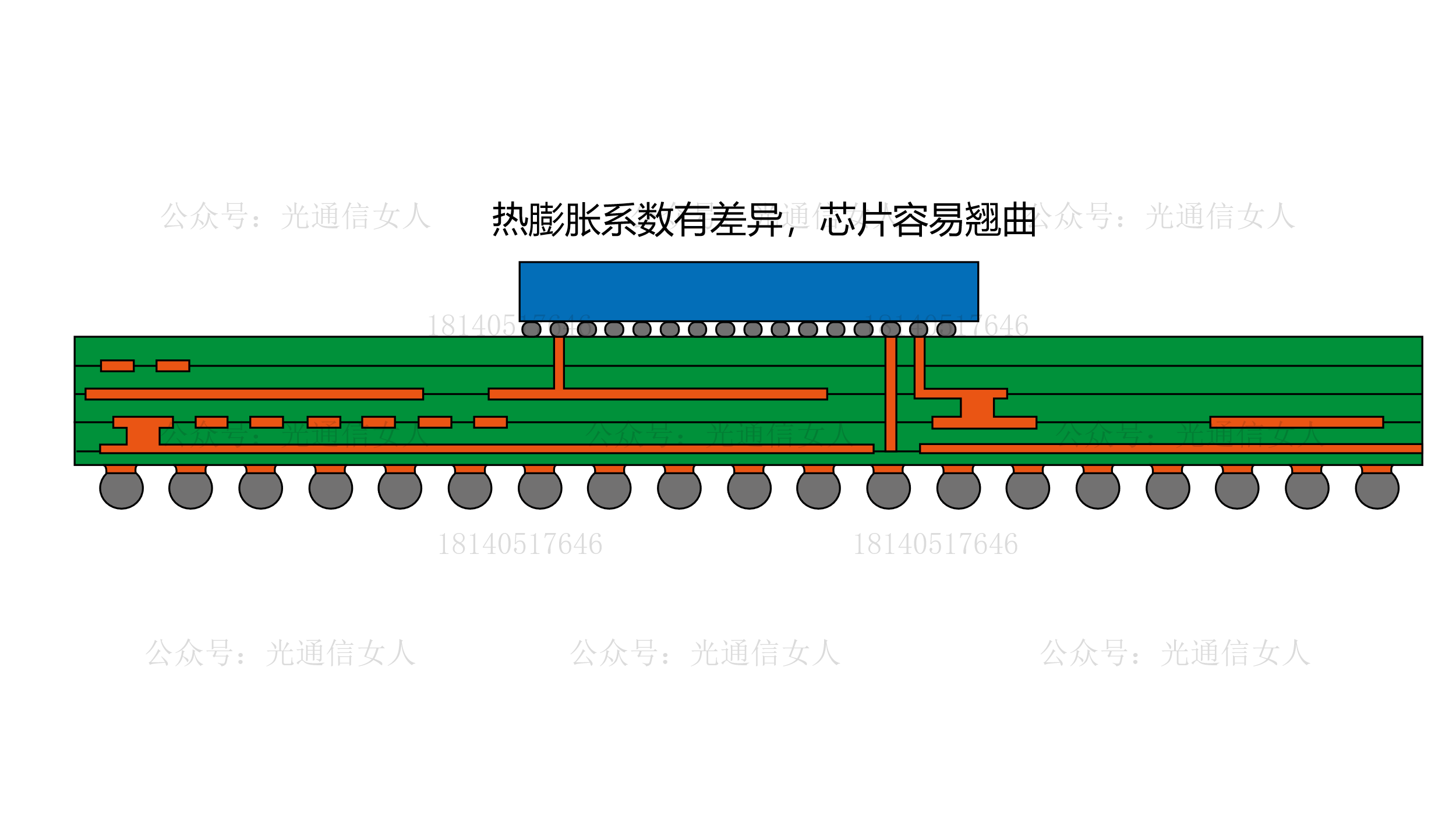
所以电芯片的裸die,与PCB焊接后,大多数选择灌封环氧胶,起到机械支撑作用,避免芯片翘曲,同时还能起到防潮和导热的辅助作用。
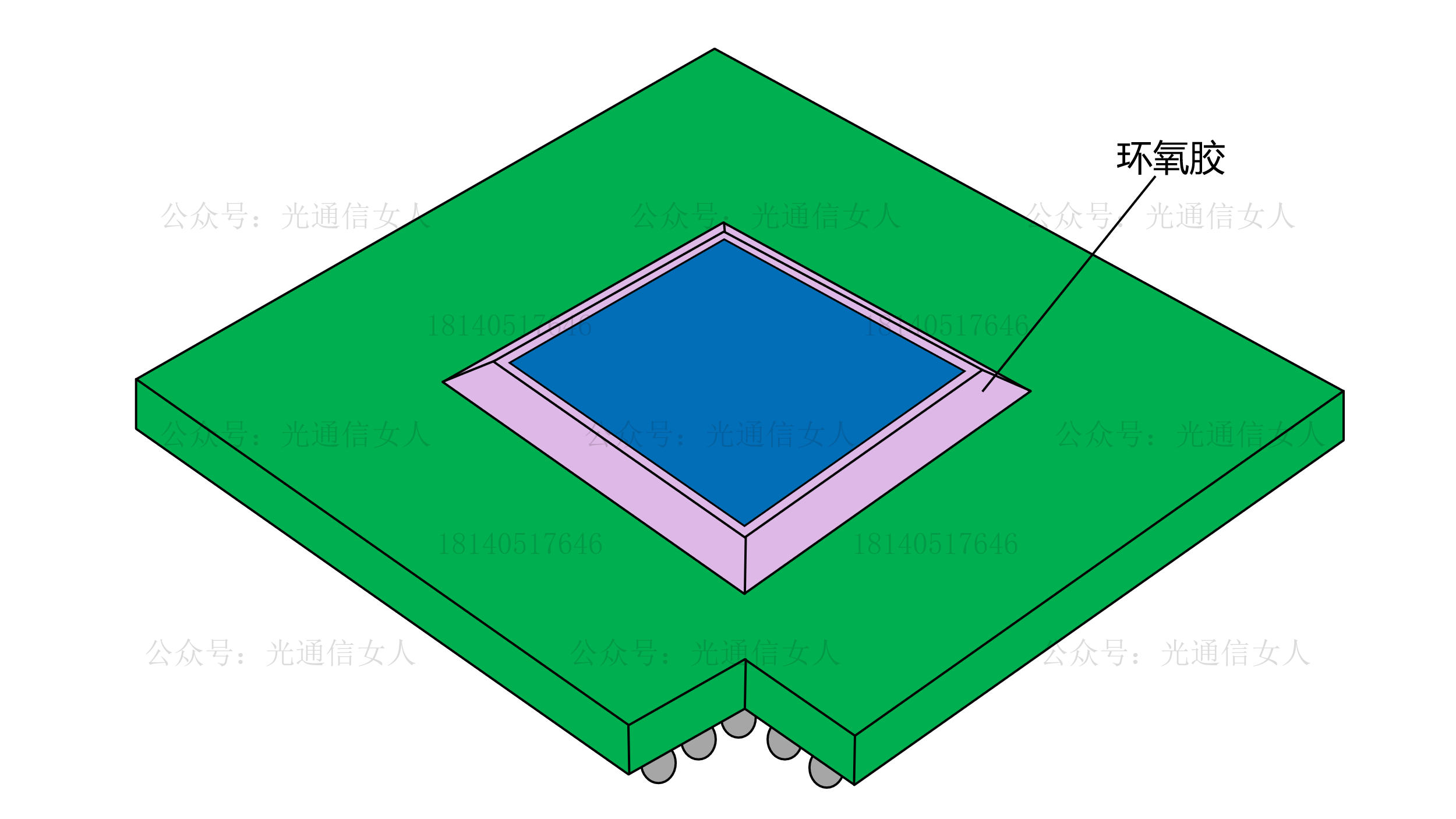
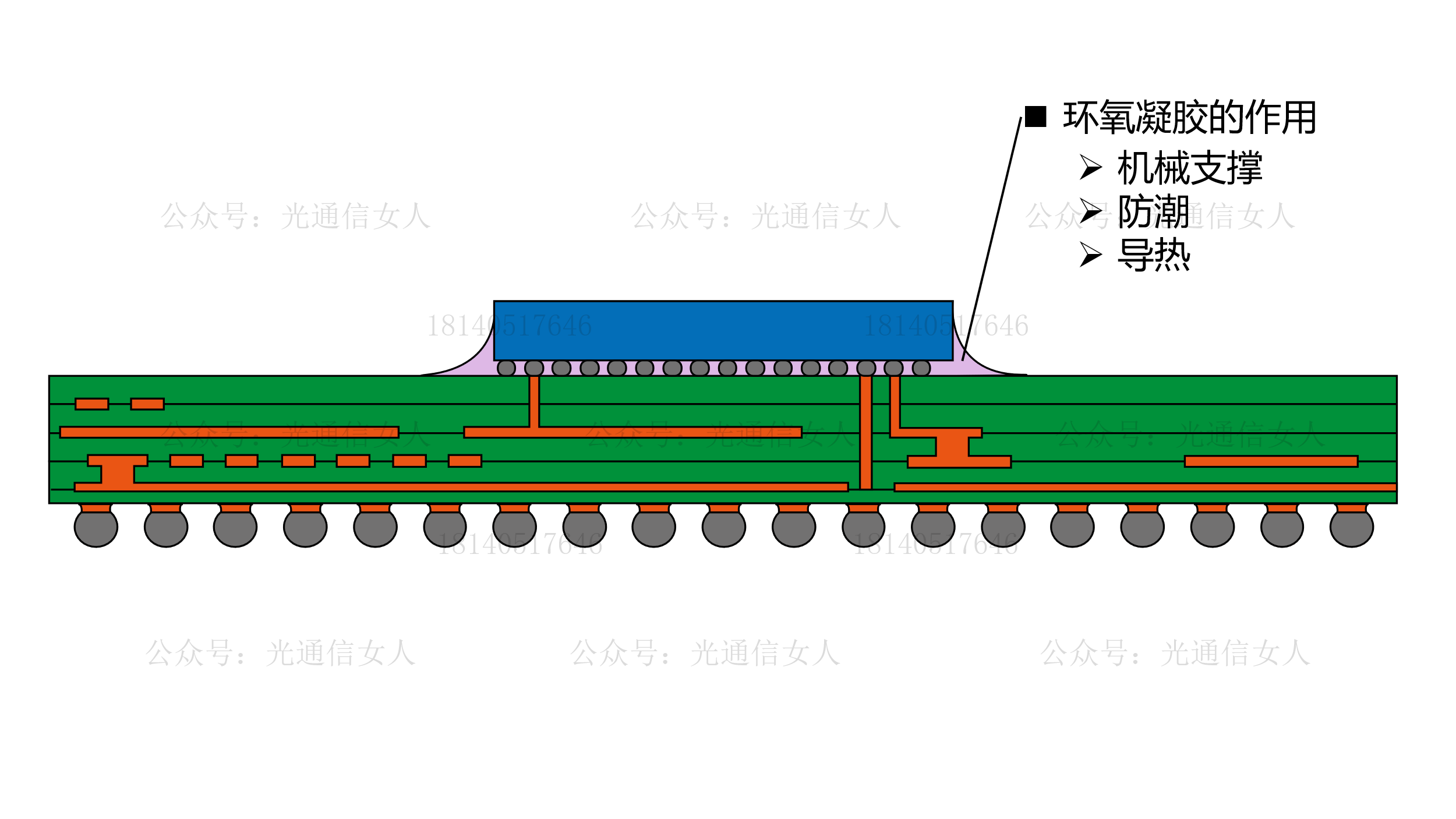
最后,固定金属上盖,用于增强散热。
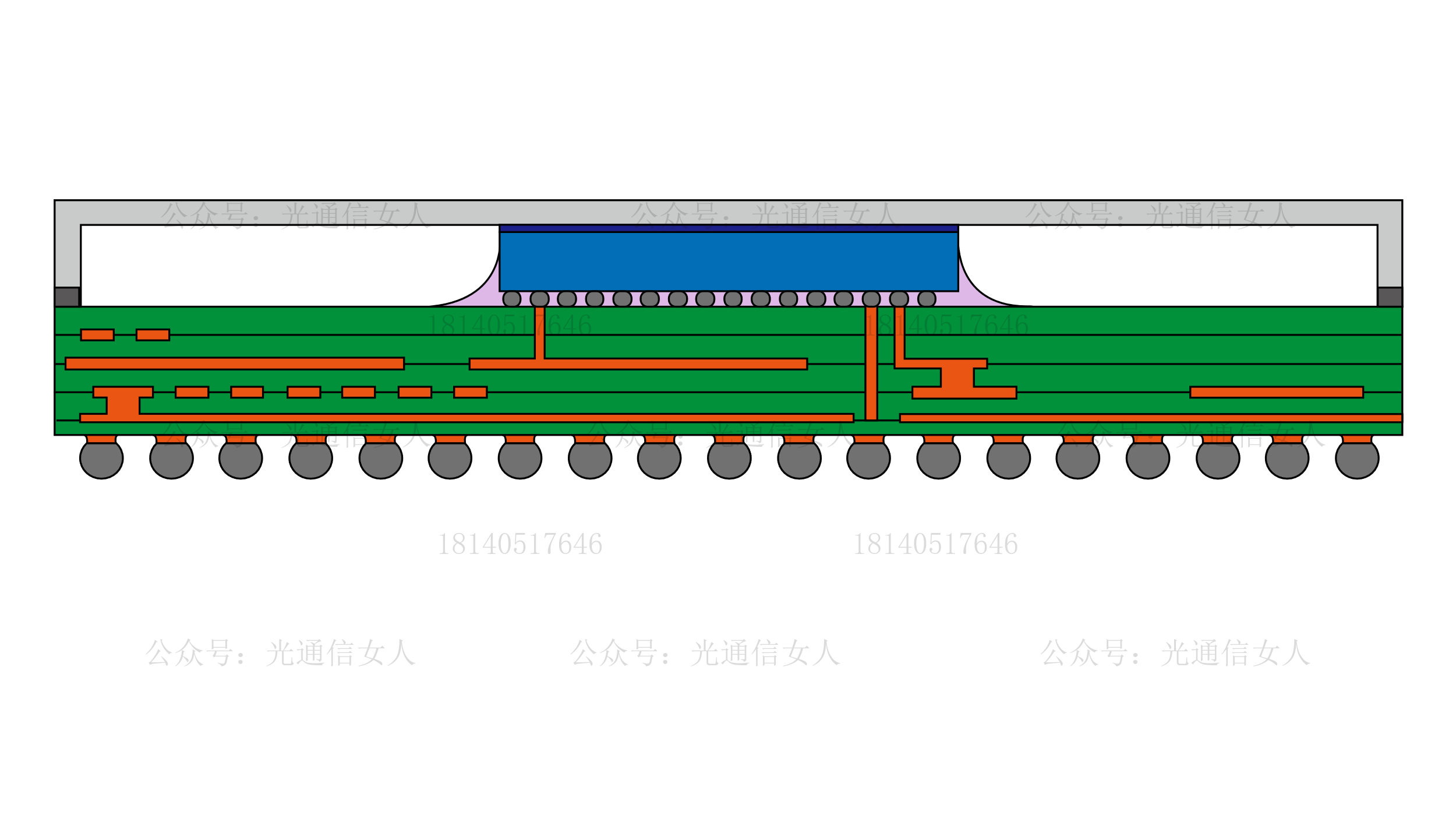
最后聊一下模拟芯片,光模块里的模拟芯片主要是驱动芯片与跨阻放大器芯片,这两个功能,可以集成在一个芯片里,也可以分开做,甚至可以集成在DSP芯片里去。
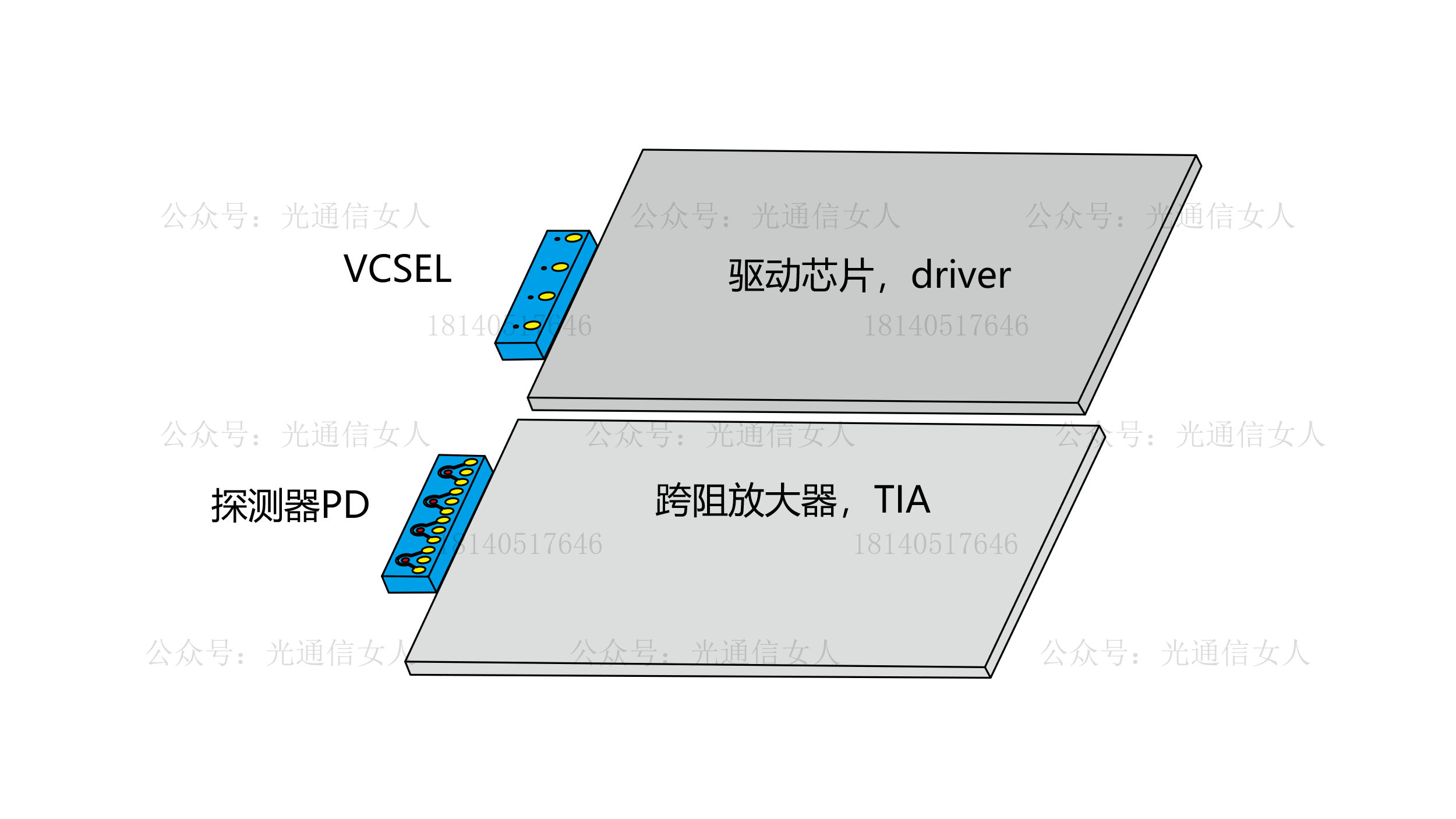
大多数的时候,驱动芯片Driver(DRV芯片)与跨阻放大器TIA,采用COB,或COC方式,用键合金丝做互联。
也有一部分采用裸die flip chip的倒装焊接方式。裸die flip chip的方式,可以支持更大的射频带宽,但是对热膨胀系数的差异很敏感。
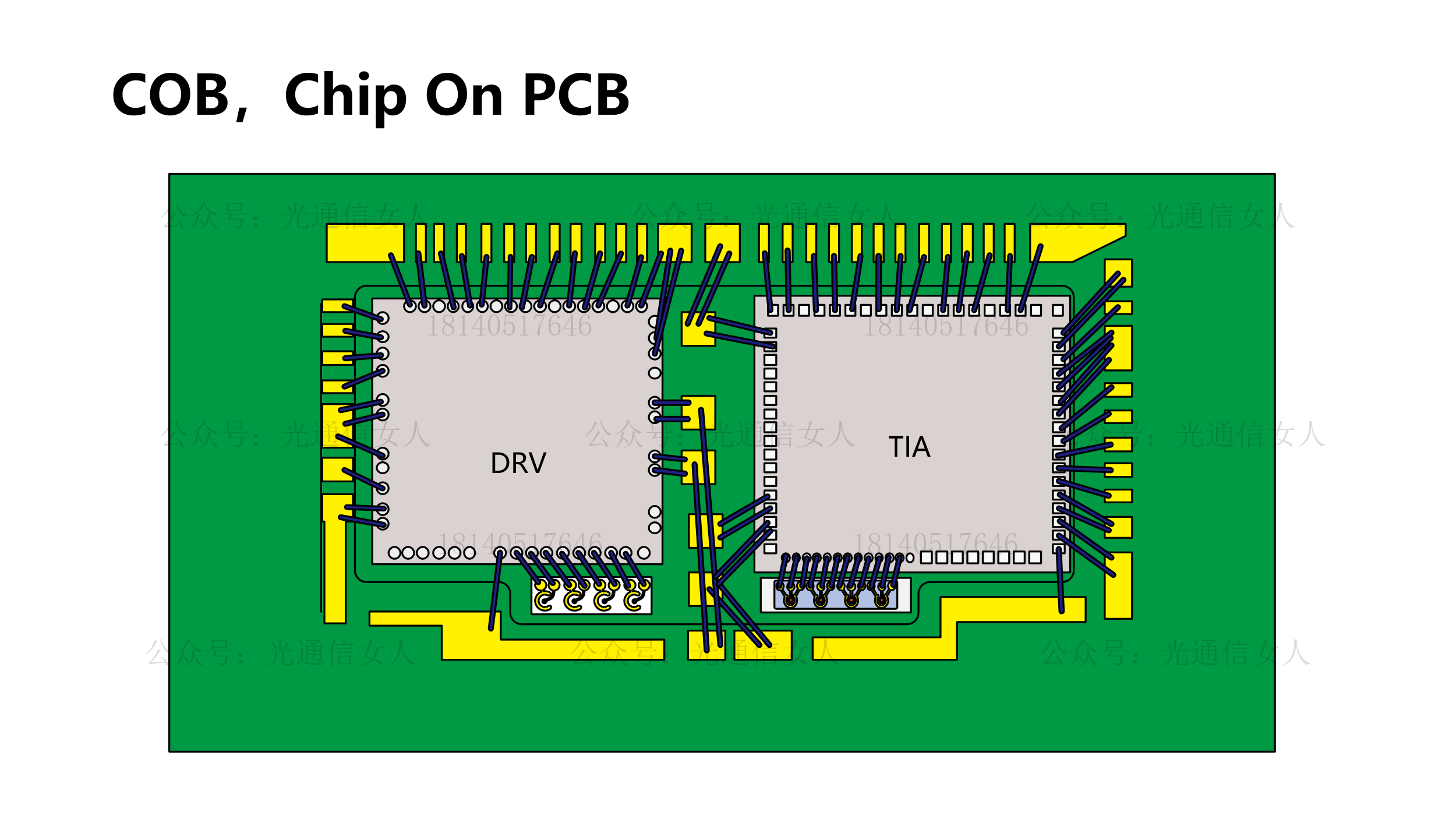
金丝键合方式,是模拟电路里常见的低成本工艺。
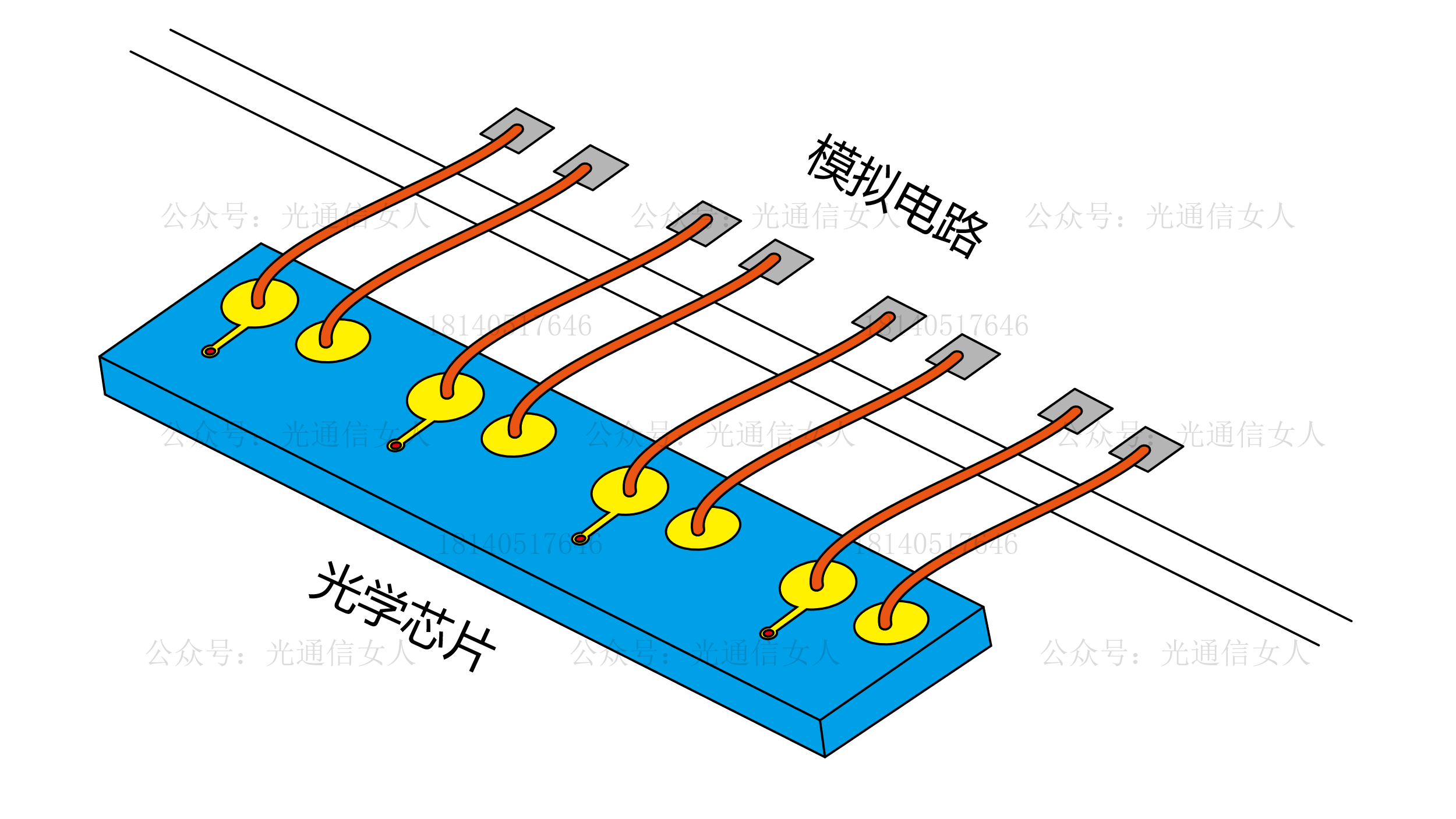
DRV、TIA采用flip chip封装,属于先进工艺,通常需要多芯片的复合大带宽射频封装工艺。